Similar presentations:
Диффузия
1. Диффузия
2.
В твердом теле диффузия –процесс активируемого
температурой перескока атома из
одной потенциальной ямы в
другую.
3. Законы Фика
• j = – D grad N,d dN
dj
D
=–
dx dx
dx
dj
dN
=–
dx
dt
N N
=
D
t x x
j [см-2/c]
D(T) = Do exp(- E/kT)
N
[см-3]
[см2/c]
j(x)
j(x+dx)
dx
x x+dx
dx
x
4. Диффузия из неограниченного источника примеси
jДиффузия из
ограниченного
источника примеси
j(0,t)=0
Ns
N 0, t N S const
N x dx Q const
0
5. Диффузия из одной полуограниченной области в другую
erf u2 u
e d
2
0
erfc u 1 erf u
Краевые условия
N (-∞,t) = No = const
N (∞,t) = 0
Начальные условия
при t =0 и x → +0, N(x,0) → 0
при t =0 и x → -0, N(x,0) → No
6.
Краевые условияN (-∞,t) = No = const
N (∞,t) = 0
Начальные условия
при t =0 и x → +0,
N(x,0) → 0
при t =0 и x → -0,
N(x,0) → No
N0
x
N x, t
erfc
2
2 D t
L 2 D t
7. Диффузия из неограниченного источника примеси
N 0, t N S constN(x,t) = Ns erfc (x/L)
t
Q j t dt 2 N S
0
D t
D
j 0, t N S
t
8. Диффузия из слоя конечной толщины
суперпозиция двух профилей N1–N2N x, t
N0
x h
x h
erfc
erfc
2
L
L
N0
x h
N1 x, t
erfc
2
L
N0
x h
N 2 x, t
erfc
2
L
9. Диффузия из бесконечно тонкого слоя (точечный источник)
N0 22
2
N x, t
exp u du exp u du
x h L
2
x h L
N 0 x h L
exp u 2 du
x h L
При h → 0 интеграл стремится к
2h N 0 Q const
2 h
2
2
exp x L
L
2
L 4 D t
N 0 2h
Q
2
2
N x, t
exp x L
exp x 2 4 D t
L
2 D t
10. Понятие тонкого и толстого слоя
h > 4L – слой толстыйh < L/4 – слой тонкий
Отражающая и связывающая границы
Граница, поток примеси через которую равен 0 –
отражающая.
Граница, концентрация примеси на которой равна 0 –
связывающая (поглощающая).
x
x
N x, t N 0 1 erfc N 0 erf
L
L
11. Факторы, влияющие на величину коэффициента диффузии
Температура процесса.
D(T) = Do exp (- E/kT)
Механические напряжения и сопутствующая им
повышенная концентрация дислокаций. Вдоль
дислокаций диффузия примеси идет во много
раз быстрее, чем в бездефектном материале.
Концентрация диффундирующей примеси.
Концентрация фоновой примеси.
Атмосфера, в которой ведется диффузия
примеси.
Ориентация кристалла.
12. Диффузия из пленок, наносимых на поверхность полупроводника
• Пленки металлов, например, Au или Al,нанесенные методом термического испарения.
Толщина пленок определяется требуемым
количеством примеси, которое должно быть
введено в полупроводник.
• Слои легированного оксида кремния или
легированного поликремния.
• Пленки фоторезистов- диффузантов. В этих
пленках обычными методами фотолитографии
можно сформировать рисунок областей,
подлежащих легированию.
13. Диффузия в потоке газа-носителя
Твердые источники• БСС (nB2O3∙mSiO2), В2О3
• ФСС (nP2O5∙mSiO2)
Газообразные источники
• В2Н6 (диборан)
• PH3 (фосфин)
14. Диффузия в потоке газа-носителя из жидкого источника
B2O3• BCl3 и BBr3; PCl3
Барботер
15. Метод параллельного источника
N2, O2BN (нитрид бора)
B2O3
Установка твердых
планарных
источников и
пластин кремния – в
кварцевой кассете:
• 1 – кварцевая
кассета;
• 2 – твердые
планарные
источники;
• 3 – пластины
16. Источники диффузанта
• Бор (В)В2Н6 (диборан); смесь (порядка 5%) с Ar
БСС (nB2O3∙mSiO2), В2О3
2 B2O3 + 3Si → 3Si02 + 4В
ТПИ – BN (нитрид бора)
BCl3 и BBr3
• Фосфор (P), мышьяк (As) и сурьма (Sb)
PCl3, оксихлорид фосфора POCl3
PH3 (фосфин); 2 РH3 → 3H2 + 2P
P2O5, ФСС (nP2O5∙mSiO2)
2 Р2О5 + 5Si → 5SiО2 + 4P
Поверхностные источники: ортофосфаты кремния, (NH4)H2PO3, ФСС
ТПИ: нитрид фосфора, фосфид кремния, ФСС, метафосфат
алюминия, пирофосфат кремния
17. Выбор легирующей примеси
Система энергетических уровней, создаваемых данной
группой примесей в запрещенной зоне полупроводника.
Все основные донорные и акцепторные примеси в кремнии
(элементы V и III групп) имеют Еа≈ 0.06 эВ. Исключением
является In: Еа≈0.16 эВ от Еv (используется при создании
фотоприемных устройств).
Примеси, имеющие энергетические уровни, расположенные
вблизи середины ЗЗ, например, Au, применяются для
снижения времени жизни ННЗ.
Предельная растворимость примеси.
Р (1,5∙1021 см-3), As (2∙1021 см-3), Sb (5∙1019 см-3 ).
B (5∙1020 см-3), Al (2∙1019 см-3).
Величина коэффициента диффузии.
Наибольший коэффициент диффузии D имеет Al. Заметно
уступают ему B и P. Очень велики D у Au и О2.
Технологичность. В первую очередь D в Si и SiО2.
18.
GeSi
19. Двух- и трехмерные точечные источники
r2r2
Q
Q
N r , t
exp
exp 2
m
m
(4 Dt )
4 Dt (4 Dt )
L
r - расстояние от источника диффузанта
m= 1/2, 1 и 3/2, соответственно, для одно-, двух- и
трехмерного источников
В трехмерном случае количество примеси в источнике
Q безразмерно,
в двухмерном случае Q [см-1]
2
2
2
Q
( x x1 ) ( y y1 ) ( z z1 )
N x, y , z , t
exp[
]
3/ 2
(4 Dt )
4 D t
(x1,y1,z1) – координаты источника примеси
20.
Формула ПуассонаQ
( x x1 ) 2 ( y y1 ) 2 ( z z1 ) 2
N x, y , z , t
exp[
]
3/ 2
(4 Dt )
4 D t
F ( , , )
( x ) 2 ( y ) 2 ( z ) 2
N x, y, z, t
exp[
]d d d
3/ 2
(4 Dt )
4 D t
F ( , , ) F ( ) F ( ) F ( )
( x )2
F ( )
N x, t
exp
d
4 D t
2 Dt
N(x,y,z,t) = N(x,t)∙N(y,t)∙N(z,t)
21. Диффузия в прямоугольное окно
2b2b
x
x
2a
2a
y
z
y
z
N x, y , z , t
NS
x a
x a
y b
y b
z
erfc
erfc
erfc
erfc
erfc
4
L
L
L
L
L
z2
Q
x a
x a
y b
y b
N x, y, z, t
erfc
erfc
erfc
erfc
exp 2
4 D t
L
L
L
L
L
22.
NSx a
x a
z
N x, y , z , t
erfc
erfc
erfc
2
L
L
L
z2
Q
x a
x a
N x, y, z, t
erfc
erfc
exp 2
2 D t
L
L
L
2a
23. Схематическое представление диффузионного очага при локальной диффузии бора в кремний
24.
Отражающая границаN0
x h
x h
x, t erfc
NОтражающая
erfc
граница 2
L
L
No
-h
h
0
Отражающая
граница
Q
Q
0
x
x2
2Q
N x, t
exp 2
L
L
x
25. Связывающая (поглощающая) граница
Поглощающаяграница
No
-h
0
h
x
- No
Поглощающая
граница
Q
-l
0
-Q
l
x
26.
Диффузияв вакуум
N0/2 erfc (-x/L)
- N0/2 erfc (x/L)
N(x,t)
u
erfc= uN 0 /21 erfc
erf (x/L)
erfc u 2 erfс u
erf u erf u
x
x
N x, t N 0 1 erfc N 0 erf
L
L
27. «Разгонка» примеси Многостадийная диффузия
N x, t N Serfc 2 Dз t з
Dр t р
exp ( x ) d
2
4 D р t р
Dр tр = Dр1 tр1 + Dр2 tр2 + … + Dрi tрi
Q N x, t dt
0
2NS
Dз t з
характеристическая величина D t = Dз tз + Dр tр
Если Dр tр > 3 Dз tз
Если Dр tр Dз tз
Dз t з
x2
N x, t
exp
D t
4 D t
NS
x
N x, t N Sэф erfc
2 Dt
N Sэф N S
Dз t з
D t
28. Диффузия B в Si
29.
30. Диффузия P в Si
коэфф.активности ˂ 1при L˂1 мкм
транзистор с тонкой базой
(менее 0.2 мкм)
Эффект вытеснения
коллекторного перехода












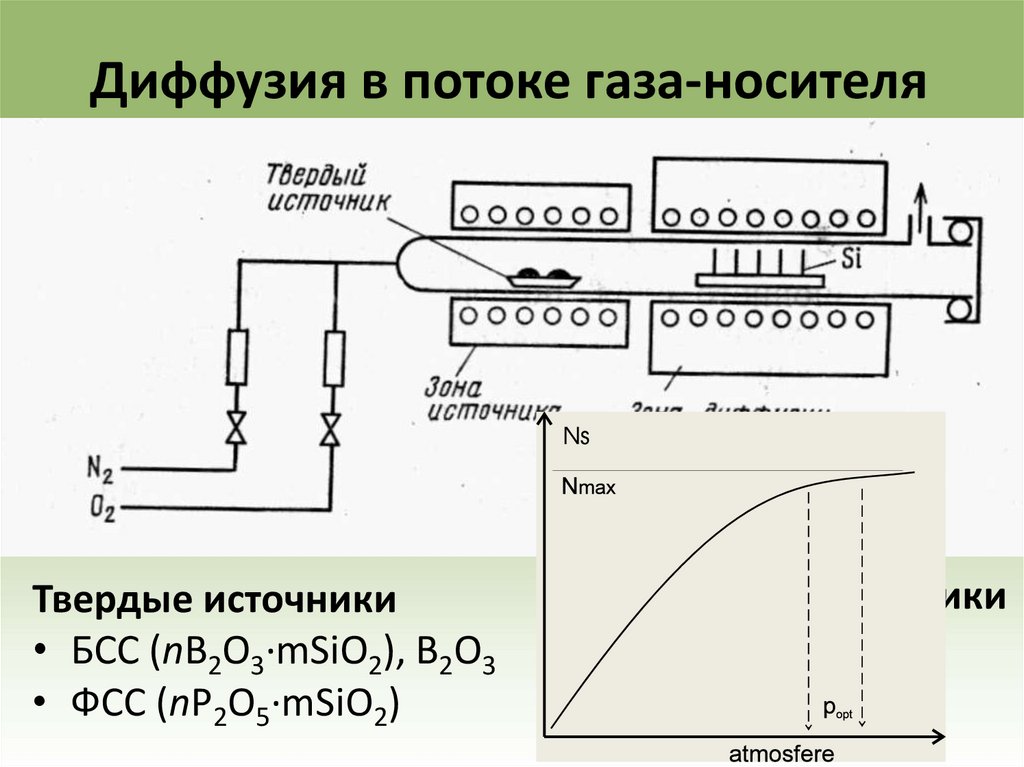
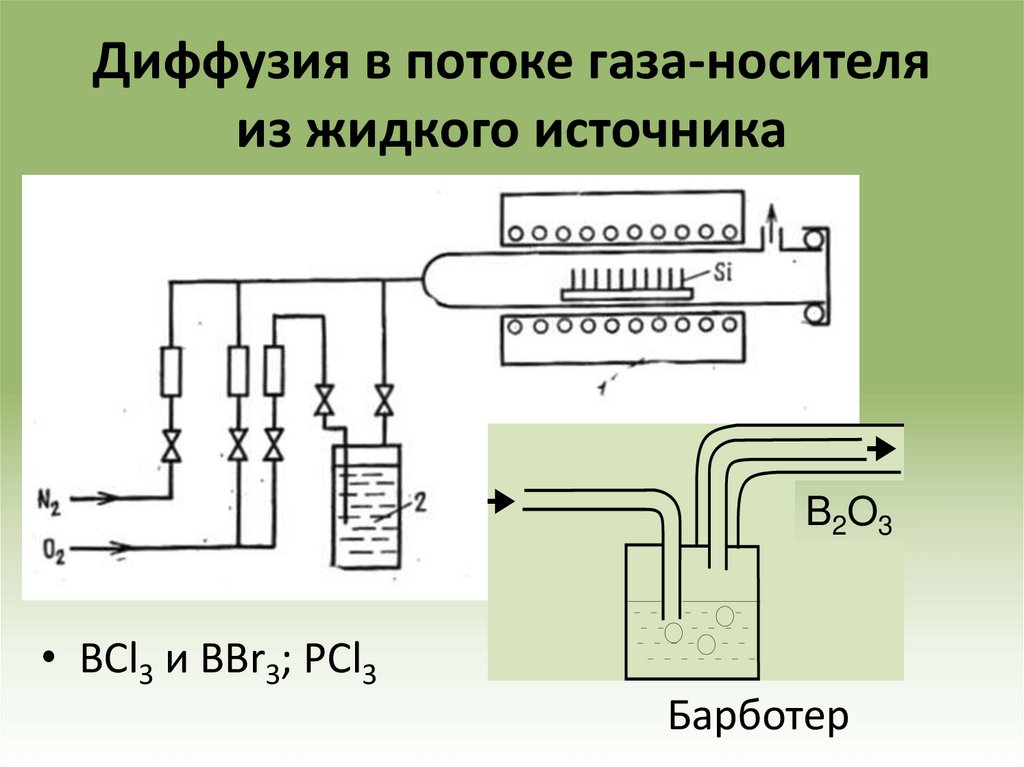
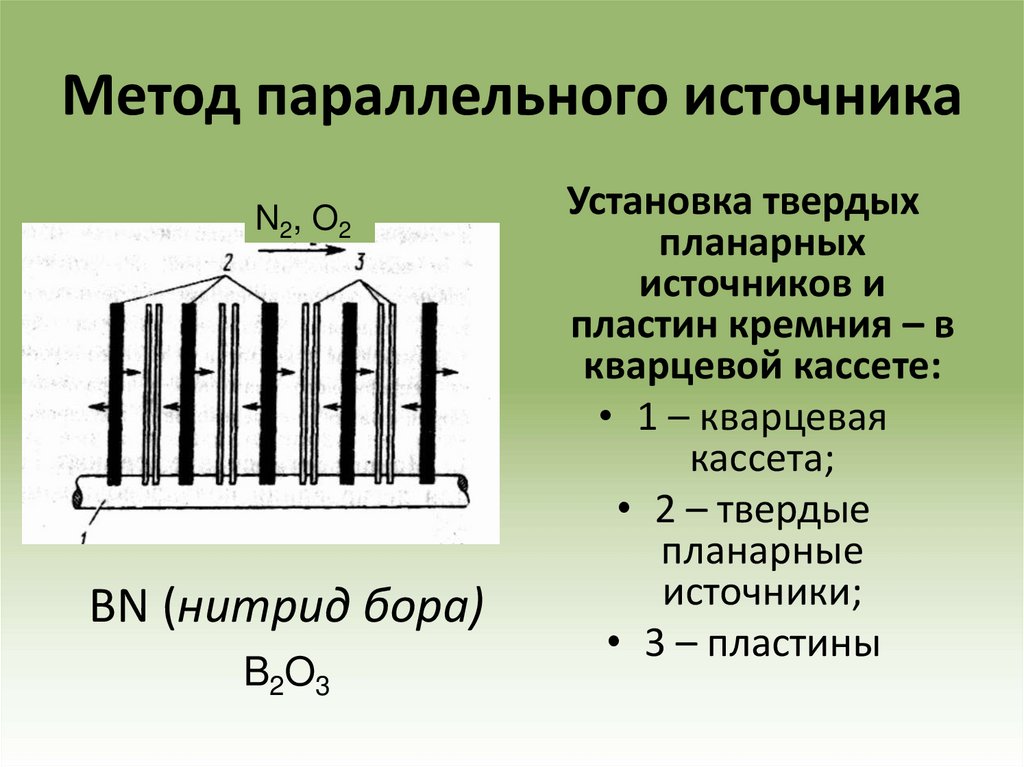
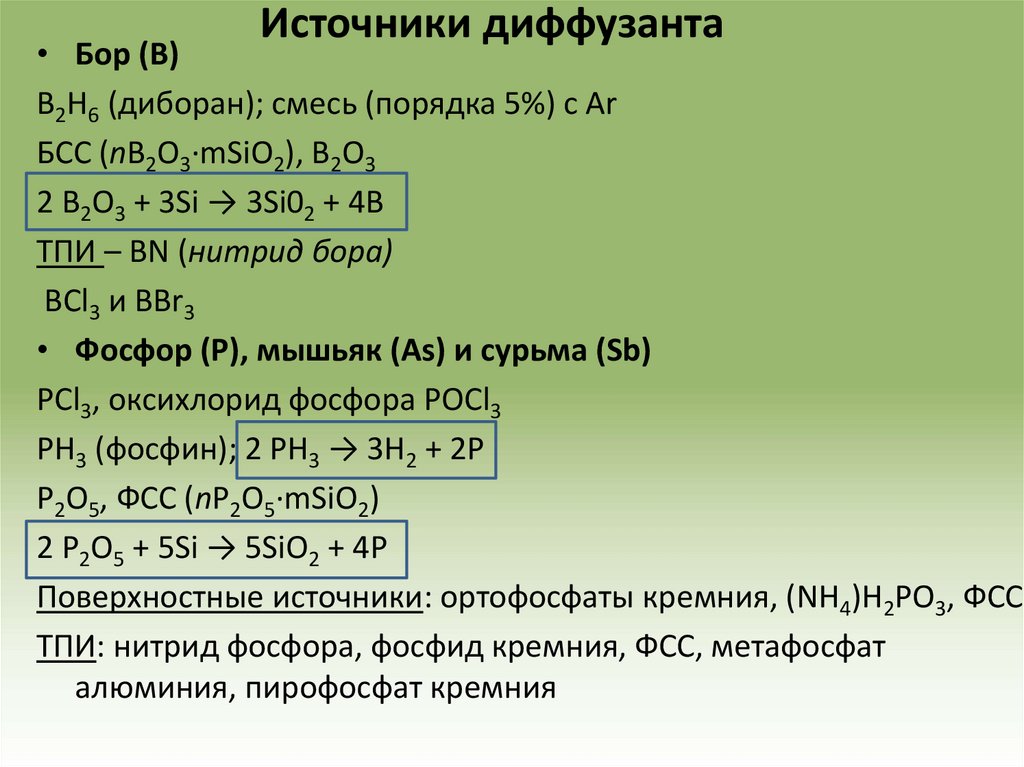






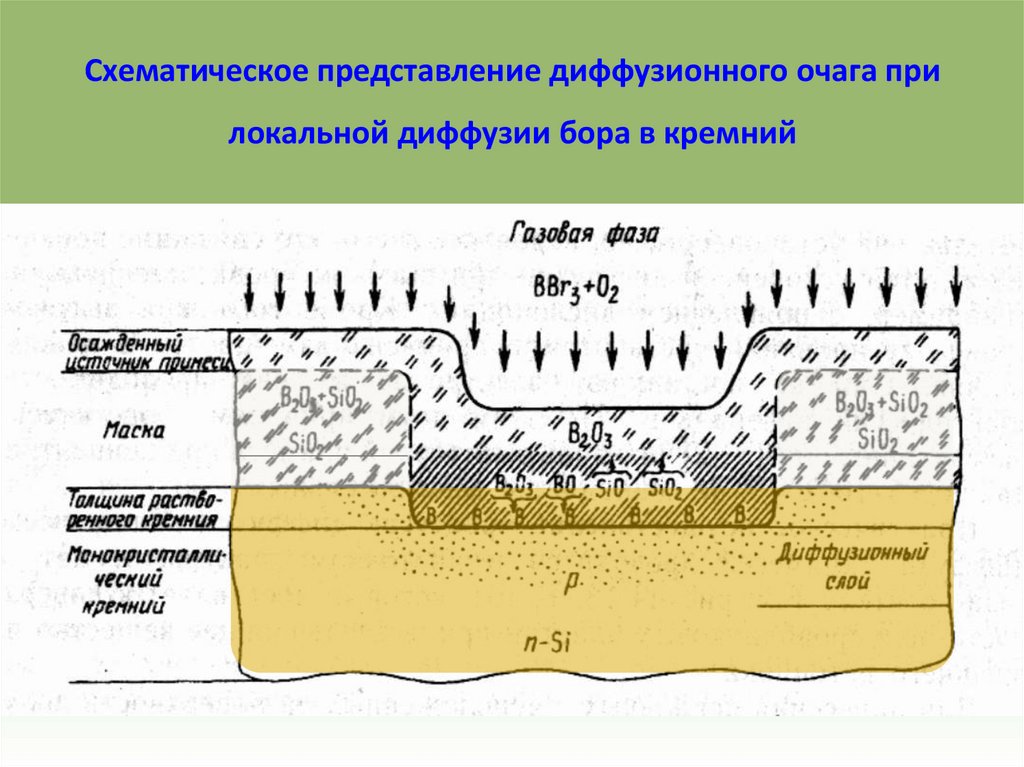

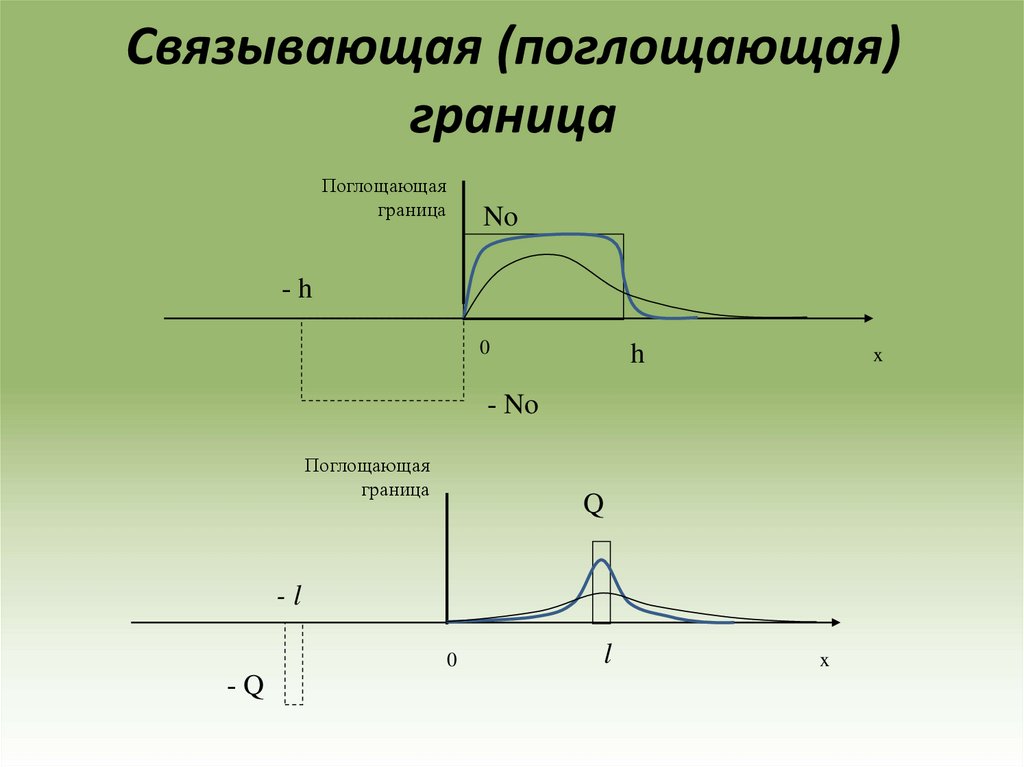
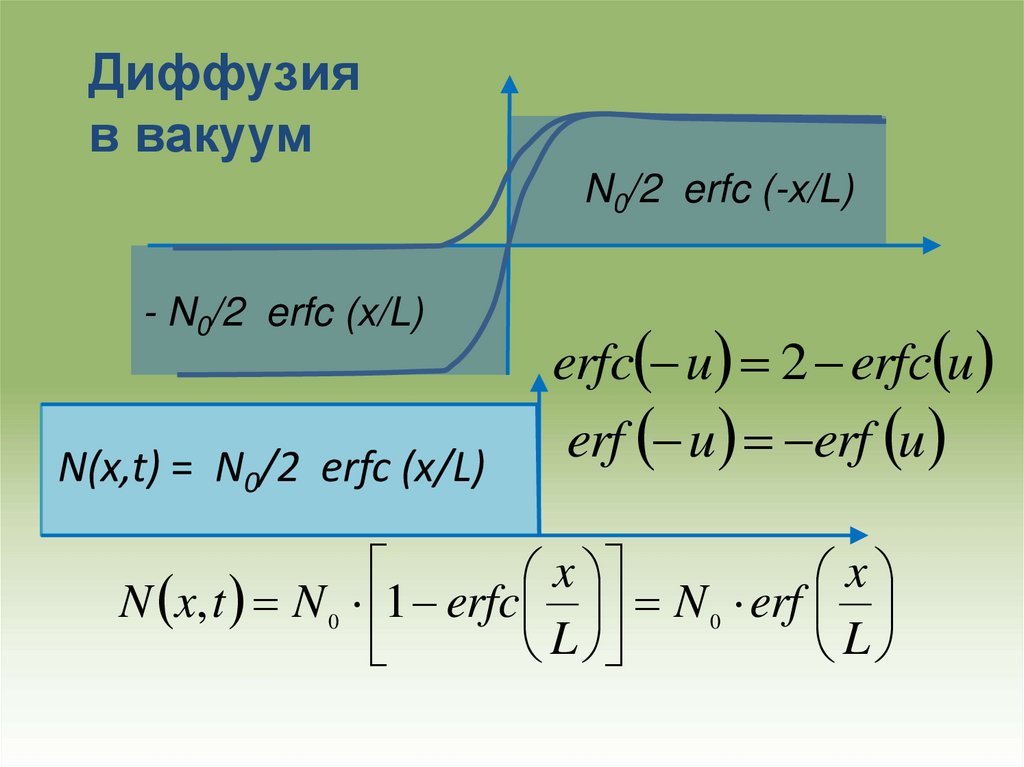



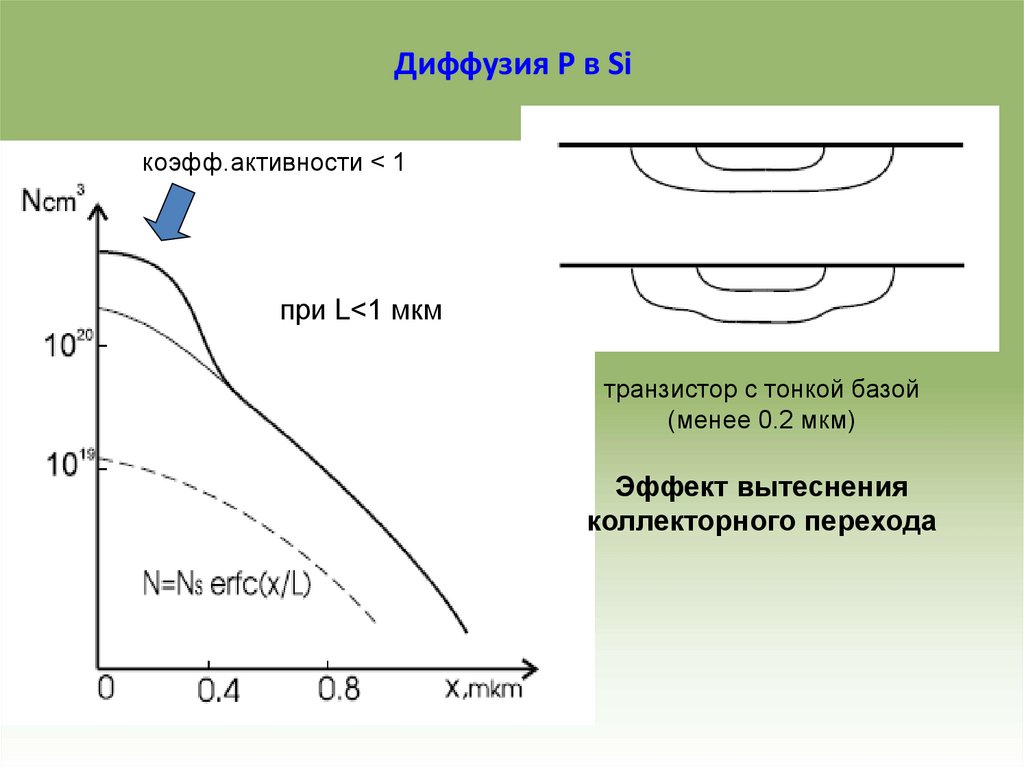
 physics
physics








