Similar presentations:
Ионная имплантация. Двух- и трехмерные точечные источники
1. Двух- и трехмерные точечные источники
r2r2
Q
Q
N r , t
exp
exp 2
m
m
(4 Dt )
4Dt (4 Dt )
L
r - расстояние от источника диффузанта
m= 1/2, 1 и 3/2, соответственно, для одно-, двух- и трехмерного источников
Формула Пуассона
F ( , , )
( x ) 2 ( y ) 2 ( z ) 2
N x, y, z, t
exp[
]d d d
3/ 2
(4 Dt )
4 D t
( x )2
F ( )
N x, t
exp
d
4 D t
2 Dt
F (N(x,y,z,t)
, , ) =FN(x,t)∙N(y,t)∙N(z,t)
( ) F ( ) F ( )
2. Диффузия в прямоугольное окно
2bx
2b
2a
x
2a
y
z
y
z
N x, y, z, t
NS
4
x a
x a
y b
y b
z
erfc
erfc
erfc
erfc
erfc
L
L
L
L
L
3. Источники диффузанта
• Бор (В)В2Н6 (диборан); смесь (порядка 5%) с Ar
БСС (nB2O3∙mSiO2), В2О3
2 B2O3 + 3Si → 3Si02 + 4В
ТПИ – BN (нитрид бора)
BCl3 и BBr3
• Фосфор (P), мышьяк (As) и сурьма (Sb)
PCl3, оксихлорид фосфора POCl3
PH3 (фосфин); 2 РH3 → 3H2 + 2P
P2O5, ФСС (nP2O5∙mSiO2)
2 Р2О5 + 5Si → 5SiО2 + 4P
Поверхностные источники: ортофосфаты кремния, (NH4)H2PO3, ФСС
ТПИ: нитрид фосфора, фосфид кремния, ФСС, метафосфат
алюминия, пирофосфат кремния
4. Выбор легирующей примеси
Система энергетических уровней, создаваемых данной
группой примесей в запрещенной зоне полупроводника.
Все основные донорные и акцепторные примеси в кремнии
(элементы V и III групп) имеют Еа≈ 0.06 эВ. Исключением
является In: Еа≈0.16 эВ от Еv (используется при создании
фотоприемных устройств).
Примеси, имеющие энергетические уровни, расположенные
вблизи середины ЗЗ, например, Au, применяются для
снижения времени жизни ННЗ.
Предельная растворимость примеси.
Р (1,5∙1021 см-3), As (2∙1021 см-3), Sb (5∙1019 см-3 ).
B (5∙1020 см-3), Al (2∙1019 см-3).
Величина коэффициента диффузии.
Наибольший коэффициент диффузии D имеет Al. Заметно
уступают ему B и P. Очень велики D у Au и О2.
Технологичность. В первую очередь D в Si и SiО2.
5.
GeSi
6. ИОННАЯ ИМПЛАНТАЦИЯ
7. Достоинства ионного легирования
• точная дозировка примеси (теоретически – 1%,практически – 5%);
• высокая чистота;
• расширенная возможность локального легирования
(широкий круг маскирующих материалов, меньше боковое
легирование);
• можно легировать через покрытие;
• возможность получения управляемого профиля
распределения – вплоть до формирования захороненного
слоя.
• возможность создания мелких переходов (20 нм, около 40
атомных слоев)
• быстрый процесс;
• можно проводить при комнатной температуре;
• ИЛ легко управлять путем изменения ускоряющего
напряжения, плотности ионного пучка, угла наклона пучка,
времени облучения пластин, а в случае обработки
сфокусированным пучком и скорости его сканирования
8. Схема установки ионного легирования
r r 2 M11U ZZ1 1 BB
2Z U M
источник
ионов
1
1
Анализатор
ионов по
массе
Энергия ионов
от десятков
килоэлектронвольт
до единиц
мегаэлектронвольт
вакуум порядка 10-4 Па
ВУ
ускоритель
интегратор
заряда
ИЗ
отклоняющие
пластины
ПУ ускоритель
9. Оборудование ионной имплантации
10. Основные параметры ионного легирования
Энергия ускоренных ионов. Ион с зарядом q [Кл],под действием разности потенциалов [В],
приобретает энергию , E0 qU [Дж].
Доза облучения – это количество частиц;
бомбардирующих единицу поверхности за данное
время. Доза облучения определяется плотностью
ионного тока j [А/м2] и длительностью облучения t
[с]:
I
2
D q N x dx dt jt [мкКл/ см ].
S
0
0
Чтобы выразить дозу в количестве частиц,
внедренных на единице поверхности, величину
делят на заряд одной частицы:
Q D q jt q , ион/см2.
11. источники
• с поверхностной термической ионизацией –нагреватель (вольфрамовая лента) на него насыпается
соль металла – KJ, NaCl, CaCl2 т.д., получают ионы Na+,
K+, Li+, Cs+, Rb+, J-, F-, Br-, Cl-;
• с ионизацией электронным ударом: электроны
создаются термоэмиссией или в газовом разряде,
ускоряются электростатическим или высокочастотным
полем, удерживаются в ограниченном объеме
магнитным полем и направляются на столкновение с
молекулами газа или пара рабочего вещества,
ионизируя их;
высокочастотные – плазма ВЧ-разряда (при давлении
10-10-2 Па), магнитное поле увеличивает
эффективность; на анод подается 2-10 кВ;
на основе дугового разряда в парах рабочего вещества
(BF3, AsH3,PCl3, B2H6) при низких давлениях (порядка 1
Па).
12. Пробеги и дисперсии пробегов ионов
13. Распределение пробегов ионов
( x Rp )N ( x) N ( Rp ) exp
2
2 Rp
2
Q
N (Rp )
2 R p
14. Теория Линдхарда, Шарфа и Шиотта
Механизмы потерь энергии иона приего торможении в мишени независимы
друг от друга и аддитивны
• dE/dx = Sn+Se
Sn = σNE
Se k E
Emax
4 M 1M 2
E0
2
M1 M 2
1
R
N
E0
dE
0 Sn Se
15. Потери энергии иона при торможении
16. Проецированная длина (а) и рассеяние (б) пробега ионов
аб
17. Каналирование ионов
18.
19.
20. Приближение Пирсона
21.
y-ay a
N ( x)
erfc
N ( x, y)
erfc
2
2 R
2 R
22. Фронт р-п перехода при ионном (а) и диффузионном (б) локальном легировании
Маскирование производится пленками окиси кремния; или Si3N4,фоторезистами, поликремнием или пленками металлов
Требования: должны быть достаточно толстыми для полного
торможения бомбардирующих ионов,
иметь низкий коэффициент распыления ионным пучком и
хорошо растворяться после облучения
23. Профили распределения дефектов и атомов бора
дефекты Френкеля –вакансии и атомы в
междуузлиях
дефекты смещений
сливаются в зоны
размером 5... 10 нм
кластер радиационных
нарушений - скопление
простых дефектов
доза аморфизации критическая доза ионного
облучения, при которой
полупроводник переходит
из кристаллического
состояния в аморфное
24. Структура нарушенных слоев
25. Дозы аморфизации кремния и германия (а) и температурные зависимости доз аморфизации кремния (б)
критическая температурааморфизации Ткр
для бора
24 °С,
для фосфора 175 °С,
для сурьмы 460 °С
26. Влияние термообработки на распределение фосфора, внедренного в кремний
2(
x
R
)
Qn
p
n ( x, t )
exp
2
2
2( R p 2 Dt )
2 R p 2 Dt
27. Импульсная термообработка
Восстановление кристаллической структурыслоев практически без изменения профиля
распределения примеси.
Такая возможность обеспечивается за счет
разницы в энергиях активации процессов
диффузии
примесей
и
процессов
самодиффузии,
ответственных
за
восстановление кристаллической структуры
(в Si 3.5 и 5 эВ). Поэтому при температурах,
приближающихся к температуре плавления,
процессы восстановления кристаллической
структуры ускоряются в значительно
большей
степени,
нежели
процессы
диффузии примесей.
28.
ИМПУЛЬСНАЯ ТЕРМООБРАБОТКАОказывается возможной
рекристаллизация полностью
аморфизированных и даже
поликристаллических слоев.
Может проводиться как при
однородном нагреве всей
поверхности пластины, так и с
использованием техники
сканирования лучом, при этом может
потребоваться несколько циклов
нагрева – охлаждения.
29. Импульсная термообработка
1. Восстановление кристаллической структуры после ионнойимплантации.
2. Снижение плотности дислокаций на 2-3 порядка величины и
концентрации кислородных кластеров по крайней мере на
порядок величины при воздействии импульсов длительностью
менее 0.05 с, разогревающих поверхностные слои до 1350 –
1400оС.
3. Уменьшение величины сопротивления контакта металлкремний приблизительно на порядок величины при
воздействии импульсов порядка 1 с, нагревающих поверхность
пластин до температуры, меньшей температуры плавления
металла. При этом используется однородный нагрев всей
площади пластины.
4. Создание приповерхностных слоев с большой концентрацией
дефектов, которые впоследствии могут использоваться для
геттерирования легко диффундирующих примесей (играют роль
центров рекомбинации).
5. “Резка” пластин.
30. Применение ионного легирования
1. Введение примеси• Загонка примеси с точной дозировкой
• Создание профиля с максимумом на глубине
• Создание мелких p-n-переходов
2. Модификация химических свойств материала
• Создание захороненного слоя оксида
• Аморфизация слоя для уменьшения растворимости
• Геттерирование примесей тяжелых металлов
31. Гетерирование -
Гетерирование удаление нежелательных примесей и дефектов.1. Высвобождение примесей или разложение
протяженных дефектов на составные части.
2. Диффузия к зонам захвата (стокам).
3. Поглощение примесей или междоузельных атомов
стоком.
Диффузия фосфора - метод гетерирования Cu. Атомы
Cu в Si находятся в междоузлиях, они переходят в
состояние Сu3– и образуют пары Р+Сu3–.
Внедрение в кремниевую пластину ионов инертных
газов приводит к формированию при отжиге
пузырьков газа, ограниченных кристаллографическими
поверхностями.














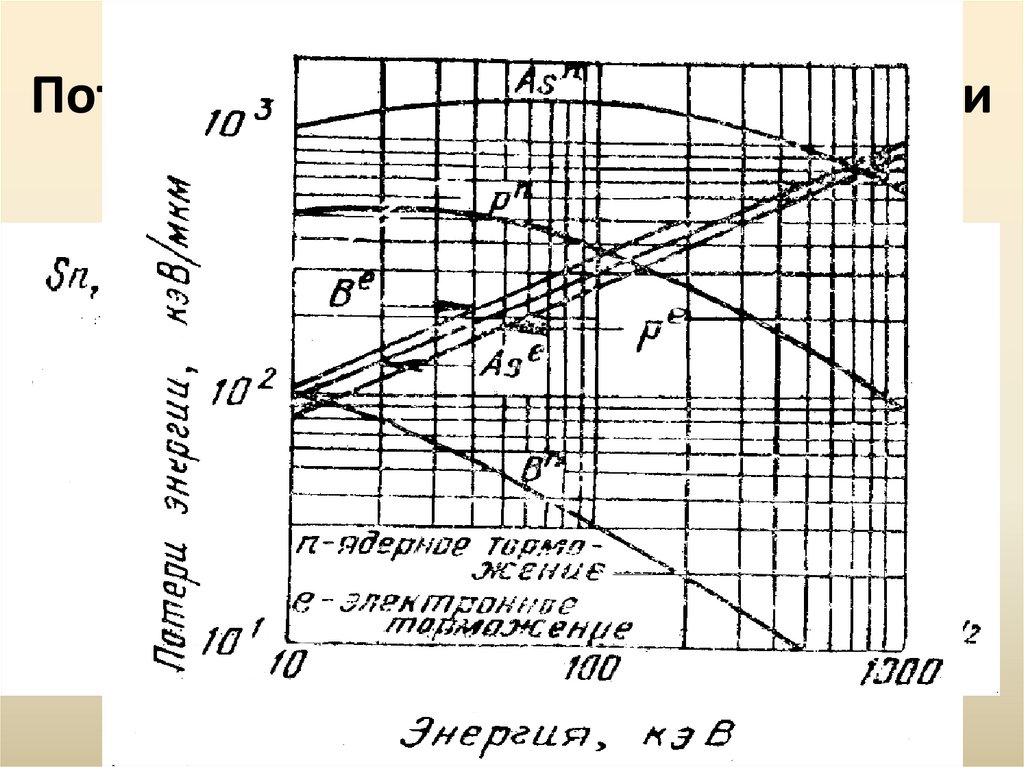



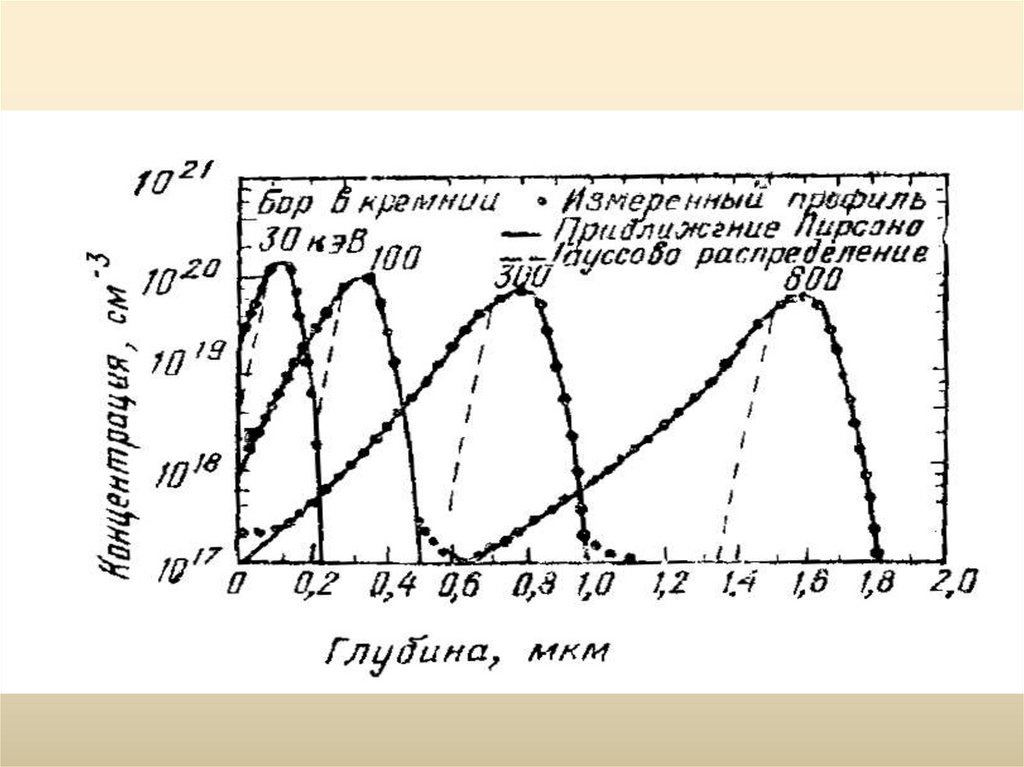

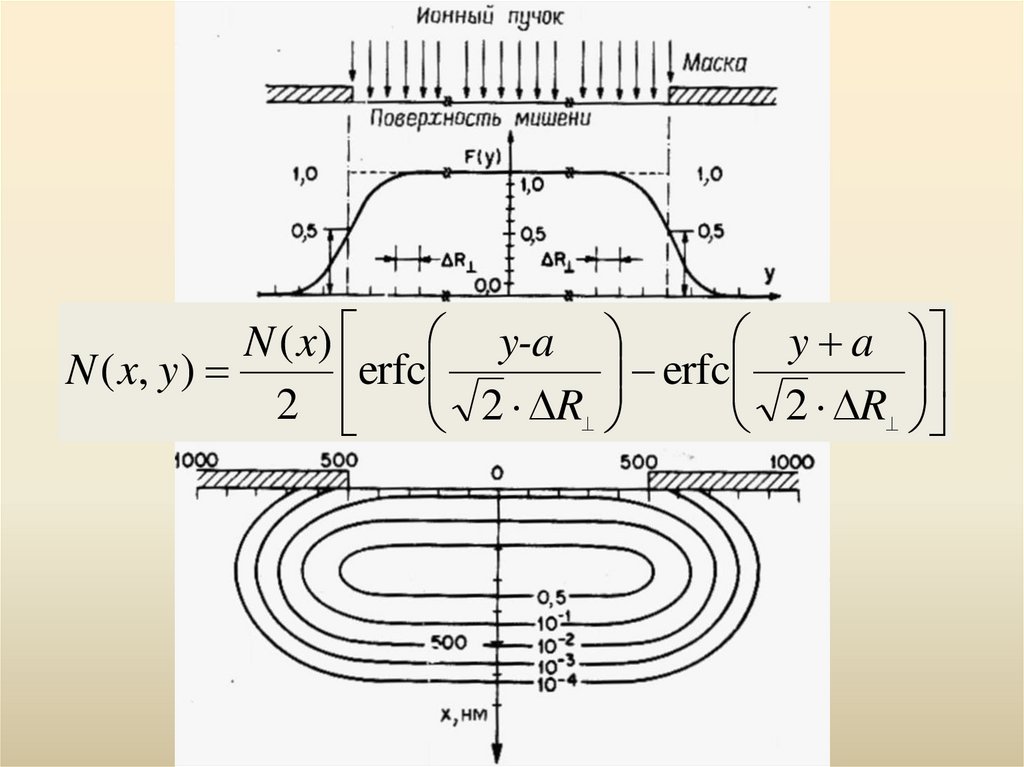










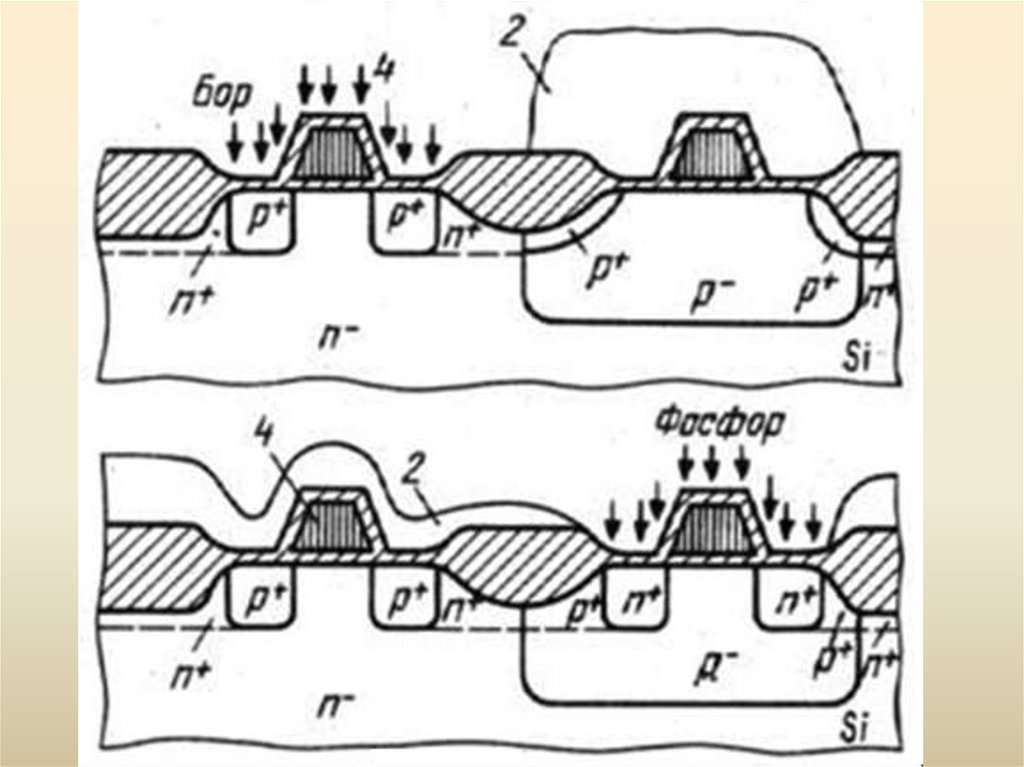

 physics
physics








