Similar presentations:
Контактные явления
1. Твердотельная электроника
Электронный учебно-методическийкомплекс
Твердотельная электроника
Презентации к лекционному курсу
Контактные явления
МОСКВА
2016
НИУ «МЭИ»
2. Барьер на границе металла с полупроводником (барьер Шоттки)
qX S Eвак EcEвак F
3.
Работа выхода равна разности между энергиейпокоящегося электрона в вакууме у поверхности
образца полупроводника и уровнем Ферми в данном
полупроводнике.
4. Контакт металл-полупроводник
qМ
П
k
5. Контакт металл-полупроводник
6. Контакт металл-собственный полупроводник
ФП ФМФП ФМ
7. Контакт металл-электронный полупроводник
ФП ФМФП ФМ
8. Контакт металл-дырочный полупроводник
ФП ФМФП ФМ
9.
Без смещения:W0
2 0 k
q Nd
m
2 q N d k
0
10.
Со смещением:2 0 k Vсм
W
q Nd
2 q N d k V
m
0
11. Сила изображения
q2E пот x
16 0 x
12. Сила изображения
• Если теперь вблизи границы раздела металл –вакуум имеется электрическое поле , то
выражение для энергии электрона на расстояния
х приобретает вид:
2
q
Eпот x
q x x
16 0 x
13. Граница металл-полупроводник при приложении электрического поля (барьер для электрона)
14. Граница металл-полупроводник при приложении электрического поля (барьер для электрона)
• Эта функция имеет максимум в точке хm. Егоположение можно определить из условия
d E x
0
dx
q
xm
0
16 0
• где в качестве обычно принимается
максимальное электрическое поле в обедненной
области. Контактное электрическое поле
понижает высоту барьера на величину 0,01-0,04
эВ.
15. Прямое и обратное смещение перехода металл-полупроводник
16.
Важно подчеркнуть, что внешнее напряжениеможет только выпрямить границы разрешенных
зон .
Другими словами, при приложении больших
прямых смещений электроны начнут «убегать» от
батареи смещения и все зоны будут наклоняться.
17.
18. Расчет ВАХ барьера Шоттки
При приложении напряжения:2 0 k Vсм
W
q Nd
где
J J п.п
V
T
Jм Js e
1
Ub
J s A T 2 e T
4 mn* q k 2
mn*
A
120
3
h
m0
А
см 2 K 2 - Постоянная Ричардсона
19. ВАХ диода Шоттки
20. Диод Шоттки
21. Диод Шоттки
22.
• ДШ характеризуются быстройрекомбинацией инжектированных
носителей (время жизни носителей крайне
мало), а значит и высоким
быстродействием. Благодаря
минимальному сопротивлению базы и
отсутствию процессов накопления и
рассасывания избыточных зарядов,
быстродействие получается достаточно
высоким: граничная частота fгр = 1010 Гц.
23.
24.
25.
Контакт электронного и дырочногополупроводников
26. Возникновение потенциального барьера. Контактная разность потенциалов
27. Контакт электронного и дырочного полупроводников
28.
29.
30. Образование p-n-перехода
31.
Перераспределение носителей, образовавшееся приконтакте, и формирование потенциального барьера
высотой q k приводит к тому, что диффузионный
поток основных носителей ( n n и p p ) прекращается.
Энергетический барьер существует именно для
основных носителей, потенциального барьера для
неосновных носителей ( pn и n p ) нет
32.
Для того чтобы рассчитать распределенияконцентраций
свободных
носителей
в
приповерхностной области необходимо решить
уравнение Пуассона, устанавливающее связь между
распределением потенциала и пространственного
заряда ρ(x):
33. Решение уравнения Пуассона
34.
Толщина ОПЗWp
Wn
Na
Nd
;
W0 N d N a W0 N d N a
k
q
2 0 s
N W
d
2
n
N aW
2
p
Nd Na
W
2 0 s
Nd Na
2 0 s
Nd Na
W0
k
q
Nd Na
q
2
0
35.
Чем выше степень легирования n- и pобластей полупроводника, тем меньшетолщина ОПЗ. Если одна из областей
легирована значительно сильнее другой, то
большая часть падения потенциала приходится
на высокоомную область
36. Определение контактной разности потенциалов
37.
Потенциальный барьер в pn-переходе тем выше,чем сильнее легированы p- и n-области. По мере
роста
температуры
величина n 2 возрастает.
i
Выражение под знаком логарифма стремится к
нулю, т.е. контактная разность потенциалов с
ростом температуры уменьшается.
При высоких температурах начинает доминировать
собственная проводимость как в p-, так и в nобласти, при этом в каждой из областей уровень
Ферми стремится к середине запрещенной зоны и q k
стремится к нулю.
38.
Связь концентрации носителей сpn n p
q k
exp
p p nn
kT
q k
p n p p exp
kT
k
exp
Т
k
p p exp
Т
k
k
q k
n p nn exp
nn exp
kT
Т
39. Рассмотрим теперь pn-переход, к которому приложено прямое смещение Vсм (минус батареи к n-типу, плюс – к p-типу).
Допустим, что все приложенное внешнее напряжение падаетна pn-переходе.
При прямом смещении высота потенциального барьера
понижается на qVсм по сравнению с равновесным
состоянием, соответственно изменяется и толщина ОПЗ:
2 0 s
Nd Na
Wпр
k Vсм
q
Nd Na
40.
Понижение потенциального барьера приводит кувеличению потока основных носителей заряда по
сравнению с равновесным состоянием. Под действием
диффузионных процессов основные носители ( n n и p p )
перемещаются в соседнюю область, становясь
неосновными носителями ( p n и n p ).
Образовавшийся градиент концентрации неосновных
носителей приводит к появлению диффузионных токов
неосновных носителей заряда, он направлен от ОПЗ
вглубь полупроводника. При этом направления
диффузионных токов, создаваемых p n и n p совпадают,
в то время как их потоки направлены в разные стороны.
41. Распределение носителей заряда вблизи перехода
а)42.
Введение в полупроводник носителей заряда спомощью pn-перехода при подаче на него
прямого смещения в область, где эти носители
заряда являются неосновными, называют
инжекцией.
Концентрация дырок в n-области вблизи контакта
будет равна:
pn p n 0 p
43.
Для ее нахождения в стационарном случае награнице с ОПЗ (при х Wn ) нужно вместо q k
q k Vсм
использовать значение
( k Vсм )
Vсм
p no exp
p n Wn p p exp
T
T
Концентрация неосновных носителей в
низколегированной области (базе) зависит от
концентрации носителей в высоколегированной
области (эмиттере) и от напряжения
смещения, приложенного к
pn-переходу
44. Распределение неосновных носителей в базе
p n Wn p n p n 0Vсм
p no exp
1
T
45.
Аналогичные явления происходят в p-области: сюда из nобласти инжектируются электроны и концентрацияизбыточных электронов при x=-Wp составит:
Vсм
n p W p n po exp
1
T
46.
Если к pn-переходу приложено обратное смещение(минус батареи к p-типу, плюс – к n-типу), потенциальный
барьер повышается на q k . Толщина слоя ОПЗ
увеличивается:
2 0 s
Nd Na
Wобр
k Vсм
q
Nd Na
47.
Чем сильнее переход смещен в обратном направлении,тем выше потенциальный барьер, и тем меньшее
количество основных носителей заряда способно
преодолеть возросший потенциальный барьер. В
соответствии с этим количество неосновных носителей
заряда в приконтактной области уменьшается по
сравнению с равновесным состоянием, следовательно,
уменьшается и количество основных носителей заряда
вследствие соблюдения электронейтральности. Это
явление носит название экстракции носителей заряда
48.
Таким образом, при обратном смещении pn-перехода токосновных носителей заряда будет меньше, чем при
равновесном состоянии, а ток неосновных носителей
заряда практически не изменится. Поэтому суммарный
ток через pn-переход будет направлен от n-области к pобласти и с увеличением обратного напряжения вначале
будет незначительно расти, а затем стремиться к
некоторой величине, называемой током насыщения Js.
49.
Прямое смещение p-n-перехода50.
Энергетические диаграммы при прямом иобратном смещении p-n-перехода
51. Идеальная МДП–структура
Если на окисел, покрывающий поверхность кристалла,нанести металлический электрод (затвор), то, изменяя его
потенциал относительно объема кристалла, возможно изменять
величину заряда в приповерхностной области полупроводника
и, соответственно, её проводимость.
Этот эффект положен в основу целого ряда
полупроводниковых устройств, среди которых самое
известное – МДП-транзистор.
52.
МДП-структура53. МДП-структура
54.
• На границе металл-диэлектрик,диэлектрик-полупроводник, а в отсутствии
диэлектрика на границе металлполупроводник возникает контактная
разность потенциалов:
q
1
2
k
55. Обогащение
n-тип56. Обеднение
p-типn-тип
57. Инверсия
p-типn-тип
58. Допущения для «идеальной» МДП-структуры
• Разность работ выхода между металлом затвора идиэлектриком, диэлектриком и полупроводником, равна
нулю.
• Диэлектрик является идеальным изолятором.
• В диэлектрике и на границах раздела металл-диэлектрик и
полупроводник-диэлектрик нет никаких зарядов, т.е.
диэлектрик не имеет дефектов.
При любых смещениях в структуре могут существовать
только заряд в ее полупроводниковой части и равный ему
заряд противоположного знака на металлическом
электроде, отделенном от полупроводника слоем
диэлектрика.
59. МДП-структура
60. Для характеристики изгиба будем использовать понятие поверхностного потенциала φs
ρ x q N a2 x
E x
2
x
s 0
0 s
x
0
d
0 при х w
dx
q N a
2
x w
2 s 0
q N a w 2
s
2 s 0
61. Расчет параметров
62. К расчету МДП-структуры
(4.6)(4.7)
(4.8)
(4.9)
(4.10)
(4.11)
(4.12)
63. Емкость барьера Шоттки
0 q Nd 0 SC S
2 k Vсм
L
k Vсм
q 0 Nd S
2C 2
2
64. Емкость p-n–перехода
Сбар0 s S
W Vсм
q 0 s
Nd Na
S
2 k Vсм N d N a
65. Диффузионная емкость pn-перехода
Диффузионная емкость pnпереходаC диф
( I p p I n n )
T
S
j p p j n n
T
66. Емкость МДП-структуры
Управляющийэлектрод
Полупроводник
диэлектрик
p-п/п
Me
U
EС
Cs
Cd
Ef
q ms
U
ms
Диэлектрик
а)
EV
обедненный
слой
б)
67.
1010
-4
P-тип Si (300K)
-5
Na 4 1015 cm 3
~ exp(q s /2kT)
|Qs|, Кл/см
(Обогащение)
-7
~ s
Плоские
зоны
10
Обед
нение
-8
10
-9
B
Ev
-0,4
(Сильная
инверсия)
B
-6
10
10
~ exp(q s /2kT)
-0,2
0
0,2
Слабая
инверсия
Ec
Ei
s,B
0,4
0,6
0,8
1,0
68. С-V-характеристики идеальной МДП-структуры
Cd1,0
Cd
Cb
(емкость
плоских зон)
0,6
C/Cd
(a)
0,5
s b
s b
Cmin
(б)
0,4
Cmin
(в)
0,2
0
s
0
s,B
s
69. Заряды в окисле
МеталлNa+
заряд подвижных
ионов Q
K+
заряд захваченный
в окисле
Фиксированный
заряд окисла
SiO 2
+++
+
+
SiO к
+
+
+
+
+
+
+
+
+
---
Заряд, захваченный
поверхностными ловушками
Si



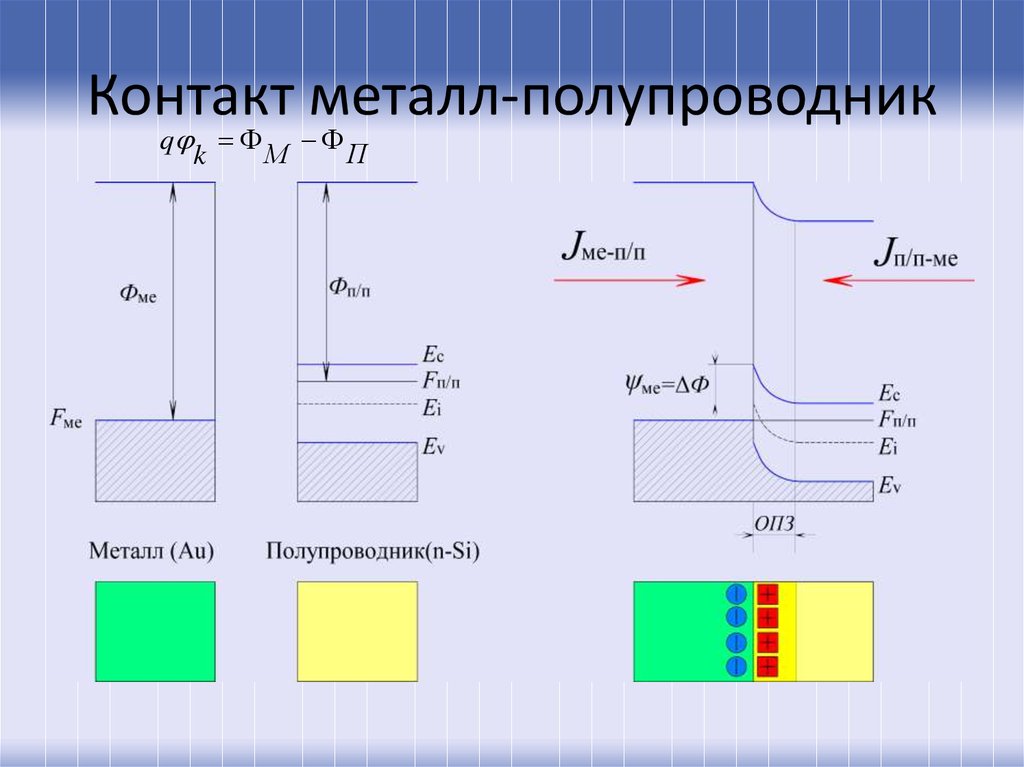
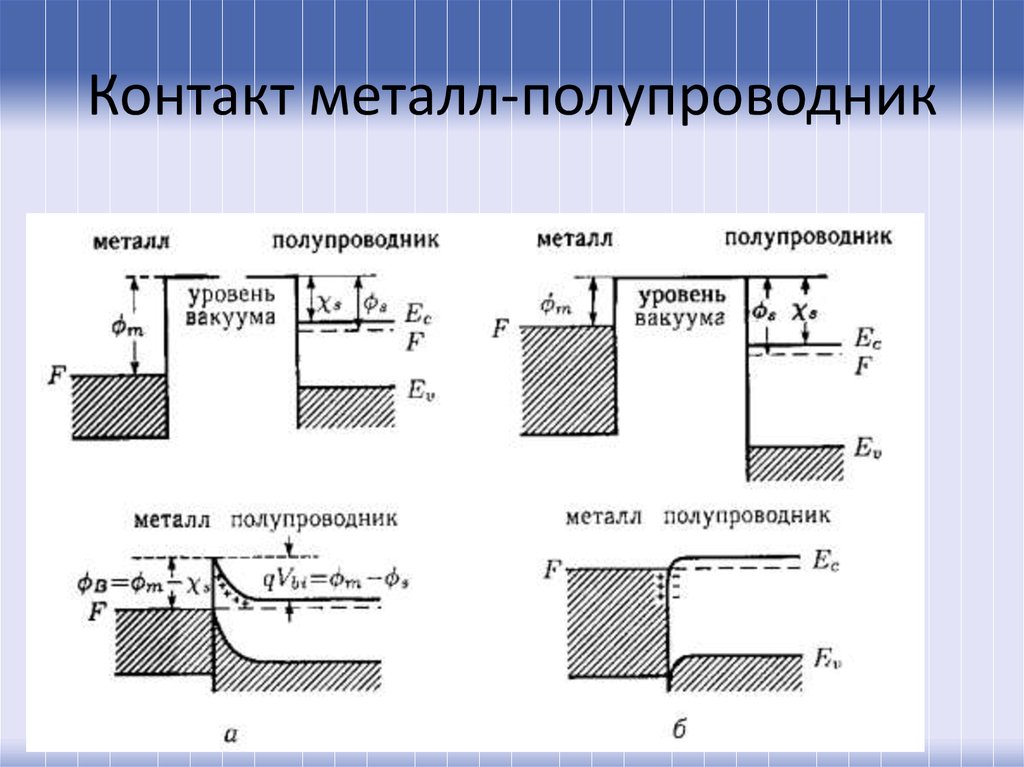














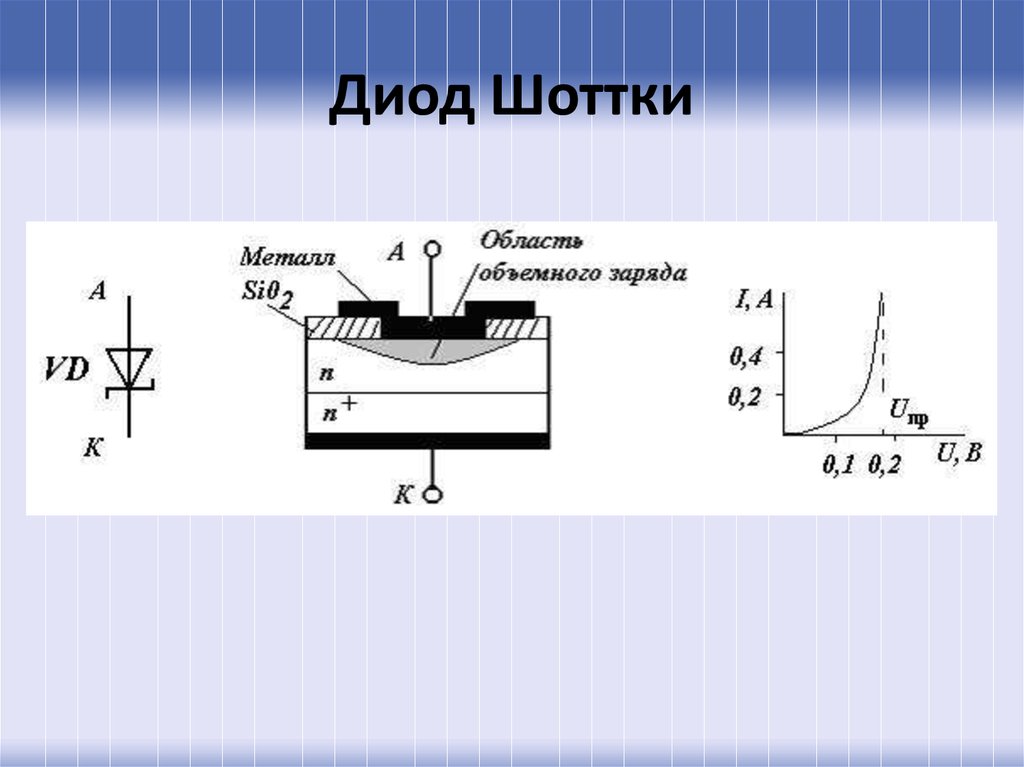



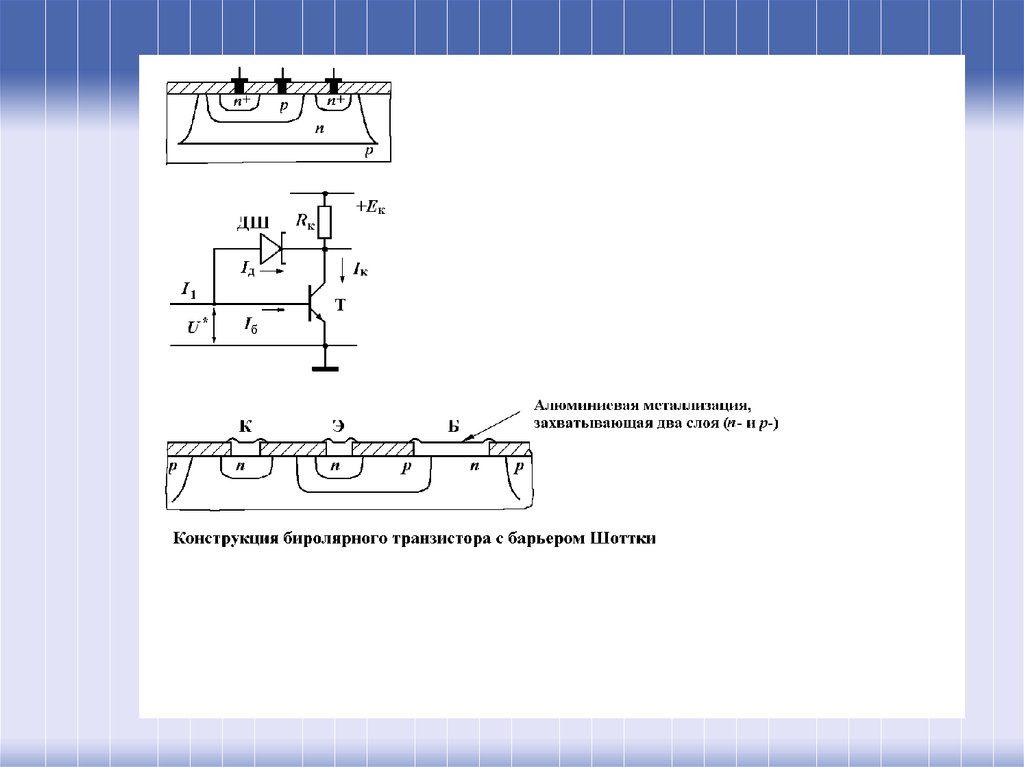
























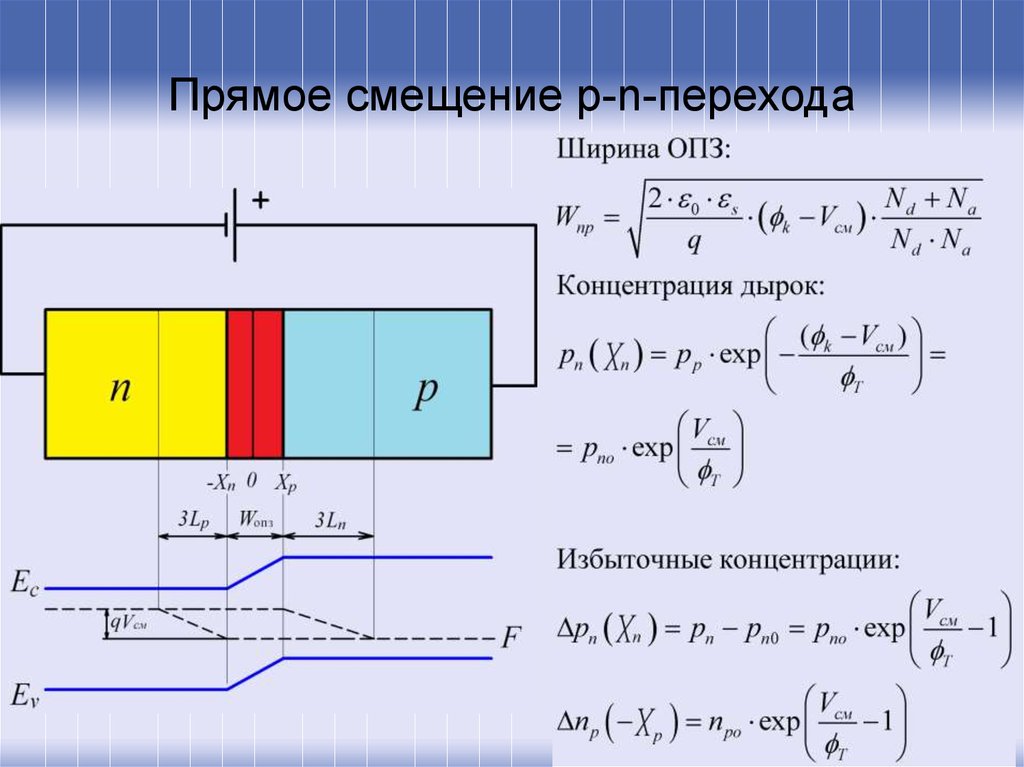



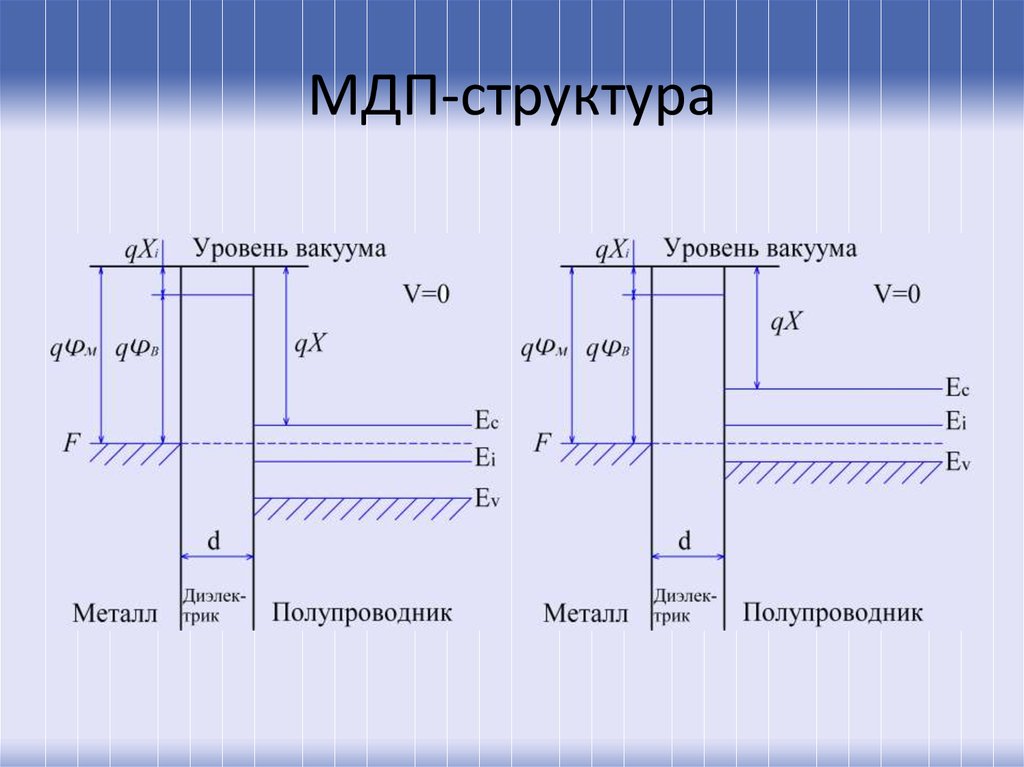



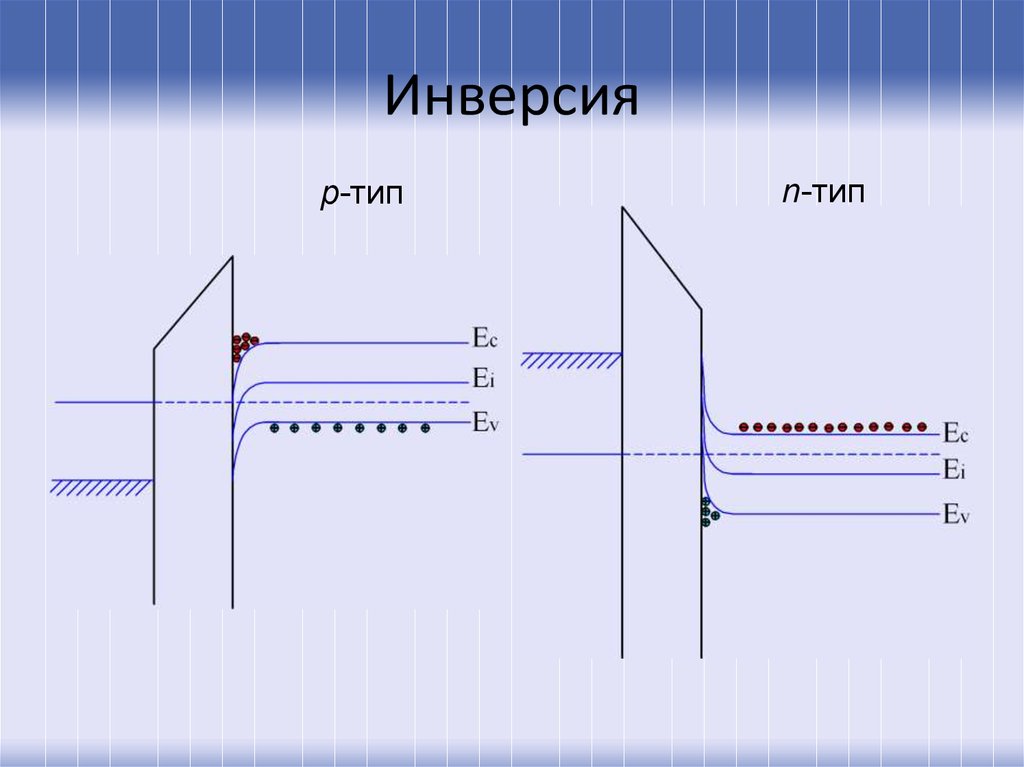








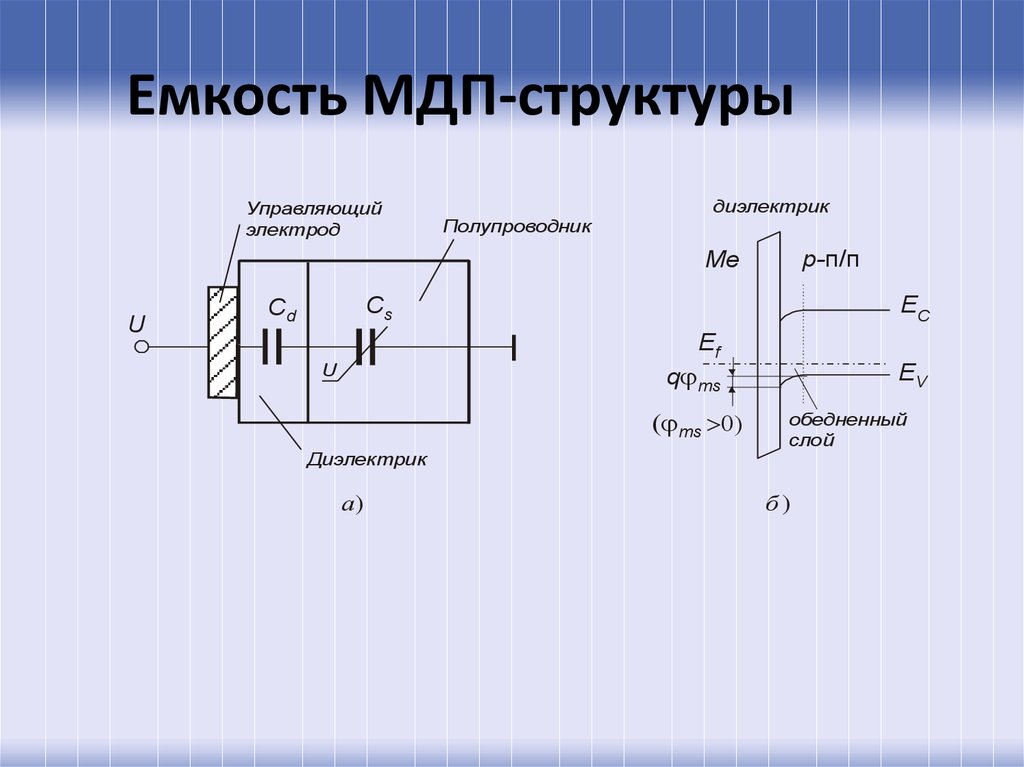
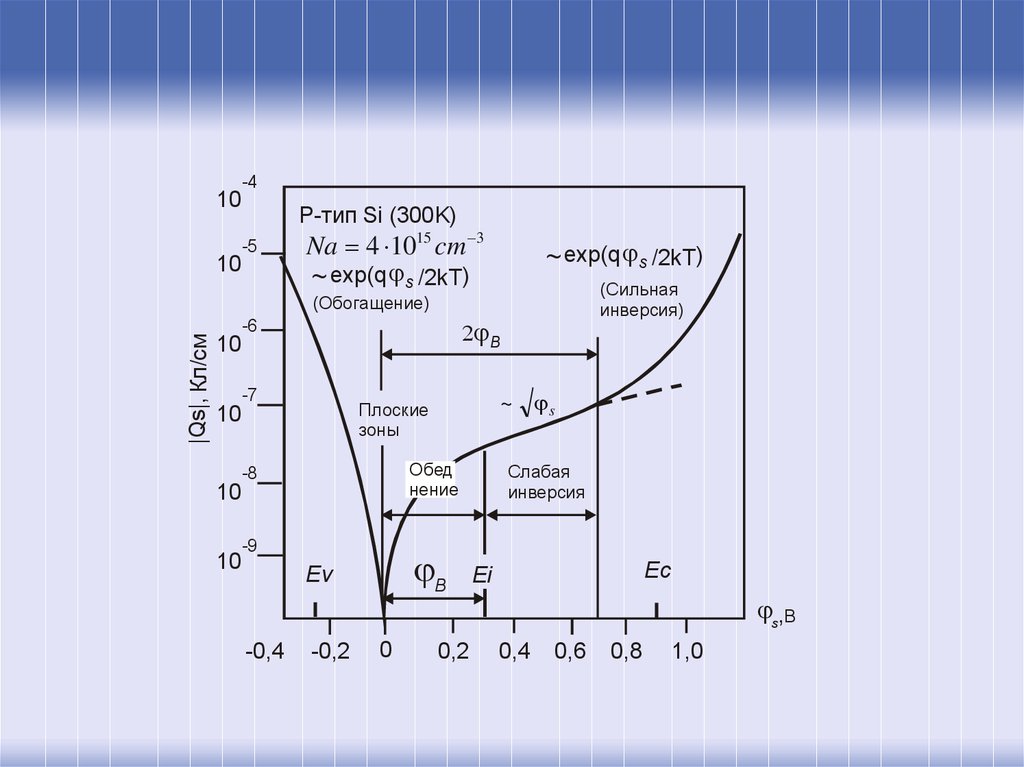
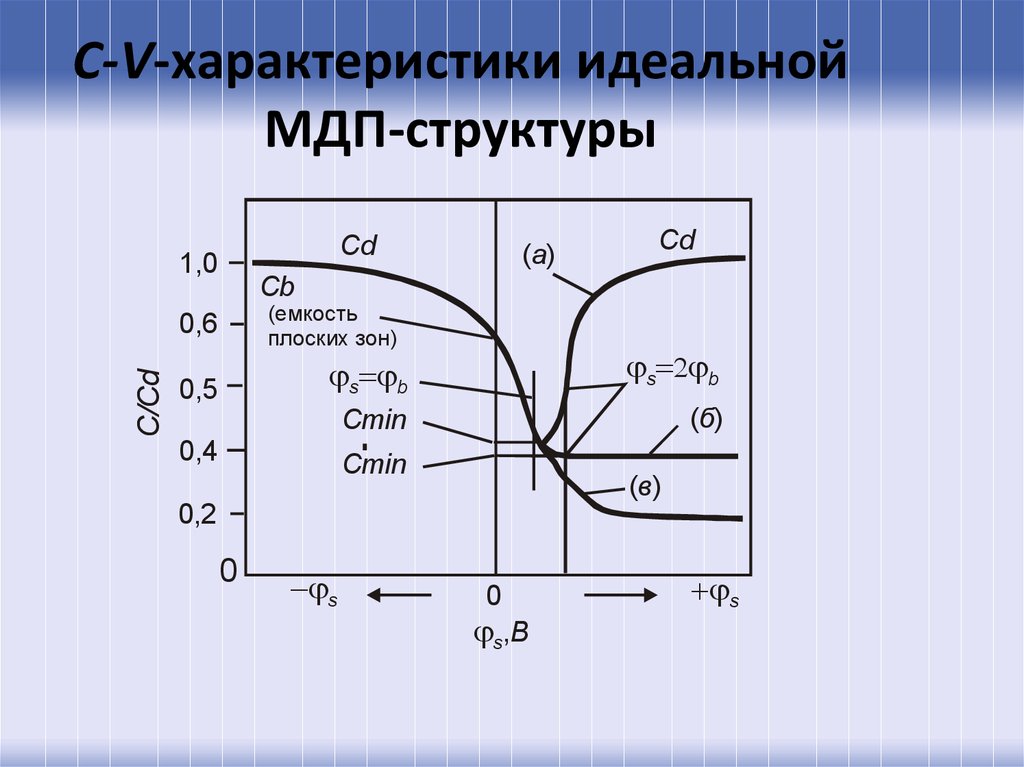

 physics
physics








