Similar presentations:
Активные слои тонкопленочных приборов на основе аморфного кремния
1.
Активные слои тонкопленочныхприборов на основе аморфного
кремния.
Бахов В.А.
2. Актуальность темы
3. Теоретические методы изучения андерсоновской локализации
4. Приближённые методы, основанные на теориях эффективной среды или на теории многократного рассеивания
5. Магнетронная установка
а)б)
в)
Рис.1.11. а)Упрощённая схема МРС – установки. ,б) Установка для магнетронного
распыления в) Вакуумная установка УРМ-3.279.011
6. Вакуумная камера
а)б)
а)Вакуумная камера с ионными источниками и стендом для напыления подложек.
б)Устройство источника ДУ-150.
7. Модернизированный магнетрон
а)б)
в)
Модернизация магнетрона а)Магнетронная распылительная систе-ма с
цилиндрической кремниевой мишенью Ø 80 мм. Зона эрозии материала с поверхно-сти
мишени: кольцо, внешний диаметр ко-торого 58мм, внутрен-ний – 18мм б)Схема
магнетронной распылительной системы с плоской мишенью 1, 3 – Вакуумные
уплотнительные прокладки; 2 – изолирующее кольцо; 4 – фланец; 5 – зона плазмы; 6 –
подложка; 7 – осаждаемая пленка; 8 – зона эрозии; 9 – электрическое поле; 10 – анод; 11
– магнитное поле; 12 – периферийные постоянные магниты; 13 – основание блока; 14, 17
– трубки; 15 – центральный магнит; 16 – клемма; 18 – корпус; 19 – мишень – катод. в)
Магнетрон со снятым катодом. Магнитная система магнетрона.
8.
Параметры магнетронной распылительной системы90
Диаметр катода, мм
20
6
Магнитная система
постоянные магниты
(SmCo)
Магнитное поле на поверхности катода, Тл
Коэффициент использования катода, %
Рабочий газ
Рабочее давление, Па
Мощность распыления, кВт
0,022-0,05
25,4
0,4÷0,532
1,5
0,015
Радиус цилиндрической поверхности
условного анода, м
0,0108
4•10-4
Площадь поверхности плазменного тороида,
м2
8•10-3
Эффективность процесса
плазмообразования
Энергетическая эффективность системы
ионного распыления, кг/Дж
Скорость распыления мишени, нм/с
5
0
0
100
200
300
400
500
600
U,B
Расчетные вольт-амперные
характеристики при индукции
магнитного поля 0,035Тл и
давлении.(1,3÷1,86•10-1 Па)
2,38•10-3
Площадь сечения плазменного тороида, м2
Энергетическая эффективность процесса
ионного распыления, кг/Дж
10
Ar
Расстояние от катода до условного анода, м
Площадь распыляемой поверхности катода,
м2.
15
I,A
Толщина катода, мм
4,56•10-9
0,6
2,9•10-9
254
Удельная скорость распыления - 440х10-5
г/см2
с;
энергия
генерируемых частиц - 10-20эВ;
энергия осаждаемых частиц - 0,210,0эВ; скорость осаждения 1060нм/с;
рабочее давление в
рабочей камере -(5-50)*10-2 Па.
700
9. Кристаллодержатели
аб
а)Маски для напыления контактной сетки б) Использование вакуумных красок
в) кристаллодержатели 65x65.
в
В процессе напыления применялись разные типы масок, и строения с разными
размерами, в основном в напылении применялись крепления для 65x65, 125x125, 45x45.
10. Образцы
аб
рис. 5. а)Экспериментальные образцы б) Образцы для оптики.
Были получены образцы с разными структурами и режимами получения, на разных
подстилающих поверхностях: Покровное стекло, Ситалл, Фото стекло, крист n-Si,
крист p-Si, микрокристаллический Si.
11. Структуры образцов гидрированного a-Si
fg-aSi:H(0)fg-aSi:H(10)
fg-aSi:H(20)
fg-aSi:H(30)
fg-aSi:H(50)
psaSi:H(10)
psaSi:H(20)
psaSi:H(30)
psaSi:H(50)
stl-aSi:H(0)
stl-aSi:H(10)
stl-aSi:H(20)
stl-aSi:H(30)
stl-aSi:H(50)
stl-aSi:H(0)-Al
stl-aSi:H(10)-Al
stl-aSi:H(20)-Al
ps-aSi:H(0)
stl-aSi:H(30)-Al
stl-aSi:H(50)-Al
12. Структурные схемы образцов для исследования разной стехиометрии аморфных плёнок а также барьеров
аб
в
г
д
е
а) Покровное стекло + a_n-Si б) Фотостеколо стекло + a_n-Si, в) Покровное стекло + a_p-Si г)Фотостеколо стекло + a_pSi д) a_n-Si + Ситалл е) a_p-Si +Ситалл
а
к
б
л
в
м
х
г
д
н
о
ц
ч
е
п
ш
щ
ё
ж
з
р
с
т
ъ
и
у
й
ф
ы
а) Al конт + a_n-Si + Ситалл б) Al конт + a_p-Si + Ситалл в) Al конт+ a_n-Si+ Фотостеколо г) Al конт+ a_p-Si+ Фотостеколо д) Al конт+ a_nSi+кристал n-Si
е) Al конт+ a_p-Si+кристал n-Si ё) Al конт+кристал n-Si ж) Al конт+ a_n-Si+кристал p-Si з) Al конт+ a_p-Si+кристал p-Si
и) Al конт+кристал p-Si й) Al конт+ a_n-Si+микрокристал -Si к) Al конт+ a_p-Si+микрокристал -Si л) Al конт+микрокристал-Si м) Al конт+ a_nSi+кристал n-Si+ Al конт н) Al конт+ a_p-Si+кристал n-Si+ Al конт о) Al конт+ a_n-Si+кристал p-Si+ Al конт п) Al конт+ a_p-Si+кристал p-Si+ Al
конт р) Al конт+ a_n-Si+микрокристал -Si+ Al конт с) Al конт+ a_p-Si+микрокристал -Si+ Al конт т) Al конт + a_n-Si+ Ситалл у) Al конт+ a_nSi+ Фотостеколо ф) Al конт+ a_n-Si+кристал n-Si х) Al конт+ a_n-Si+кристал p-Si
ц ) Al конт+ a_n-Si+микркрист -Si ч) Al конт+кристал
n-Si ш) Al конт+кристал p-Si
щ) Al конт +микркристал-Si ъ) Al конт + a_p-Si + a_n-Si+ Фотостеколо ы) Al конт + a_p-Si + a_n-Si+
Ситалл
13. Структурные схемы образцов контактных площадок, и гетероперехода
psps+anSi
fg
fs+anSi
stl
stl+anSi
cn- Si
stl+apSi-Al
cnSi+apSi-Al
fs+apSi-Al
stl+apSi-Al
cnSi+apSi-Al
bAl-cnSi-pcSi-cnSi-anSi-fTi
cpSi+anSi
cnSi+anSi
fs+apSi-Al
mcpSi+an
Si
cpSi+apSi-Al
mcpSi+apSi-Al
cpSi+apSi-Al
mcpSi+apSi-Al
bAl-cnSi-pcSi-cnSi-fTi
bAl - cn-Si-cpSi- an-Si - fTi
mcp- Si
cp- Si
stl - anSi - Ti
0
14.
Исследование контактов и плёнок для солнечнойэнергетики
Ag
Ag
Ag
Ti
Ag
Ag
Ag
Ti
Ti
Ti
anSi:H
cnSi
cpSi
anSi:H
cnSi
cpSi
cnSi
cpSi
cp+Si
cp+Si
cp+Si
Al
Al
Al
Ti
Ti
Ti
Ti
Ti
Ti+Si
anSi:H
stl
cnSi
cpSi
anSi:H
cnSi
cpSi
Ti+Si
anSi<Ti>:H
ps
cp+Si
Al
cp+Si
Al
Ti+Si
anSi<Ti>:H
fg
Ti
15. Исследование нитридов
anSi:HSiN-C
cnSi
cpSi
anSi:H
fg
cnSi
SiN-C
cnSi
cpSi
SiN-M
SiN-C
cnSi
SiN-M
fg
cpSi
fg
cnSi
cnSi
SiN-M
anSi:H
SiN-C
SiN-M
anSi:H
anSi:H
cnSi
stl
fg
cpSi
anSi<Ti>:H
ps
cnSi
SiN-M
stl
stl
SiN-M
ps
ps
anSi:H
cnSi
cpSi
SiN-M
SiN-M
anSi<Ti>:H
ps
anSi:H
stl
cnSi
16. Температурные исследования в диапазоне температур от комнатной до 100с
17. Установка для низкотемпературных измерений
1-кварцовая колба2-зажимы
3-образец
4-подложко держатель
5-термоизоляционный сосуд
6-подставка
7-жидкий азот
8-термопара
18. Оборудование для спектральных исследований
а)б)
рис. 2.3. а)Монохроматор МДР-4 “ЛОМО”. б) Оптическая схема монохроматора
19. Оборудование для спектральных исследований
a)a)Ход лучей монохроматора МДР-4
b)Фотография установки
с) Разработанная система съемки
образцов 1- ход луча 2-щель
монохроматора 3- входная щель
измерительного стенда 4фокусирующая щель 5-образец
6-фотоприёмники 7-подвижный
столик 8-приборный комплекс
b)
1
8
6
2
3
4
5
6
7
c)
20. микроинтерферометра Линника МИИ-4
а)б)
в)
а)Оптическая схема МИИ-4 б)Микроинтерферометр МИИ-4, в) Схема микроинтерферометра МИИ-4
21. Оборудование для измерения вольтамперных характеристик
Прибор ППП Л2-56Характериограф-z
22. Зависимость проводимости от температуры с разными
концентрациями водорода в плазме1 stl-aSi-H(0)
2 stl-aSi-iH(46)
a) d=210нм
3 ps- aSi-H(20)
4 stl-aSi-H(20)
5 stl-aSi-H(30).
b) d=500нм
f) d=180нм
d) d=490нм
c) d=180нм
23. Влияние водорода на проводимость
24. Спектры
25. Спектры прохождения
SiNx-p1-180нм, SiNx-p2-160нм, aSi -150нм, aSi-SiyNx-10нм+35нм26. Спектры aSi:NX ,толщины контролировались расстоянием от магнетрона
1-180нм 2-160нм27. Вольт-амперные исследования
1– mc-Si<P>; 2– с-Si<P>; 3– c-Si<B>.28. Исследования пробоя
Переход a-Si/с-SiAl
a-Si:H
Al
n 0,5 мкм
p
50 мкм
c-Si
Al
29. Введение в модель
22
1
e2
(
i ) (
a ) V0 ( R1 , R2 ...RN ) U (r1 , r2 ,...rn , R1 , R2 ,...RN )
2m
2M
2 i j rij
i
a
30. Введение в модель
c а С~ 2 A~ (cos( k x a) cos( k y a) cos( k z a))d1 ( а a 1 ) / 2 Cd1 1
d 2 ( а a 1 ) / 2 Cd 2 2
....................................
( ) / 2 C
а
a 1
dm
m
dm
С
2
A
cos(
k
a)
а
~
~
c
((
)
/
2
C
)(
1
ln(cos(
2
k
b j )) )
d j
а
a 1
dj
j
bj a
Nd j
Nc
31. Проводимость
dn f(E,T)N(E) dEn
E2
f(E,T) N(E ) dE nr nt
E1
n
Ec
f(E,T) N (E) dE f(E,T) N (E) dE
r
Eñ
t
Ev
nt
Ec
2 m * 3/ 2
nr 2
h3
f(E,T) Nt (E) dE
Ev
0 A e
~
E / kT
E
1/ 2
(2 m * kT ) 3 / 2
dE
A
4 3 h3
32. Проводимость
ntEc
f(E,T) Nt (E) dE
f(E,T) e
E F
kt
e
vξ
kt
Ev
t j (( а a 1) / 2 Ct j j )(1 ln(cos( 2 k b j )) )
bj α
Nd j
Nt (E)
Nc
nt
Ec
Ev
e
vξ
kt
z
j 1
b j Nc
α
1
nt b j Nc e
j 1 α
z
dξ
v jξ j
kT
Nt (E)
z
j 1
z
Nd j
j 1
b j Nc
α
33. Проводимость
n( 2π m * k T) 3 / 2
4π 3 h 3
( 2π m * kT)
σ eμn
3 3
4π h
z
1
A b j N c e
j 1α
3/ 2
'
n
eμ
A
α
v jξ j
kT
z
b N e
j c
j
c
v jξ j
qkT
34. Объяснение вольт-амперных характеристик
J q( Dn1 / Ln1 )( N c1 N D1 / N c 2 ) * exp( qVb /( kt))[exp( qV /( kt)) 1]ND
z
b j Nc e
j 1
v jξ j
kT
35. Классификация по стехиометрии
nN (E) dE f(E,T) N (E) dE
f (E,T)
r
Ec
n
Ec
Ec
f (E,T)
N r(E) dE f(E,T) Nt(E) dE
Ev
Ec
t
Ev
36. Расчётные показатели и b для экспериментальных данных
Расчётные показатели и b дляэкспериментальных данных
Моды
,eV
Si-OH
b 104
0%
30 %
40 %
0,572
0,7
1,1
1,8
Si-O-Si-H
0,608
1,0
2,5
4,8
Si-O-Si-H
0,627
0,9
1,9
3,1
(SiH2)n
0,634
0,9
2,4
4,0
SiH3
0,638
0,8
2,5
4,3
Si-H
0,639
0,8
2,8
4,7
H-Si-H
0,641
0,8
2,6
4,7
Si-H
0,653
0,7
1,8
3,2











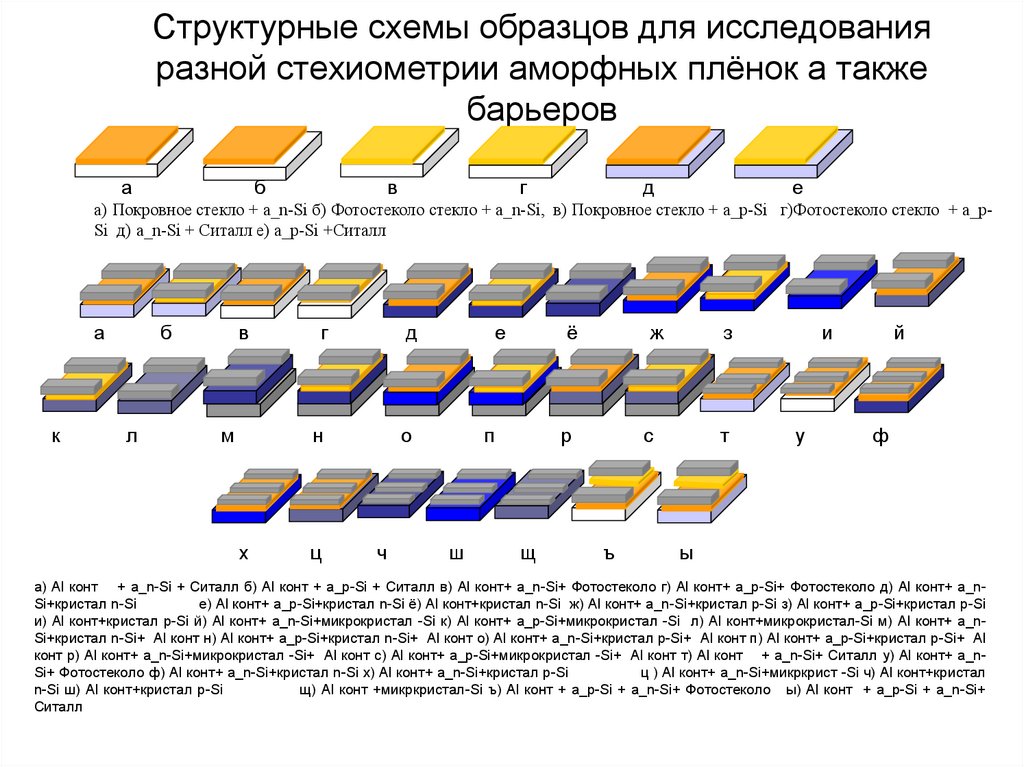

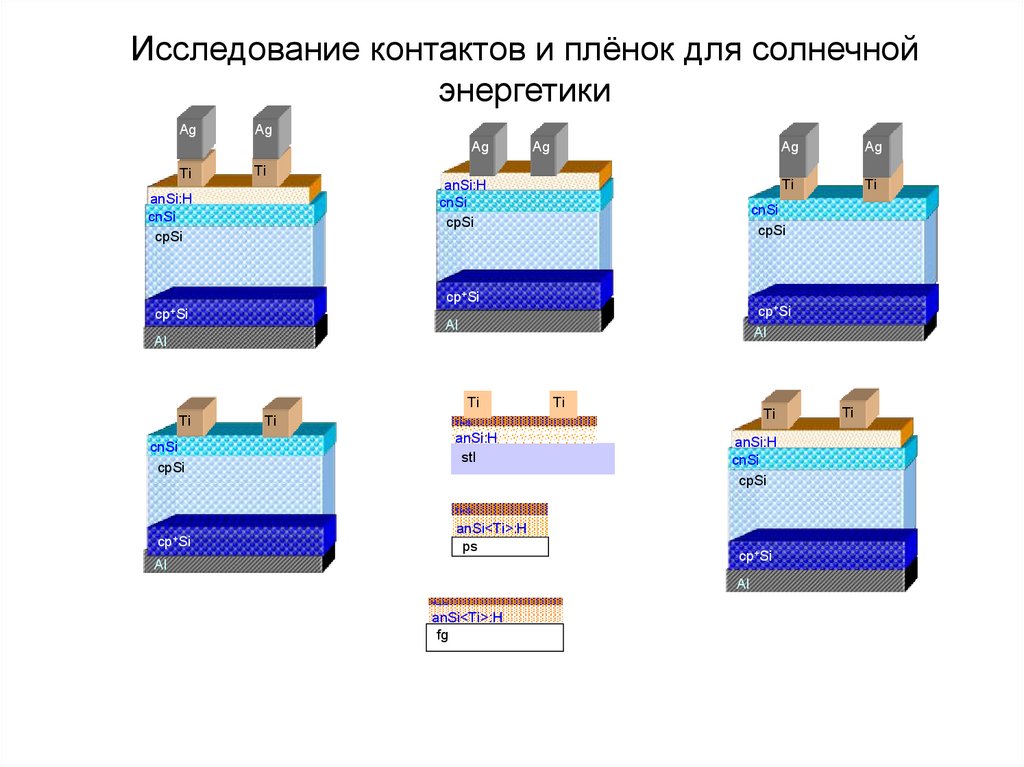





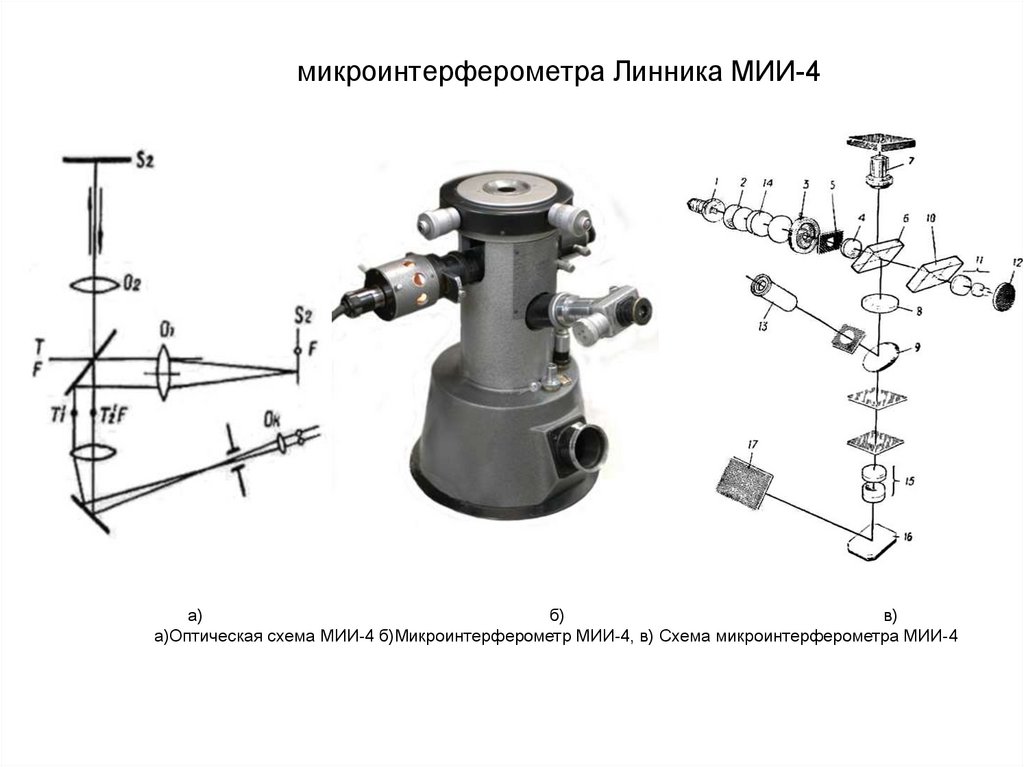


















 physics
physics electronics
electronics








