Similar presentations:
Классификация и краткое описание основных спектроскопических методов исследования поверхности и наноструктур
1. Борисюк Петр Викторович ПРАКТИЧЕСКАЯ СПЕКТРОСКОПИЯ КАФЕДРА «Физико-технических проблем метрологии»
12. Лекция 1 Классификация и краткое описание основных спектроскопических методов исследования поверхности и наноструктур.
Разные методы позволяют получить различную информацию об исследуемомобъекте: информация об их атомной структуре, элементном составе и электронных
свойствах. Возможности основных методов исследования наноструктур и поверхности
с точки зрения получаемой с их помощью информации.
Метод
Русское
Английское
название
название
РСА,
XRD,
ДМЭ/ДБЭ,
LEED/HEED,
ПЭМ, РЭМ,
TEM, SEM,
ПЭМ, ПИМ,
FEM, FIM,
АСМ, МСМ
AFM, MFM
СТМ/СТС
STM/STS
СРБИ, ОРР
HEIS, RBS
СРМИ
LEIS
ПТСРСП
EXAFS
ОСРСП
XANES
ОЭС, СОЭМ
AES, SAEM
РСМА
EDX/WDX
ВИМС
SIMS
РАС, РЭС
XAS, XES
ТПД
TPD
РФЭС/ЭСХА
XPS/ESCA,
ФЭС, РОЭС
PES, XAES
УФЭС,
UPS, IPES
ИФЭС
СХПЭЭ
EELS
ИНС
INS
Атомная
структура
Элементный
состав
Электронные
свойства
+
-
-
+
+
(+)
+
(+)
-/+
-
+
+
+
+
+
+
+
+
+
+
+
(+)
+
+
(+)
(+)
+
-
-
+
-
-
+
+
2
3.
Физические принципы РФЭС И ОЭСОтличительные особенности РФЭС:
- исследование приповерхностных слоёв (длина
пробега λ = 5–25 Å для металлов и оксидов и
λ = 40–100 Å для органических материалов и
полимеров);
- неразрушающий метод контроля поверхности;
- чувствительность к локальной электронной
плотности, анализ химического состава
образцов.
ИЗЛУЧАТЕЛЬНАЯРЕКОМБИНАЦИЯ
h BE j BE k
KE jkl BE j BE k BE l
ОЖЕ-РЕКОМБИНАЦИЯ
hν = KE + BEj + φ
ФОТОЭФФЕКТ
3
4. Пример: обзорный спектр и относительная атомная концентрация элементов в поверхностном слое образца
NaKLLO1s
↓
N1s
↓
O KLL
Na1s
C1s
1000.00
750.00
500.00
Binding energy, eV
S2s
250.00
S2p
Na2s
Na2p
0.00
4
5.
Спектры оже-серий в РФЭСa
KL L
23 23
1) Серия KLL оже-переходов
(KL1L1, KL1L2, KL1L3, KL2L3, KL2L3,
KL3L3) от B до Na (MgKα), до Mg
(AlKα);
2) Серия LMM, от S до Ge
(MgKα), до Se (AlKα);
б
L3M 23M 45
L3M 45M 45
L3M 23M 23
KL1L23
L2M 23M 23
KL1L1
L2M 45M 45
3) Серия MNN, от Mo до Nd
(MgKα), до Se (AlKα);
460 470 480 490 500 510 520 530
KE, эВ
650
700
750
800
850
900
KE, эВ
Зависимость положения линий
фотоэлектронов и оже-электронов в
шкале ВЕ и КЕ от энергии источника
рентгеновского излучения.
KE jkl BE j BE k BE l
5
6.
Физические основы СТМ и СТСТуннелирование электрона через
потенциальный барьер:
одномерная задача для свободного электрона
Aeikx Be ikx ( x 0),
( x ) Ce x De x (0 x d ),
Feikx
( x d ),
2 d 2
V ( x) E 0
2
2m dx
k 2mE /
2m( E V0 ) /
Коэффициент пропускания
T F/A
Экспоненциальная зависимость
туннельного тока ширины барьера:
Обратная длина затухания к ~ 1 А-1
2
при
d 1/
16k 2 2 2 d
T 2
e
2
k
I B exp( Ad ) eV exp( Ad eV )
при увеличении ширины барьера (расстояния между зондом и образцом) на 1 Å
туннельный ток уменьшится в ~ 7 раз:
I d
exp 2 d
exp 2 d ~ e 2
I d d exp 2 (d d )
6
7.
Оценка величины туннельного токаI en s v F STV
8
2
15
при n ~ 1022 см-2, s ~ 0.5 эВ-1, v F ~ 10 см/с, S ~ a ~ 10 см2, V ~ 1 В
T exp 2 d ~ 10 4 при ~ 10 нм-1 и d ~ 0.4 нм получаем I
~ 10 нА.
Пространственное разрешение СТМ
7
8.
Сканирующая туннельная спектроскопия.Дифференциальная туннельная проводимость
dI
~ s eV T , d , eV , eV
dV
dT , d , eV ,
s
d
dV
EF
E F eV
dI / dV
~
I /V
s eV
E F eV
~
1
V
dT , d , eV ,
d
T , d , eV ,
dV
EF
E F eV
EF
s
T , d , eV ,
s
d
T , d , eV , eV
8
9. Монтаж СВВ камеры СТМ/АСМ на комплексе анализа поверхности и наноструктур Multiprobe MXPS VT AFM, Omicron NanoTechnology GmbH в
наноцентре НИЯУ МИФИ9
10.
Спектроскопия рассеяния медленных ионов.Классификация методов рассеяния ионов:
- СРМИ (LEIS), Е=0,1 – 10 кэВ;
- СРСИ (MEIS)
- СРБИ (HEIS), Е=0,01 – 2 МэВ;
- ОРР (RBS), Е > 2 МэВ
Получаемая информация:
1) Элементный состав поверхности образца (положение линий);
2) Относительная концентрация поверхностных атомов (интенсивность линий);
3) Структура поверхностной решетки (угловые зависимости);
4) Химическое состояние поверхностных атомов (тонкая структура, иногда).
Особенности метода СРМИ: Глубина зондирования один-два атомных слоя
поверхности, вследствие:
1) ослабления интенсивности ионного пучка по мере его проникновения вглубь
образца вследствие большого сечения рассеяния;
2) увеличения вероятности нейтрализации ионов, рассеянных на глубоких
поверхностных слоях.
Историческая справка. Первое применение РМИ для исследования
поверхности (1967).
10
11.
СРМИ. Кинематический фактор.E1 kE0
k
cos
1
1
2
2
sin 2
1/ 2
2
M /m
знак «+» при рассеянии на тяжелом атоме,
знак «-» при рассеянии на легком атоме
Учет неупругих потерь энергии – фактор Q:
k
1
1 2
I I0N
Q
cos 2 sin 2 (1 )
E0
1/ 2
2
d
0 Pi
d
Сечение рассеяния определяется потенциалом
взаимодействия иона и атома-рассеивателя
11
12.
Применение метода СРМИ для определениястепени покрытия поверхности
I ( ) / I
островковый рост (механизм
Фолмера–Вебера)
послойно-островковый рост
(механизм Франка – Ван–
дер–Мерве)
TiO2(110)
послойный рост (механизм
Странского–Крастанова
12
13.
Спектроскопии рассеяния электронов на отражение СРЭОd
Ie ~
( )
d
d
d
d
( ) f ( )
d
2
– дифференциальное сечение
упругого рассеяния электронов
на атомах образца;
S (q ) exp 2W (q )
I e ~ f ( ) S (q) exp 2W (q)
2
13
14.
Спектроскопия характеристических потерь энергииэлектронов СХПЭЭ
2
1
~ Im
E
(
q
,
)
( ) 1
2
f 0 pl
i 0
2
– дифференциальное сечение
неупругого рассеяния
электронов на атомах образца;
n
2
f j pl
2
2
i j
j 1
j
14
15.
Экспериментальные спектры рассеяния отраженныхэлектронов для системы кластеров Au
Спектры неупругогорассеянных электронов
Возбуждение
плазмонов и
межзонных
переходов
Au/SiO2
Au/ВОПГ
Au/Ni
15














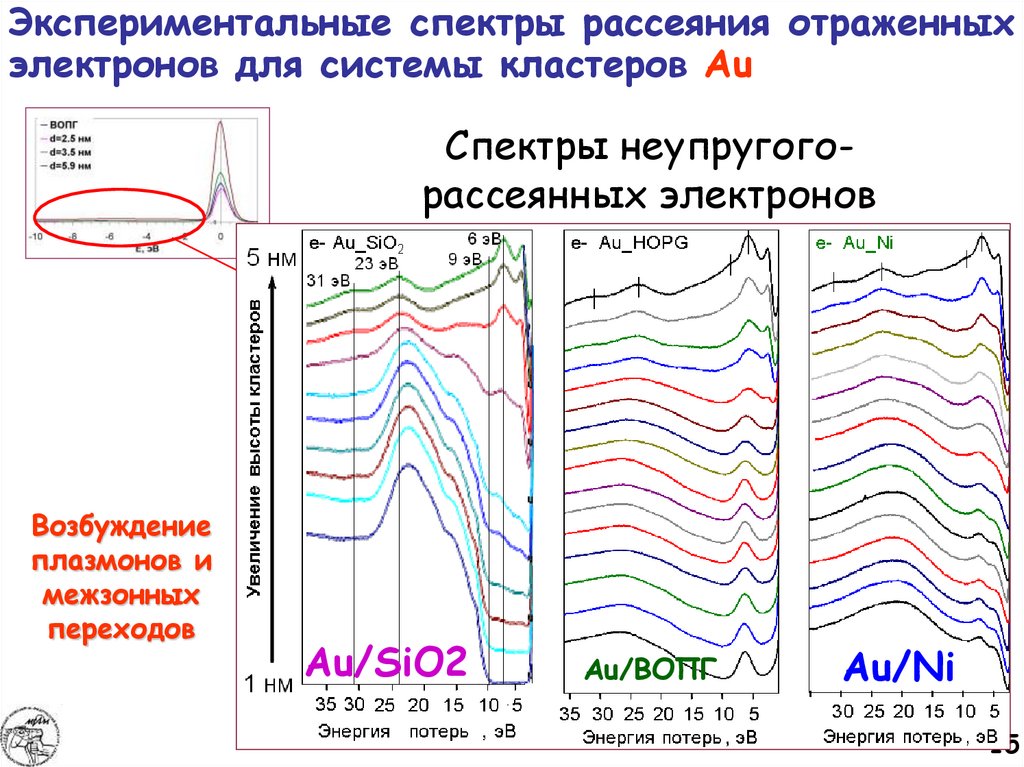
 physics
physics








