Similar presentations:
Классификация нано-объектов
1. Наномеханика материалов и систем
Профессор ЧалдышевВладимир Викторович
chald.gvg@mail.ioffe.ru
2. Учебный план. Часть 1 – механика нано-объектов в среде
Учебный план. Часть 1 – механика нанообъектов в среде1. Механизмы формирование наносистем
в твердых телах.
2. Упругие деформации и напряжения в
наноструктурах.
3. Пластическая деформация
наноструктур.
4. Разрушение наноструктур.
5. Упругие волны и внутреннее трение.
3. Учебный план. Часть 2 – нано-электро-механические системы
Учебный план. Часть 2 – нано-электромеханические системы1.
2.
3.
4.
Материалы и технология изготовления наноэлектро-механических систем.
Элементы нано-электро-механических систем.
2.1 Пассивные элементы.
2.2 Активные элементы.
2.3 Нанодатчики.
Применения нано-электро-механических систем.
3.1 Фотоника.
3.2 Электроника.
3.3 Транспорт.
3.4 Информатика.
3.5 Биология и медицина.
3.6 Микрожидкостные системы.
Мировая экономика НЭМС.
4. Литература
Основная• Cleland A.N. “Foundations of Nanomechanics” (Springer-Verlag, Berlin, Heidelberg,
New York, 2003).
• Freund L.B., Suresh S. “Thin film materials: stress, defect formation and surface
evolution” (Cambridge University Press, Boston, 2003, 2009).
• Maluf N., Williams K. “An Introduction to Microelectromechanical Systems
Engineering” (2nd edition. Artech House, Boston, London, 2004).
Дополнительная
• Hearn E.J. “Mechanics of Materials” vol.1-2 (Butterworth-Heinemann, Oxford,
Auckland, Boston, 1997).
• Hearth J.P., Lothe, J. “Theory of Dislocations” (3rd edition. Willey Interscience, New
York, 1982) [Хирт Дж., Лоте И. “Теория дислокаций” (М, Атомиздат 1972)].
• Лурье А.И. “Теория упругости” (М., Наука, 1970).
• Елисеев В.В. “Механика упругих тел” (СПбГТУ, 1999).
• Работнов Ю.Н. “Сопротивление материалов” (М., Физ.-Мат. Лит., 1962).
• Ziman J.M. “Priciples of the Theory of Solids” (2nd edition. Cambidge University
Press, 1972). [Займан Дж. “Принципы теории твердого тела” (М., Мир, 1974)].
• Случинская А.И. “Основы материаловедения и технологии полупроводников”
(М., 2002).
• Вайнштейн Б.К. “Современная кристаллография. Том 1. Симметрия кристаллов.
Методы структурной кристаллографии.” (М., Наука, 1979).
• Johnson K.L. “Contact mechanics” (Cambridge University Press, Boston, 1985).
5. Классификация нано-объектов
пленкаили
слой
2D
нить
или
проволока
1D
островок
или
точка
0D
6. Пример: вертикально излучающий лазер vertical cavity surface emitting laser (VCSEL)
(a)(b)
(a) Schematic of the vertical cavity surface emitting laser. (After Choquette
(2002).) (b) cross-sectional TEM image of the optical cavity and the surrounding
DBR mirror region which comprises alternating layers of high- and low-refractive
index material. The thickness of the optical cavity is 250 nm.
7. Пример: нано-электро-механические системы (НЭМС)
Electron micrographs of silicon NEMS structures made by surface micromachiningand e-beam lithography.
(a) A compound torsional oscillator tilting mirror.
(b) Silicon nanowire resonant structures. (After Craighead (2000))
8. Формирование наноструктур
• Эпитаксия, наращивание, напыление• Само-организация на поверхности или
в объеме
• Литография и травление
9. Планарные технологии
10. Напыление – Sputtering, Physical deposition
11. Напыление
• Бомбардировка ионами, возможно в присутствиивнешних полей: СВЧ, магнетронное, и др.
• Распыляемая мишень осаждается на подложку в
вакуумной камере.
• Типичная скорость напыления 0.1-0.3 мкм/мин.
• Типичная температура < 150 °С.
• Материалы: алюминий, титан, хром, платина,
палладий, вольфрам, Al/Si и Ti/W сплавы, аморфный
кремний, изоляторы, включая стекла и
пьезокерамики (PZT и ZnO).
• Реактивное распыление металлов с участием азота
или кислорода приводит к образованию пленок таких
соединений как TiN или TiO2.
12. Молекулярно-пучковая (лучевая) эпитаксия – molecular-beam epitaxy (MBE)
Схема типичной промышленной установки13. Процессы на поверхности при МПЭ
14. Газофазная эпитаксия (Vapor Phase Epitaxy) в хлоридной системе или с использованием металло-органических соединений
metal-organic chemical vapor deposition (MOCVD)Схема промышленной установки MOCVD
15. Процессы на поверхности при MOCVD
Процессы, происходящие при MOCVD16. Моды эпитаксиального роста
Технология молекулярно-лучевой эпитаксии (MBE) илигазофазной эпитаксии с использованием металлоорганических
соединений (MOVPE, MOCVD).
Моды роста:
Франка—ван дер Мерве (Frank—van der Merve, FM)
Фолмера—Вебера (Volmer—Weber, VW)
Странского—Крастанова (Stranski—Krastanow, SK)
17. Движущая сила эпитаксии – пересыщение (supersaturation) газовой фазы и адсорбционного слоя
ΔF = kTv ln(p/pe), where k = 1.38x10−23 J/K = 8.617x10−5 eV/KF
e
kTs ln( ad / ad )
18. Само-организация
19. Три стадии формирования наночастиц
• Нуклеация (Nucleation) - Гомогенное илигетерогенное образование зародышей новой
фазы за счет флуктуаций.
• Начальный рост (Initial growth) - Рост за счет
обеднения прилегающих областей матрицы.
• Коалесценция (Ostwald ripening) - Рост
крупных частиц за счет растворения мелких
частиц.
20. Поверхностная энергия
ES Sγ > 0 – коэффициент поверхностного натяжения
S – площадь поверхности
Формирование частицы новой фазы связано с образованием
поверхности раздела фаз
21. Нуклеация в объеме
Работа, необходимая для создания зародыша новой фазыW
3
4
3 a F
/ v 4 a
2
Вероятность образования зародыша новой фазы
Gibbs free energy
f exp( W / kT )
Критический зародыш
2 v
ac
F
F kT ln( c / ce )
ac
2 v
kT ln( c / ce )
1J/m ; v 43 r 4 10
2
3
30
m ; k 1.38 10
3
Nucleation barrier
23
ac
J/K ;
a
22. Нуклеация островка на поверхности
eF kTs ln( ad / ad
)
W V F / v A f R2 ( s fs )
Young 1805
> 0 – распад пленки на островки (Volmer - Weber island growth mode)
γs – γfs > γf – полное смачивание; послойный рост пленки (Frank - van der Merwe
growth mode)
23. Нуклеация при пересыщении на поверхности
eF kTs ln( ad / ad
);
W V F / v A f R 2 ( s fs )
ac
eff
2 eff v
;
F
1 cos
f
2
2/3
( 2 cos )1/ 3
24. Давление под искривленной поверхностью
Для двух фаз, находящихся в равновесии,dW ( Pж Pг )dV dS 0;
Vж 43 a 3 ; S 4 a 2 ;
2
;
a
Pж Pж P0 ; Pг Pг P0 ;
Pж Pг
ж г P P vж Pж vг Pг ;
0
Pж
2
vг
2 vж
; Pг
;
a vг vж
a vг vж
kT
2
2 vж
vж vг
; Pж
; Pг
P0 ;
P0
a
akT
Внутри частицы новой фазы
давление повышено
Для давлений г kT ln Pг (T )
kT Pг
2 vж
Pж
ln ; Pг P0 exp
vж P0
akT
γ = 1 Дж/м2
k = 1.38 10-23 Дж/К
a=?
25. Самоорганизация при пересыщении на поверхности
• Выращивание субмонослойныхостровков
• Распад тонких пленок на островки
• Выращивание усов (whiskers, nanowires,
rods) – массивов квантовых проволок –
по механизму пар-жидкость-кристалл
(ПЖК)
26. Механизм роста ПЖК
Пересыщенный парпересыщенная
жидкость
кристаллическая
подложка
кристалл
ус
whisker
nanowire
nanorod
27. ZnO nanowires on sapphire
(a) Plan view and (b) glancing view of ZnO nanowires grown on a-planesapphire. The nanowires grow perpendicular to the substrate and with
nearly perfect rotational alignment with respect to the substrate lattice.
Scale bars are 100 nm. Baxer et. al. JCG 274, 407 (2005).
28. ZnO nanostructures
Typical SEM images showing morphologies of ZnO structures:dense filmlike rods (a), dense filmlike nanoplatelets (c), flowerlike nanoplatelets (e),
nanobelts (g), and nanowires (i).
The corresponding high magnification images are displayed in (b), (d), (f), (h), and (j),
respectively. After C. Ye., X. Fang, Y. Hao, X. Teng, L. Zhang, J. Phys. Chem. B 2005;
29. Одномерные наноструктуры
GH
I
J
A schematic summary of the kinds of quasi-one dimensional nanostructures:
(A) Nanowires and nanorods;
(B) core–shell structures with metallic inner core, semiconductor, or metal-oxide;
(C) nanotubules/nanopipes and hollow nanorods;
(D) heterostructures;
(E) nanobelts/nanoribbons;
(F) nanotapes;
(G) dendrites;
From: Kolmakov A, Moskovits M.
(H) hierarchical nanostructures;
Annu. Rev. Mater. Res. 2004;
(I) nanosphere assembly;
(J) nanosprings.
30. Synthesis of core–shell nanowires
a, Gaseous reactants (red) catalytically decompose on the surface of a gold nanoclusterleading to nucleation and directed nanowire growth.
b, One-dimensional growth is maintained as reactant decomposition on the gold catalyst
is strongly preferred.
c, Synthetic conditions are altered to induce homogeneous reactant decomposition on
the nanowire surface, leading to a thin, uniform shell (blue). d, Multiple shells are grown
by repeated modulation of reactants. (L.J. Lauhon, et al, Nature 2002.)
31. Si–Si homoepitaxial core–shell nanowires.
a, b, Diffraction contrast and highresolution TEM images, respectively, of an unannealed intrinsic silicon core and p-typesilicon shell nanowire grown at 450 °C. Crystal facets in the high-resolution TEM image designated by arrows indicate
initially epitaxial shell growth at low temperature. Scale bars are 50 nm and 5 nm, respectively. c, d, TEM images
(analogous to a and b) of an i-Si/p-Si core–shell nanowire annealed at 600 °C for 30 min after core–shell growth at 450 °C.
Inset, two-dimensional Fourier transforms of the image depicting the [111] zone axis of the single crystal nanowire. The 1/3
{422} reflections, although forbidden in bulk silicon, arise as a result of the finite thickness of the nanowire. e, f, TEM images
of an i-Si/SiOx/p-Si nanowire. The oxide layer is too thin (<1 nm) to discern in the high resolution image, but the sharp
interface (dashed line) between the crystalline core and amorphous overcoat clearly differs from the faceting seen in b and
illustrates the disruption of epitaxy. Inset, TEM image of p-Si coating the nanowire and the Au nanocluster tip. Scale bar is
50 nm. g, Three-terminal current (I ) versus voltage (V ) measurements of the nanowires described in the preceding panels.
Curves b, d and f are labelled according to the representative TEM image (b, d and f) from the same sample of wires. Curve
f has been multiplied by a factor of 104. Insets, current versus backgate voltage to determine field-effect mobilities.
32. Ge–Si core–shell nanowires
33. Si–Ge and Si–Ge–Si core–shell nanowires.
Elemental mapping cross-section indicating a 21-nmdiameter Si core (blue circles), 10-nm Ge shell (redcircles) and <1 nm interface.
Cross-sectional elemental mapping of a double-shell
structure with an intrinsic silicon core (diameter, 20 nm),
intrinsic germanium inner shell (thickness, 30 nm), and
p-type silicon outer shell (4 nm); silicon is blue circles
and germanium is red circles.
34. Coaxially-gated nanowire transistors
a, Device schematic showing transistor structure.The inset shows the cross-section of the as-grown
nanowire, starting with a p-doped Si core (blue, 10
nm) with subsequent layers of i-Ge (red, 10 nm),
SiOx (green, 4 nm), and p-Ge (5 nm). The source
(S) and drain (D) electrodes are contacted to the
inner i-Ge core, while the gate electrode (G) is in
contact with the outer p-Ge shell and electrically
isolated from the core by the SiOx layer.
b, Scanning electron micrograph (SEM) of a coaxial
transistor. Source and drain electrodes were
deposited after etching the Ge (30% H2O2, 20 s)
and SiOx layers (buffered HF, 10 s) to expose the
core layers. The etching of these outer layers is
shown clearly in the inset and is indicated by the
arrow. The gate electrodes were defined in a second
step without any etching before contact deposition.
Scale bar is 500 nm.
c, Gate response of the coaxial transistor at VSD = 1
V, showing a maximum transconductance of 1500
nA/ V. Charge transfer from the p-Si core to the i-Ge
shell produces a highly conductive and gateable
channel.
35. Домашнее задание
Ландау, Лифшиц. Статистическая физика. Часть1. Параграфы 160 - 162. Теория нуклеации.
Определить размеры критических зародышей и давление в них:
1) в газовой фазе
2) в конденсированной среде
3) для критического островка, имеющего форму сферического
сегмента, на плоской поверхности этой среды.
Коэффициенты поверхностного натяжения материала новой
фазы γf = 1 Дж/м2 ; исходной среды γs = 0.5 Дж/м2; границы
раздела γfs = 0.2 Дж/м2
Пересыщение с/сeq = 1.1.
Температура = 727оС
Радиус молекулы = 1 Å




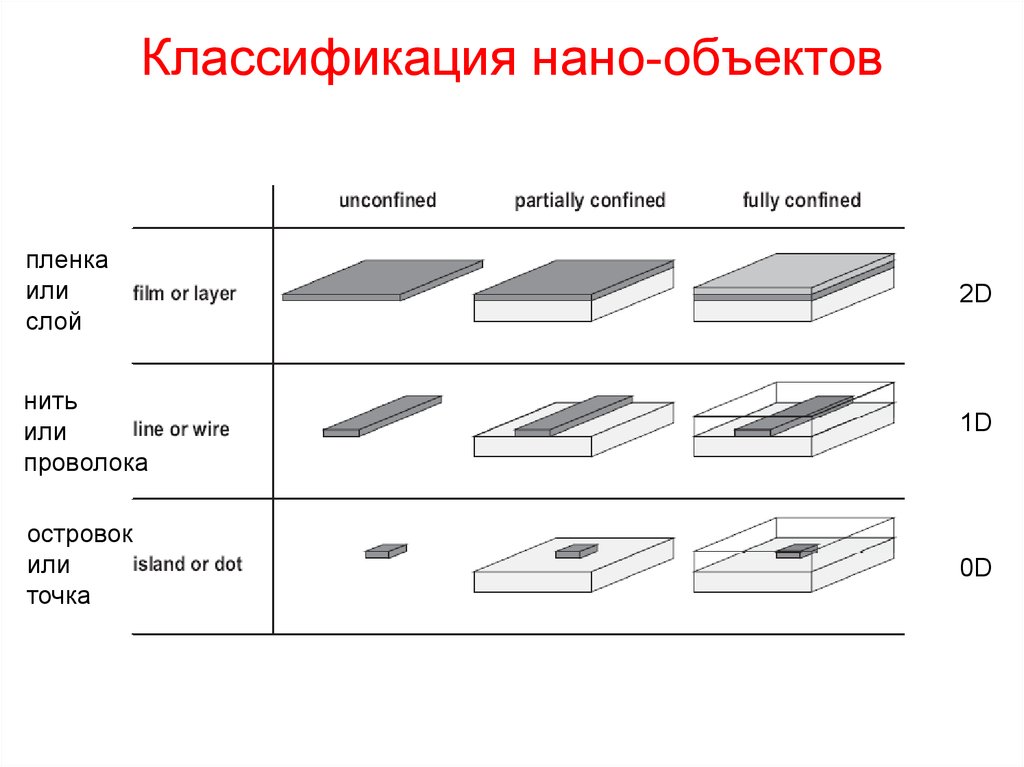
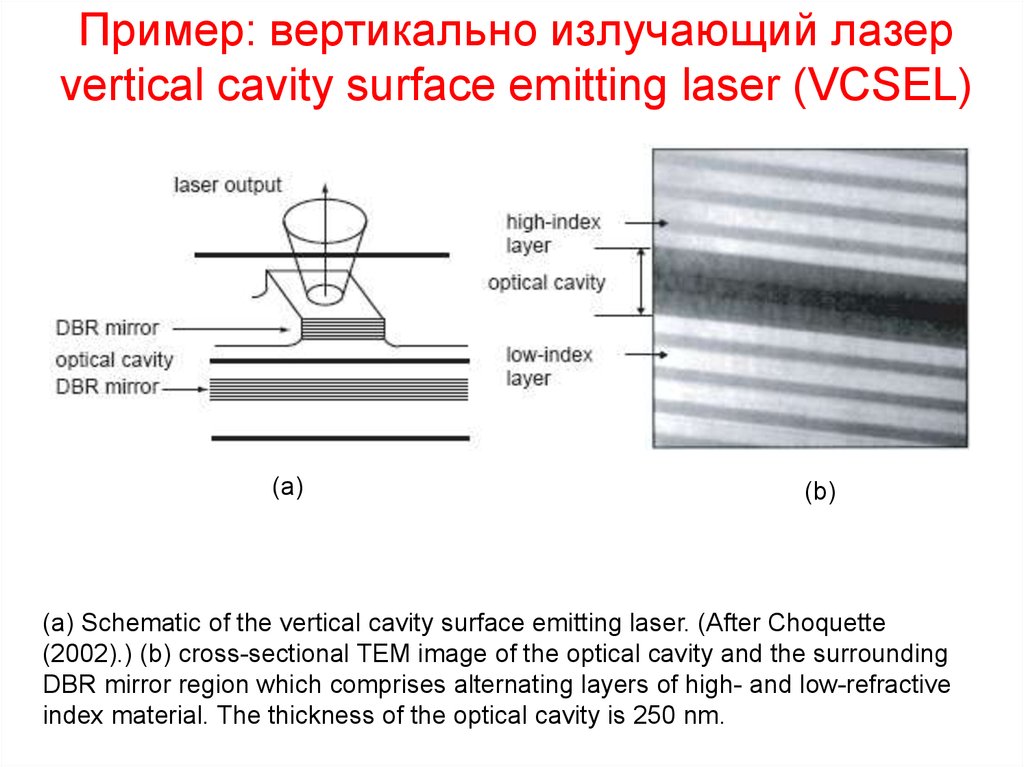



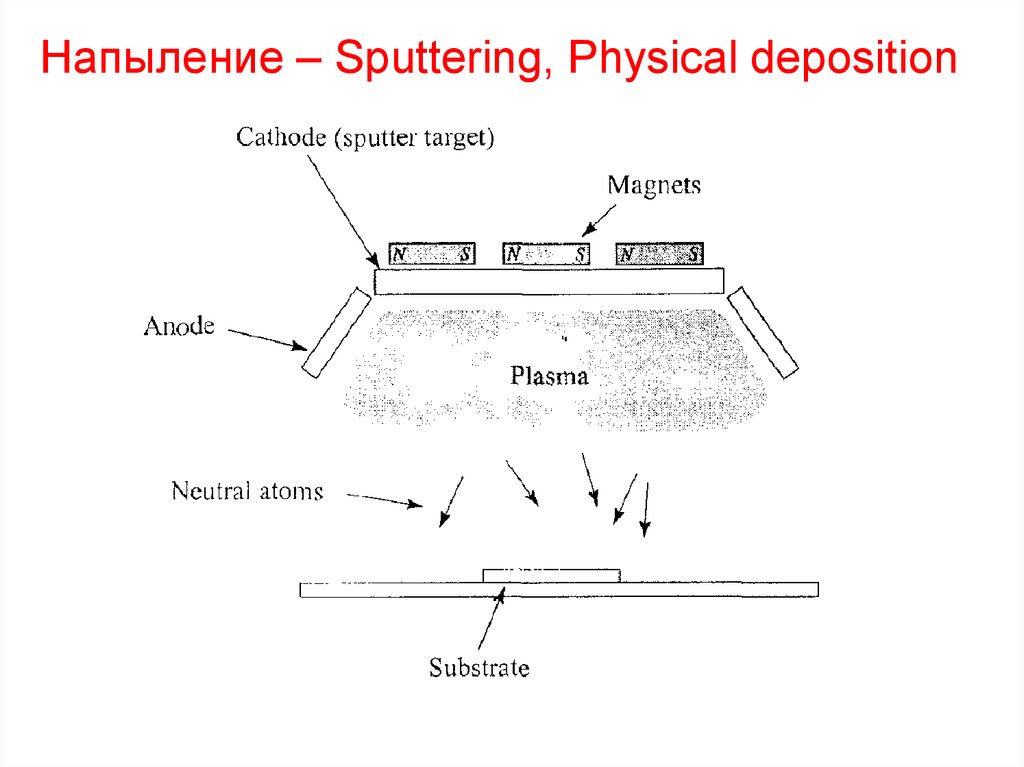

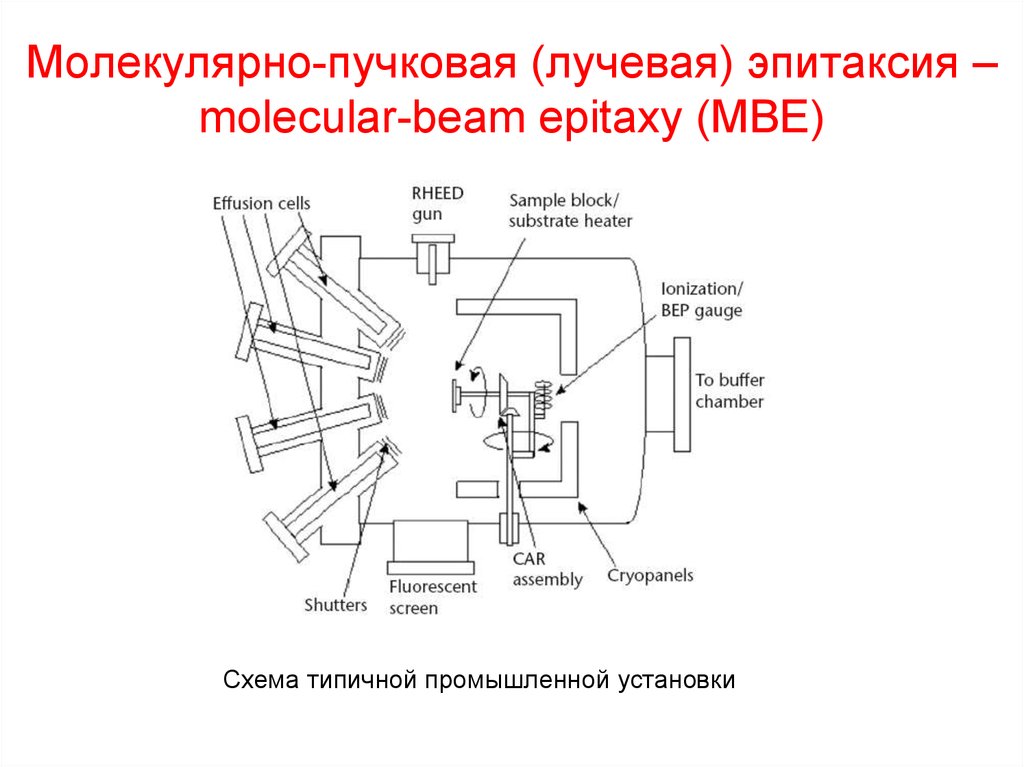
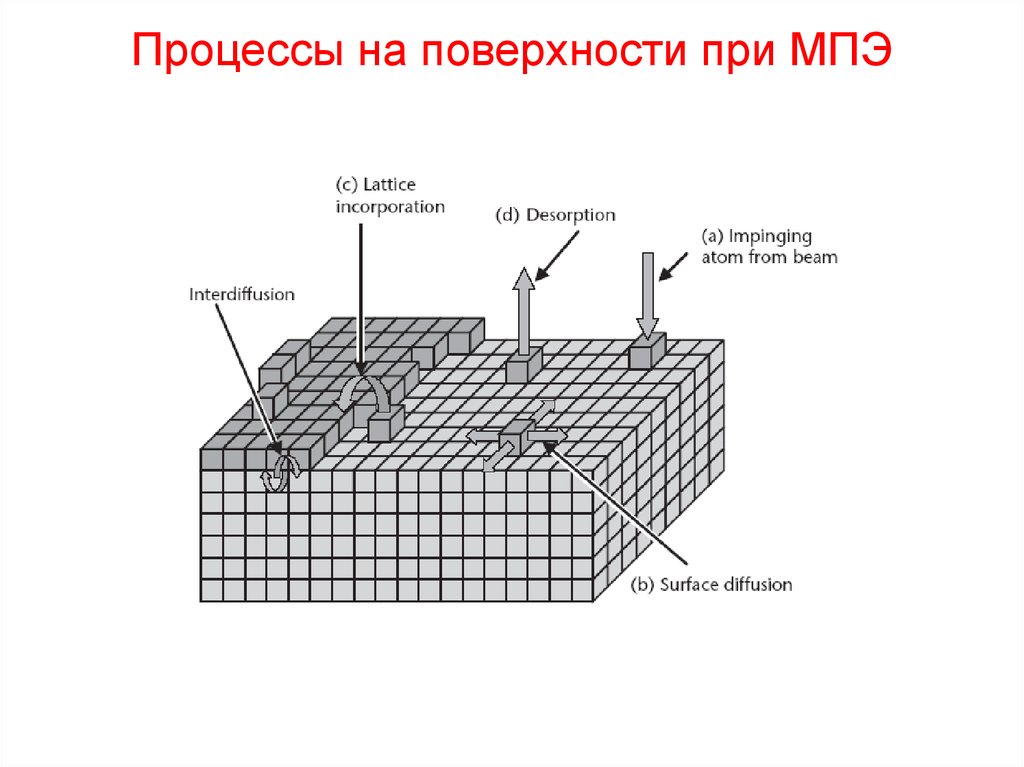
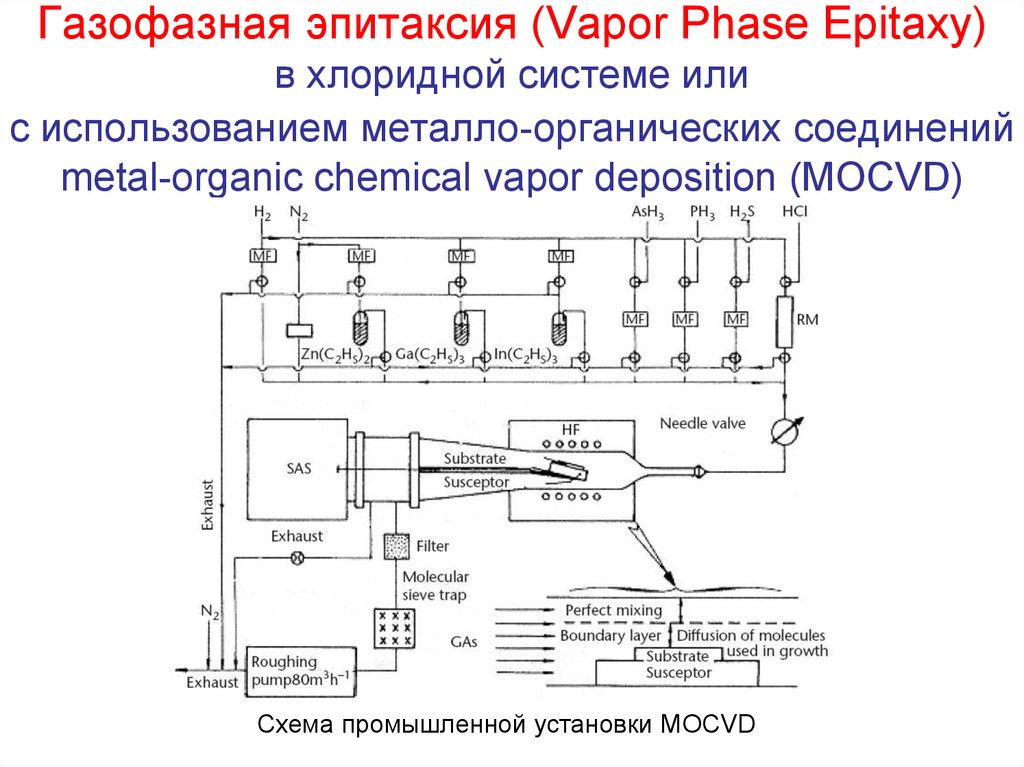











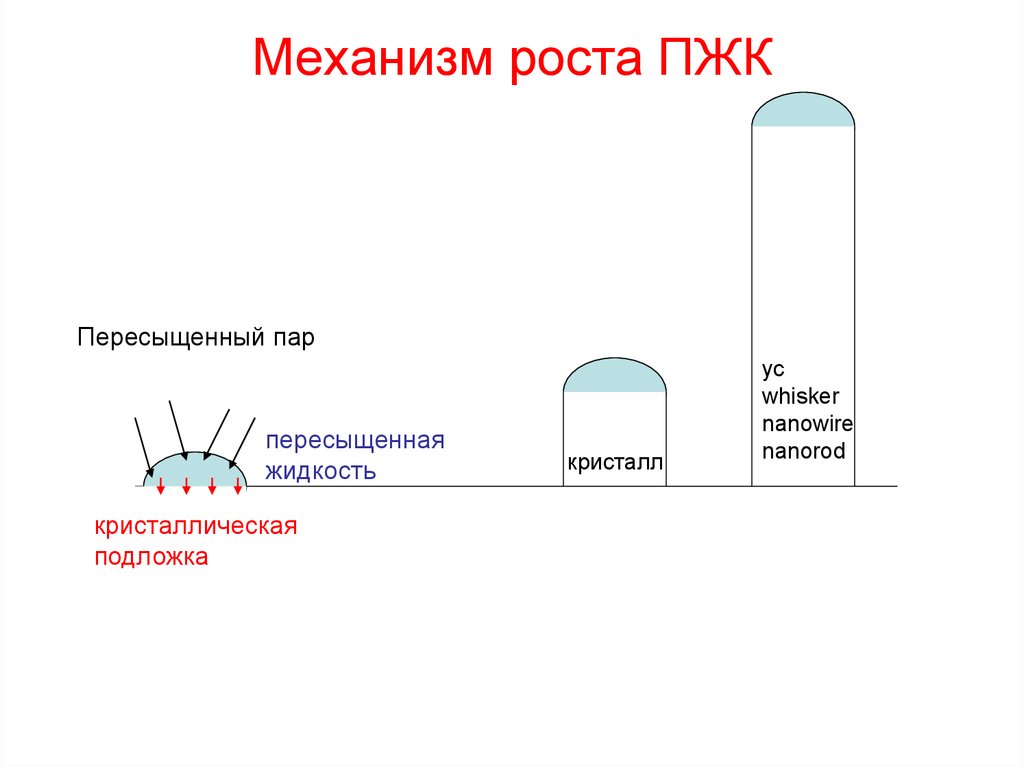


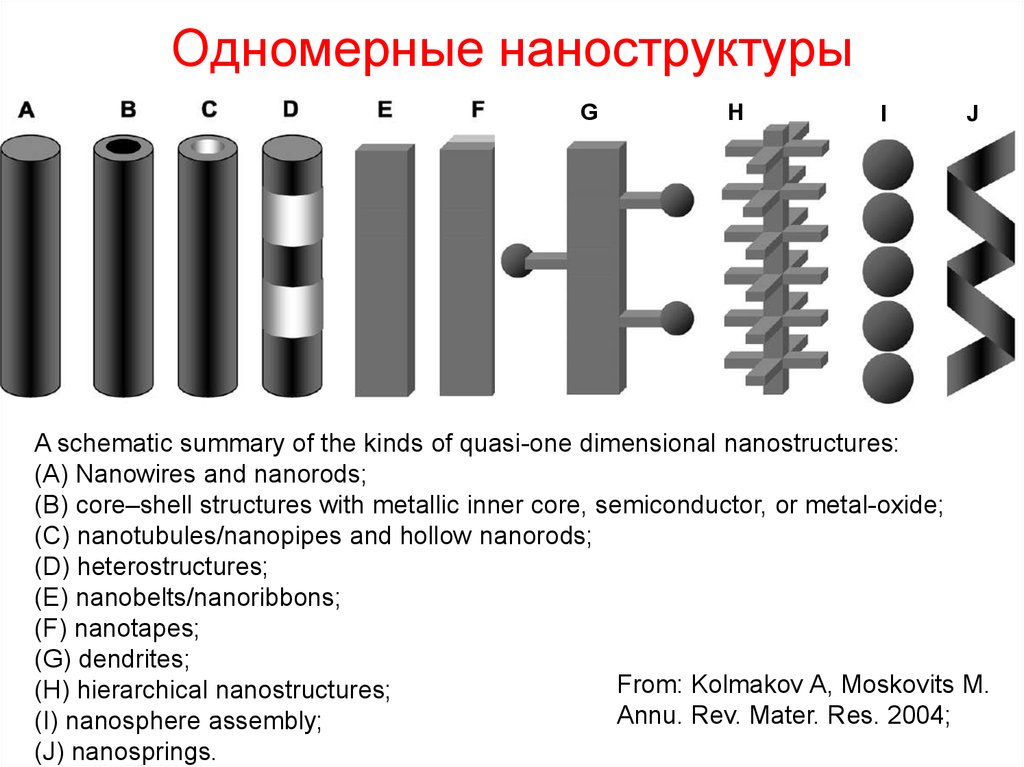


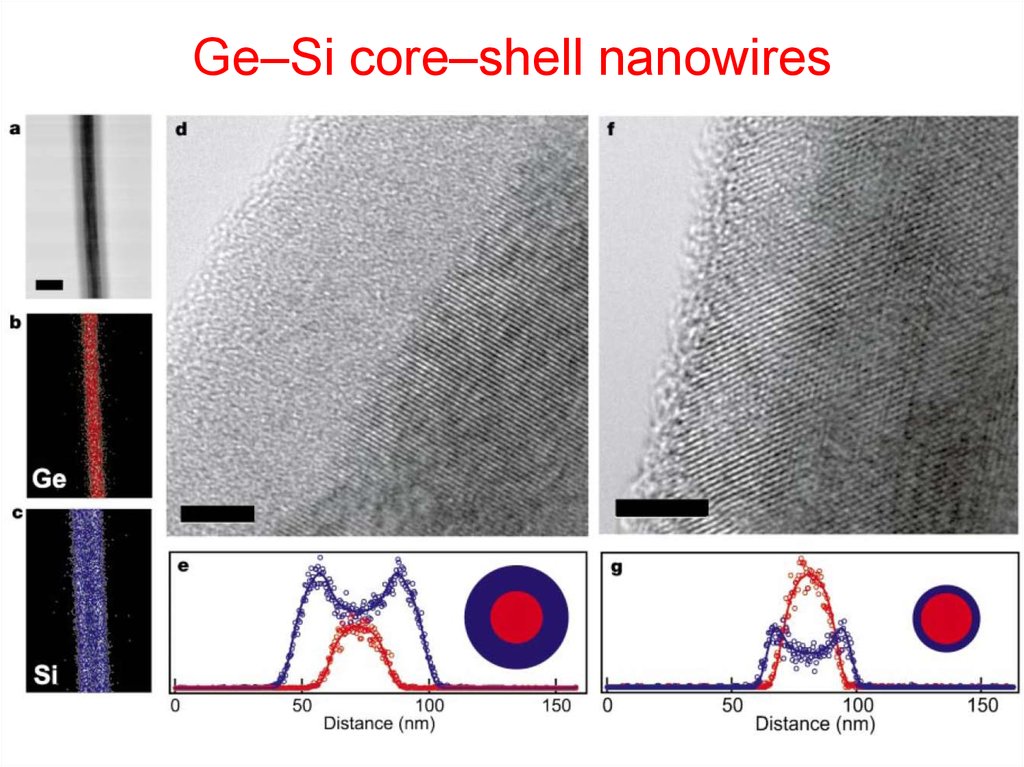



 physics
physics








