Similar presentations:
Химическая обработка. Удаление слоев (травление)
1. Удаление слоев (травление)
2.
граница раздела-
п/п
-
ОПЗ
Если скорость травления
лимитируется процессами
+
поступления травителя или
+
отвода продуктов реакции –
+
электро-травление изотропное
лит
сглаживание
поверхности.
+
травители
для кремния:
Если
скорость
лимитируется
НNO
:
НF
3
+
химической
НNO
COOH
3 : НF : СН3реакцией:
НNO3 травления
: НF
+
• скорость
зависит
КОН : H2O подложки,
от
ориентации
диффуH2NCH2CH2NH2 : С6Н4(ОН)2 : H2N-NH2
зионный
• травление селективное,
слой
• проявляются
дефекты,
травители
для оксида
кремния
HFскорость
: NH4F : травления
H2O
• на
HF : HNO
H2O
влияют
тип3 :примеси
и
уровень легирования.
3. Получение V-образных канавок в (100) Si
Поверхность (100)пересекается четырьмя
плоскостями (111)
Получение
V-образных
канавок в
(100) Si
4. Формирование мембраны
SiO2p++
Si
SiO2
5.
получениеU-образных
канавок в
(110) Si
109о 48’
35о
Поверхность
пересекается
шестью
плоскостями
(111)
(четыре под
углом 90о,
две под углом
35о 26’)
6. Схема химико-динамического травления
Схема химикодинамическоготравления
7. Методы сухого травления
• Ионно-лучевое травлениеA↓ • Ионно-плазменное травление
Травление по механизму
физического распыления
S↑ • Реактивное ионное травление
• Плазменное травление
Сочетание химических реакций в
ходе которых образуются летучие
или квазилетучие соединения и
физического воздействия ионной
бомбардировки
8.
Образование гранейАнизотропия:
A = 1 – vб / vв
Селективность: Sfm = vпл / vмаск
Sfs = vпл / vподл
А=1
S≈1
9. Профиль края элемента
10.
11.
12. Процессы создания ионов и радикалов в газовом разряде
• Простая ионизация:Ar + e → Ar+ + 2e
O2 + e → O2+ + 2e
• Диссоциативная ионизация:
CF4 + e → CF3+ + F + 2e
• Диссоциативная ионизация с прилипанием:
CF4 + e → CF3+ + F- + e
• Молекулярная диссоциация:O2 + e → 2O + e → O + OCF3Cl + e → CF3 + Cl + e
C2F6 + e → 2CF3 + e
• Диссоциативная рекомбинация: e + O2+ → 2O
• Диссоциативное прилипание:
e + CF4 → CF3 + F-
13.
Энергия ионов ≥500 эВРабочее давление 0,133 – 13,3 Па
14.
Плотностьпучка ионов
≈ 1 мА /см
Прикладываемое
напряжение
500 В
15.
Рабочее давление 13,3 – 1330 Па16. Схема вакуумной камеры для радикального плазмохимического травления
17.
Газы, применяемые для сухого травленияФоторезист
O2
18. Механизмы влияния ионного облучения
• Обеспечивает диссоциацию молекултравящих газов
• Создает дефекты на поверхности,
катализирующие хемосорбцию или
реакцию
• Способствует удалению нелетучих остатков
19. Ионно-ускоряемая реакция
Атомарный FТравление Si
Энергия ионов 450 эВ
20. Ионно-возбуждаемая реакция
Атомарный ClЭнергия
ионов
450 эВ
Травление Si
21.
CF4 → F + CFXCFX + O2 → COF2, CO, CO2
2F + H2 → 2HF
CFX не травит Si,
но травит SiO2
22.
Для уменьшения боковоготравления добавляют C2F6 в Cl2
e + Cl2 → 2Cl + e ионизация
Si+ X Cl → SiClX травление
e + C2F6 → 2CF3 +e
CF3 + Cl → CF3Cl
подавляется ионным облучением
23. «Загрузочный эффект»
24. Побочные эффекты
Повторное осаждение
Осаждение полимеров
Радиационные повреждения
Загрязнения материалом маски и т. д.
25. Определение момента окончания травления
• Регистрация оптического отражения• Регистрация концентрации травящих
компонентов
• Анализ продуктов реакции


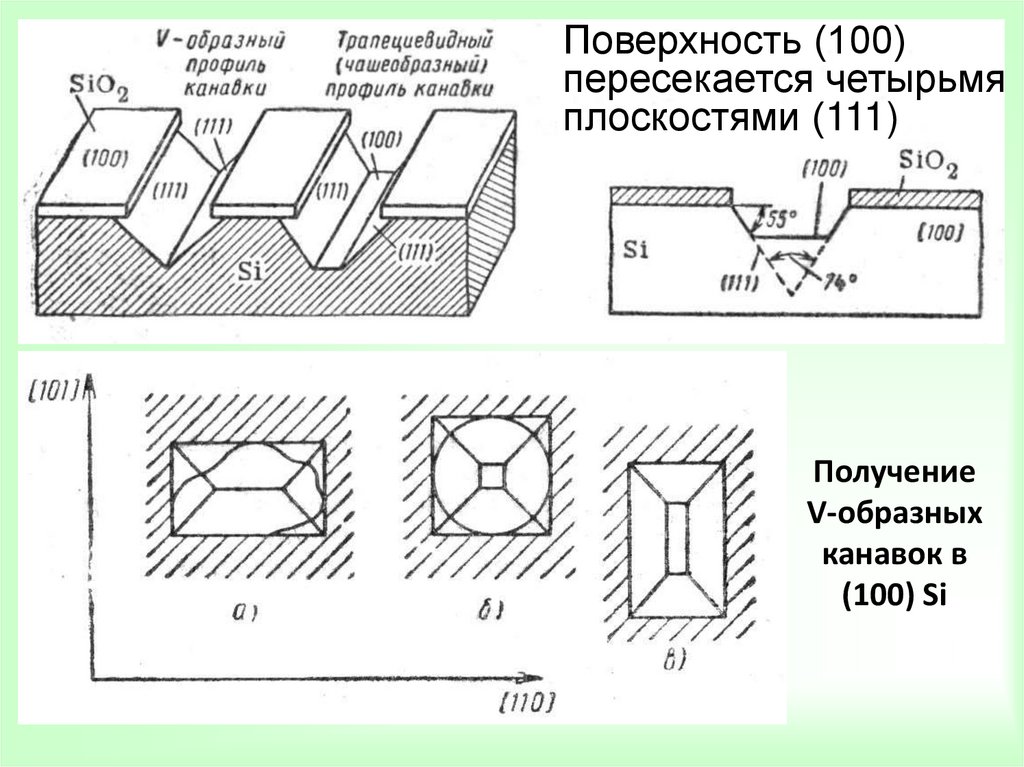

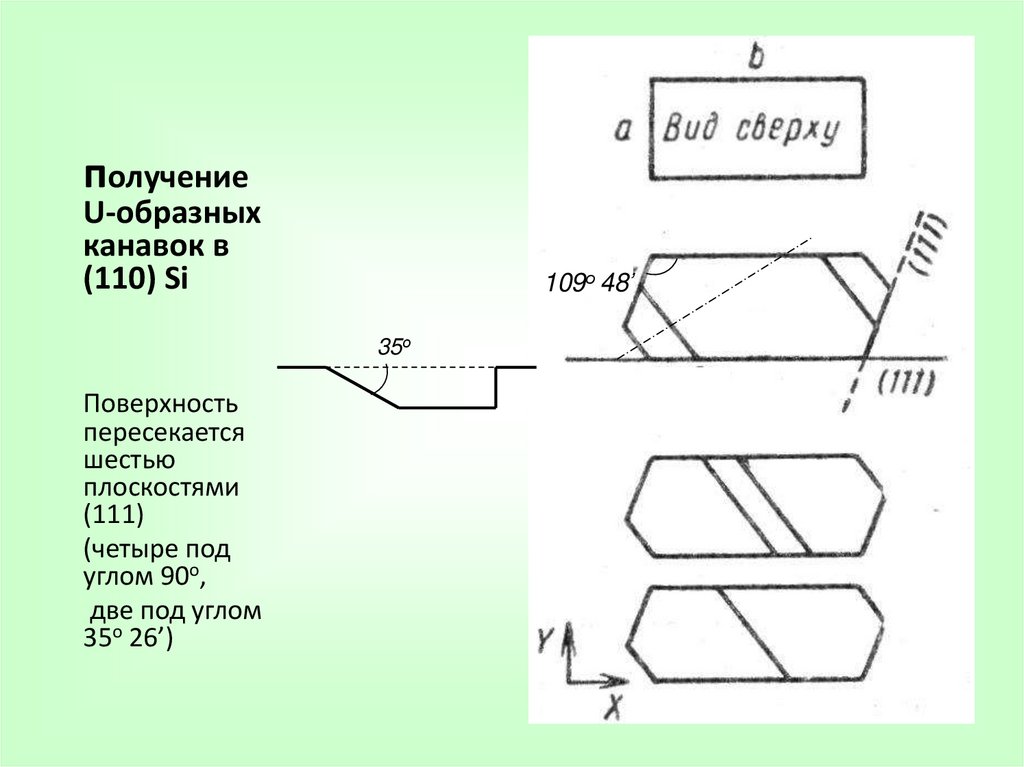



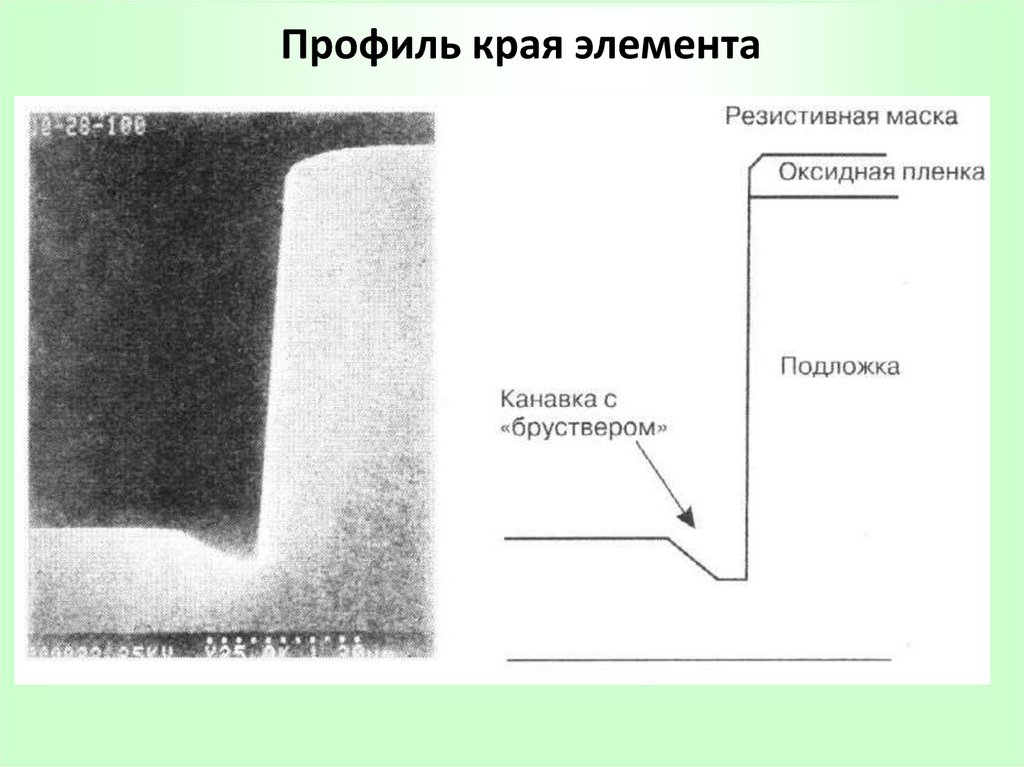
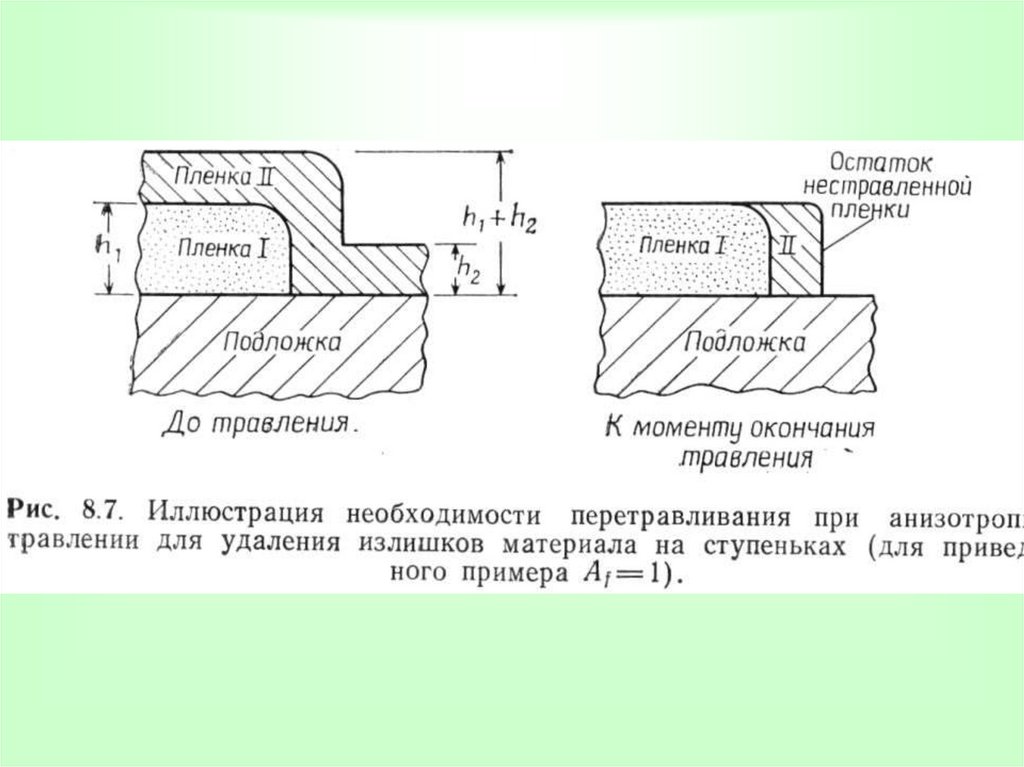















 physics
physics








