Similar presentations:
Современные конструкции ИС и способы повышения их основных характеристик
1. Современные конструкции ИС и способы повышения их основных характеристик
Технологическая норма: 0,5 мкм → 0,35 → 0,25 → 0,18 → 0,13 (130 нм)→ 90 → 60 → 45 → 32 → 22 нм.
Конструктивные решения:
- подзатворный диэлектрик с высоким К (high-k );
- напряженный кремний;
- структуры «кремний-на-изоляторе» (SOI MOSFET );
- трехмерные структуры (FinFET-транзисторы ).
2. Подзатворный диэлектрик
Толщина подзатворного слоя из SiO2 должна быть примерно в 45 разменьше планарных размеров затвора.
При проектной норме 45 нм это составляет 1 нм.
Параметры элементарной ячейки SiO2: а = 0,490 нм; с = 0,539 нм.
Основные high-k
диэлектрики
q C U
Ñ
0 S
d
3. Напряженный кремний
Подвижность носителей заряда в канале определяет быстродействиеМДП-транзистора.
Механическое напряжение изменяет эффективную массу и, как
следствие, подвижность носителей.
Впервые технология «напряженного» кремния была реализована для
90-нанометровой проектной нормы в 2001 году в IBM.
Сжимающее напряжение
(канал p-типа)
Растягивающее напряжение
(канал n-типа)
4. Структуры «кремний-на-изоляторе»
«Обычный» МДП-транзисторКНИ-структура
Преимущества:
- уменьшение паразитных емкостей на 30 – 50 %;
- уменьшение динамического энергопотребление ~ на 30 %;
- более надежная изоляция элементов ИС от подложки, что
позволяет существенно поднять верхний предел рабочих температур;
- резко увеличена радиационная стойкость.
5. КНИ-структуры (продолжение)
Способы создания КНИ-структур:Ионная имплантация - бомбардировки поверхности пластины ионами
кислорода с последующим отжигом при высокой температуре.
Сращивание пластин - очистка и активация плазменной обработкой
поверхности пластин Si и SiO2, сжатие и отжиг, в результате
химических реакций на поверхности происходят соединение пластин.
Управляемый скол. Используют две кремниевые пластины. Первая
термически окисляется, затем верхняя поверхность подвергается
насыщению ионами водорода методом ионной имплантации, в
результате чего в пластине создается область скола. Затем эта пластина
сращивается с другой, после чего происходит отделение тонкого слоя
первой пластины от второй пластины.
Эпитаксия - поверхностный слой образуется за счет выращивания
пленки Si на поверхности SiO2 (технологические проблемы).
6. FinFET транзисторы
Структура FinFET-транзистораДостоинства – те же, что и КНИ-структур
Дополнительно – малая площадь одного
транзистора (переход к технологическим
нормам 14 нм)

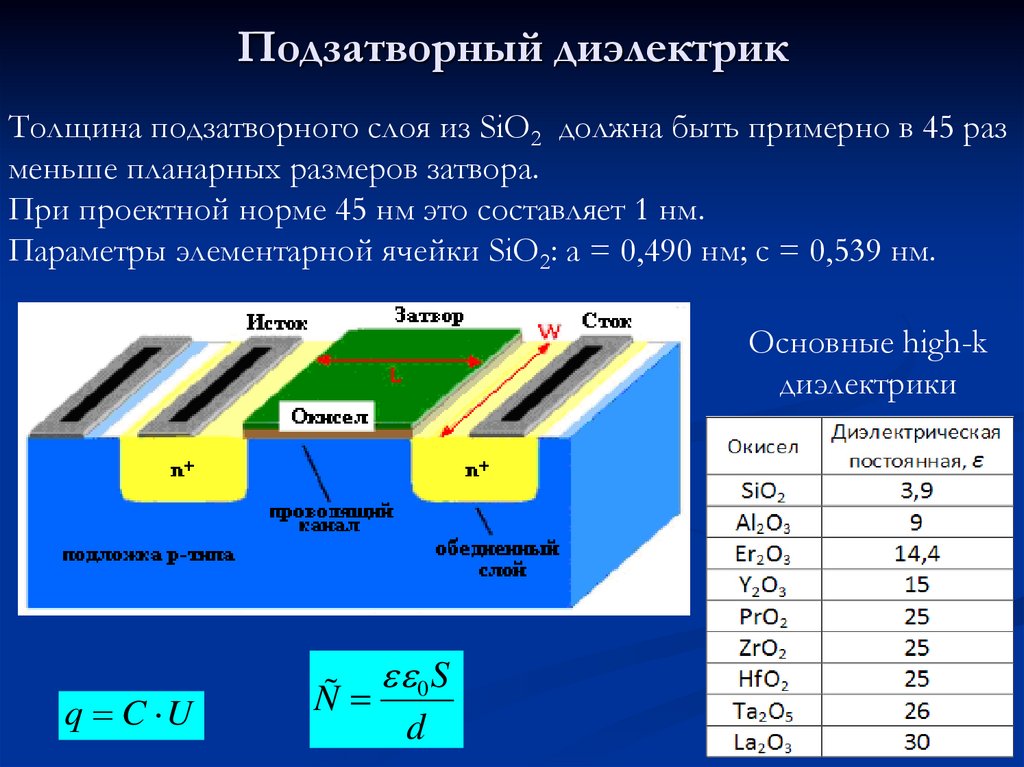
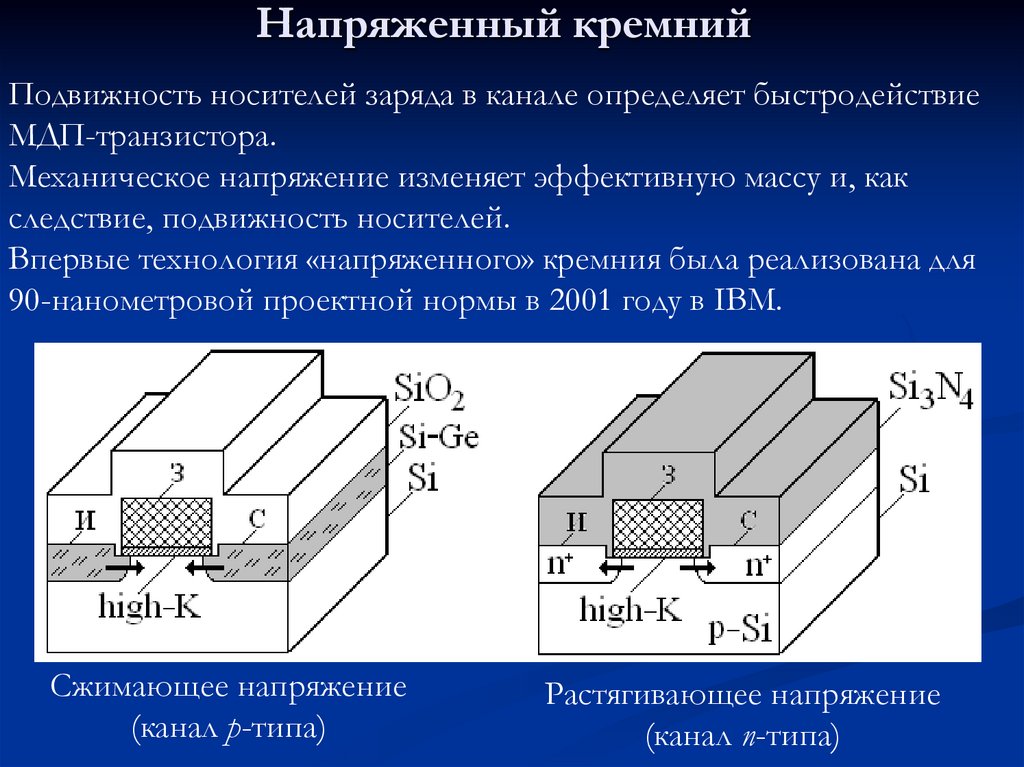


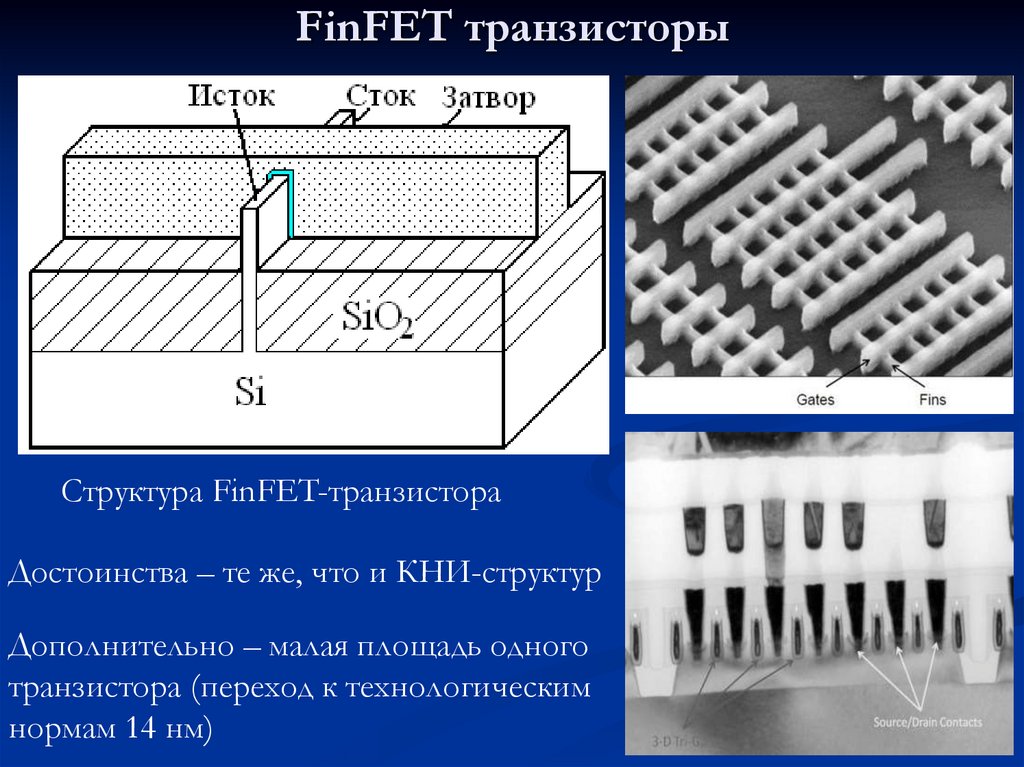
 electronics
electronics








