Similar presentations:
Низкоразмерные структуры и технологии. Структуры с двумерным электронным газом
1.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Наиболее очевидным примером структур с двумерным электронным газом являются тонкие
пленки, на примере которых в предыдущем разделе были проиллюстрированы идеи размерного
квантования.
Полупроводниковые или полуметаллические* пленки более предпочтительны для этих целей, чем
металлические. И действительно, пленки висмута исторически были первым материалом, где
экспериментально наблюдались квантовые размерные эффекты в проводимости.
Такие пленки, имеющие необходимую толщину, достаточно высокую подвижность и хорошее
качество поверхности, достаточно легко получаются методом вакуумного испарения.
* Полуметаллы – вещества, занимающие по электрическим свойствам промежуточное положение между
металлами и полупроводниками. Для полуметаллов характерно слабое перекрытие валентной зоны и зоны
проводимости. Вследствие этого полуметаллы, с одной стороны, остаются проводниками вплоть до
абсолютного нуля температуры, а с другой стороны они обладают малой (по сравнению с металлами)
концентрацией носителей тока. С ростом температуры число носителей увеличивается и электропроводность
растет. К полуметаллам относятся Bi, Sb, As, графит и др.
2.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
При описании кинетических эффектов в
системах с двумерным электронным газом
учет эффектов, связанных с переходом
носителей из одной подзоны в другую,
приводит к тому, что проводимость и другие
кинетические коэффициенты при
фиксированной концентрации носителей в
тонкой пленке являются осциллирующими
функциями ее толщины. Подобные
осцилляции являются одним из наиболее
наглядных внешних проявлений размерного
квантования, которое впервые наблюдалось
еще в 1965 году.
Осцилляции магнетосопротивления (а),
подвижности (б), постоянной Холла (в) и
удельного сопротивления в тонких
пленках Bi.
3.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Однако тонкие пленки не являются лучшими объектом для наблюдения квантовых эффектов.
Пленки висмута – скорее исключение, обусловленное большой дебройлевской длиной волны в
данном материале, чем правило. В других материалах, в том числе в полупроводниках,
получить тонкие пленки необходимого качества весьма сложно. Причина в том, что на
поверхности полупроводниковой пленки существует высокая плотность поверхностных
состояний, играющих роль центров рассеяния. Поэтому тонкие пленки, широко
использовавшиеся для изучения квантовых размерных эффектов в конце 60-х годов, уступили
ведущую роль вначале кремниевым структурам металл-диэлектрик-полупроводник
(МДПструктуры).
МДП-струтуры были известны задолго до открытия квантовых размерных эффектов и
использовались (и продолжают использоваться) в качестве полевых транзисторов.
Основным материалом для изготовления МДП-структур является кремний, в первую очередь
благодаря той легкости, с которой путем окисления создается однородный слой
высококачественного диэлектрика SiO2, требуемой толщины.
4.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
На рисунке изображена
энергетическая диаграмма МДПструктуры.
На металлический электрод,
отделенный слоем диэлектрика
толщиной d, подается
напряжение Vз, создающее в
полупроводнике
приповерхностный изгиб зон.
Для достаточно больших Vз этот
изгиб может стать порядка
ширины запрещенной зоны. При
этом в полупроводнике вблизи
границы с диэлектриком
образуется тонкий инверсионный
слой, содержащий носители
противоположного знака, нежели
в объеме полупроводника.
5.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Рассматривая металлический затвор и инверсионный слой как две обкладки плоского
конденсатора, можно вычислить двумерную плотность электронов в слое n2D
n2 D
d
VЗ V0
4 ed
d – диэлектрическая проницаемость диэлектрика, V0 – пороговое напряжение,
соответствующее открытию инверсионного слоя, т.е. появлению в нем электронов.
Инверсионный слой представляет собой потенциальную яму для электронов. где одной
стенкой является граница с диэлектриком, а роль второй стенки играет электростатический
потенциал прижимающий электроны к границе.
Напряженность электрического поля в инверсионном слое
Согласно предыдущему равенству Ẽ пропорциональна
напряжению на затворе VЗ.
~ 4 en2 D
E
d
6.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Оценим характерную толщину инверсионного канала Dz, играющего роль ширины квантовой
ямы. Если определять эту величину как ширину классически разрешенной области для
электронов с энергией En, то
E
Dz ~n
eE
С другой стороны, для любых типов квантоворазмерных структур, где движение носителей
ограничено характерными размерами Dz, сохраняет силу порядковая оценка для энергии
квантовых уровней, точная формула для которой была выведена для электрона в бесконечной
прямоугольной потенциальной яме
En ~
~
Dz ~ E 1 3
2
m Dz 2
~
En ~ E 2 3
7.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Важнейшей особенностью МДП-структур, отличающих их от других квантово-размерных
систем, является возможность управления концентрацией электронов n2D. Она может
изменяться в широких пределах при изменении напряжения на затворе VЗ. Максимальное
значение концентрации определяется максимальным значением напряжения, которое можно
приложить к затвору без риска пробоя диэлектрика. Для кремниевых структур оно имеет
порядок 1013 см-2.
Следует отметить, что изменение напряжения на затворе меняет одновременно концентрацию
двумерных носителей n2D и расстояние между уровнями размерного квантования. Этим
МДП-структура отличается от тонкой пленки, где концентрация и энергия уровней
определяются соответственно уровнем легирования и толщиной пленки и могут меняться
независимо.
Существует еще одно важное различие между МДП-структурами и тонкими пленками.
Последние представляют собой потенциальную яму для обоих типов носителей, и
квантование энергии имеет место как для электронов. так и для дырок. В МДП-структуре, в
которой ограничивающий потенциал имеет электростатическую природу, квантуется энергия
лишь одного типа носителей. Для другого типа носителей потенциальная яма отсутствует и
спектр остается непрерывным.
8.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Гетеропереходы и гетероструктуры
Для изучения эффектов размерного квантования используются в настоящее время
также и гетеропереходы.
Гетеропереходом называют переход, образующийся на границе двух полупроводников
с различной шириной запрещенной зоны.
На границе гетероперехода происходит изменение свойств полупроводника, в частности,
меняется структура энергетических зон, ширина запрещенной зоны, подвижности и
эффективные массы носителей заряда.
Различают анизотипные и изотипные гетеропереходы.
Анизотипные переходы создаются в результате контакта полупроводников с дырочной и
электронной типами проводимости.
Изотипные переходы возникают в результате контакта полупроводников одного типа
проводимости.
Комбинации различных гетеропереходов образуют гетероструктуры.
9.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
С гетероструктурами связан целый комплекс новых явлений, на основе
которых разработаны многочисленные новые типы электронных приборов:
лазеры с квантовыми ямами и точками, оптические модуляторы,
фоточувствительные nipi-структуры, фотоприемники на квантовых ямах,
транзисторы на горячих электронах, одноэлектронный транзистор и др.
В основе работы этих приборов лежит фундаментальный физический факт:
изменение энергетического спектра электронов и дырок в структурах с очень
малыми размерами (принцип размерного квантования)
10.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
С макроскопической точки зрения мы можем рассматривать гетеропереход как систему, для
которой нарушается непрерывность валентной зоны и зоны проводимости, т.е. имеется разрыв
этих зон. Эти разрывы зависят исключительно от пары материалов, образующих гетеропереход.
Возможны три типа гетероструктур.
11.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
В первом случае вся запрещенная зона
более узкозонного полупроводника
находится в пределах запрещенной
зоны широкозонного полупроводника
(тип I).
Тип II – один из разрывов зон может
быть больше различия ширины
запрещенной зоны двух
полупроводниковых материалов.
Тип III – величина одного из разрывов
может быть больше ширины
запрещенной зоны наиболее
широкозонного полупроводника.
12.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Связь между шириной
запрещенной зоны и
постоянной решетки
различных объемных
полупроводников
Требование точного
соответствия постоянных
решеток делит
полупроводники на пять
групп
13.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Гетеропереход можно реализовать при синтезе одного
полупроводникового слоя на другом. Для некоторых специально
выбранных полупроводников, обладающих совместимыми
кристаллическими структурами и постоянными решетки, можно достичь
эпитаксиального выращивания одного материала на другом. В этом
случае расположение атомов второго материала образует виртуально
совершенное продолжение лежащей ниже кристаллической решетки. Из
тщательно подобранных условий композиционный переход между двумя
материалами может быть сделан практически идеально резким (т.е. во
многих случаях протяженность гетерограниц может составлять величину
в пределах монослойной шкалы).
14.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Типичная зонная диаграмма гетероперехода между электронным и дырочным
полупроводниками (анизотипный переход).
В узкозонном полупроводнике вблизи границы раздела образуется инверсионный слой
(слой, содержащий носители противоположного знака, нежели в объеме полупроводника, в
нашем случае электроны в дырочном полупроводнике), играющий роль потенциальной
ямы для электронов, в которой существуют уровни размерного квантования.
15.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Важнейшим достоинством гетероперехода является высокое качество гетерограницы.
При выборе в качестве компонент гетеропары вещества с хорошим согласием постоянных решетки
удается уменьшить плотность поверхностных состояний на гетерогранице до значений порядка 10 8
см-2, что на несколько порядков меньше, чем в лучших МДП-структурах. Такая малая плотность
состояний в совокупности с атомно-гладкой морфологией границы приводит к возможности
получения рекордно высоких подвижностей m в приповерхностном канале. В гетероструктрах
GaAs-AlGaAs были получены значения подвижности электронов, превосходящие 107 см2/(В∙с), в то
время как для лучших Si-МДП-структур m ≈ 5∙104 cм2/(В∙с). В результате столкновительное
уширение уровней в гетероструктурах крайне мало, что позволяет наблюдать различные тонкие
эффекты.
Концентрация носителей в канале гетероструктуры определяется разрывами зон на гетерогранице и
уровнями легирования компонент гетероперехода. Для системы GaAs-AlGaAs она. Ка правило, не
превосходит 1012 см-2.
16.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
В гетероструктуре, рассмотренной выше, потенциальная яма, ответственная за
размерное квантование, образована разрывом зон проводимости с одной стороны и
электростатическим полем перехода с другой. Это аналог инверсионного слоя МДПструктуры, в котором квантуется движение лишь одного типа носителей.
Существуют также
гетероструктурные аналоги тонкой
пленки с размерным квантованием
как электронов. так и дырок. Это
двойные тонкослойные структуры,
или квантовые ямы, представляющие
очень тонкий слой узкозонного
полупроводника, между двумя
широкозонными.
17.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Если толщина узкозонного слоя а значительно меньше длины экранирования, то изгибы
зон за счет объемного заряда в полупроводниках незначительны и зонная диаграмма
модифицируется. Видно, что в зоне проводимости при достаточно малой толщине узкозонного
полупроводника практически прямоугольная потенциальная яма шириной а и глубиной DEc.
Аналогичная яма глубиной DЕv существует в валентной зоне.
Зонная диаграмма двойной
гетероструктуры при различной
толщине узкозонного
полупроводника.
* Дебаевский радиус экранирования –
характерное расстояние, на которое в
плазме, электролите или полупроводнике
распространяется действие
электрического поля отдельного заряда.
18.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Реальные образцы для экспериментального изучения квантово-размерных эффектов в
большинстве случаев содержат большое количество одинаковых или почти одинаковых квантовых
объектов. Как правило, это не меняет физической картины, поскольку вклады от всех объектов
просто суммируются. Ситуация, однако, становится принципиально иной, если отдельные слои,
нити или квантовые точки находятся настолько близко друг к другу, что носители заряда могут
туннелировать между ними.
Рассмотрим систему параллельных
квантовых ям с очень тонкими (порядка
единиц нанометров) широкозонными
разделяющими слоями. При этом ямы уже
не являются независимыми и могут
обмениваться электронами за счет
туннелирования через широкозонный
слой. Подобные структуры иногда
называют структурами с вертикальным
переносом.
19.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Если число параллельных слоев в структурах с вертикальным переносом
велико (как минимум, несколько десятков), мы имеем искусственную
периодическую структуру, или полупроводниковую сверхрешетку. Наиболее
важным свойством сверхрешеток, определяющим все их уникальные
физические свойства, является видоизменение их энергетического спектра по
сравнению со спектром одиночной квантовой ямы и исходных
полупроводников.
Сверхрешеткой называется периодическая структура, состоящая из тонких
чередующихся в одном направлении слоев полупроводников. Период
сверхрешетки намного превышает постоянную кристаллической решетки, но
меньше длины свободного пробега электронов. Такая структура обладает,
помимо периодического потенциала кристаллической решетки,
дополнительным потенциалом, обусловленным чередующимися слоями
полупроводников, и который называют потенциалом сверхрешетки.
20.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
По способу создания периодического потенциала сверхрешетки делятся на
несколько типов. Наиболее распространенными являются композиционные и
легированные сверхрешетки.
Композиционные сверхрешетки, представляют собой эпитаксиально
выращенные чередующиеся слои различных по составу полупроводников с
близкими постоянными решетки. Исторически первые сверхрешетки были
получены для системы полупроводников GаАs - АlxGa1-xАs. Успех в создании
этой сверхрешетки был обусловлен тем, что Аl, имеющий такую же
валентность и ионный радиус, что и Gа, не вызывает заметных искажений
кристаллической структуры исходного материала. В то же время Аl способен
создать достаточную амплитуду сверхрешеточного потенциала.
21.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
В легированных сверхрешетках периодический потенциал образован
чередованием слоев n- и p-типов одного и того же полупроводника. Эти слои
могут быть отделены друг от друга нелегированными слоями. Такие
полупроводниковые сверхрешетки называют часто nipi-кристаллами.
Потенциал сверхрешетки в легированных сверхрешетках создается только
пространственным распределением заряда. Он обусловлен потенциалом
ионизованных примесей в легированных слоях. Все донорные центры в
легированных сверхрешетках являются положительно заряженными, а все
акцепторные центры – отрицательно заряженными. Потенциал объемного
заряда в легированных сверхрешетках модулирует края зон исходного
материала таким образом, что электроны и дырки оказываются
пространственно разделенными. Соответствующим выбором уровня
легирования и толщины слоев это разделение можно сделать практически
полным.
22.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Схема
расположения
последовательности
слоев
(слева)
и
координатная
зависимость
зонной
диаграммы
(справа)
для
легированных сверхрешеток
GaAs (nipi-кристаллах GaAs).
Стрелка на левом рисунке
показывает
направление
роста слоев.
23.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Наличие потенциала сверхрешетки существенно меняет зонную
энергетическую структуру исходных полупроводников. Полупроводниковые
сверхрешетки обладают особыми физическими свойствами, главные из
которых следующие:
• существенное изменение в сравнении с исходными полупроводниками
энергетического спектра;
• наличие большого числа энергетических зон;
• очень сильная анизотропия (двумерность);
• подавление электронно-дырочной рекомбинации;
• концентрация электронов и дырок в сверхрешетке является
перестраиваемой величиной, а не определяется легированием;
• широкие возможности перестройки зонной структуры.
24.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
На электроны и дырки в сверхрешетке действует дополнительный прямоугольный
потенциал D(z), связанный с разрывами зон на гетерограницах. Этот потенциал
является периодическим, как и потенциал кристаллической решетки, и к нему
применимы все основные выводы о свойствах уравнения Шредингера с периодическим
потенциалом.
В приближении эффективной массы электрона уравнение Шредингера в
полупроводниковой сверхрешетке можно записать в виде
r
2
2me
2
E D z r 0
me - эффективная масса электрона в полупроводнике, Е – полная энергия частицы, .
z – направление, перпендикулярное поверхности сверхрешетки (оси сверхрешетки).
25.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Поскольку потенциал сверхрешетки зависит только от координаты z,
совпадающей с осью сверхрешетки, то энергетический спектр электронов в
сверхрешетке резко анизотропен. На движение электронов в плоскости,
перпендикулярной оси сверхрешетки ее потенциал не будет оказывать
заметного влияния. В то же время, движение электронов вдоль оси z будет
соответствовать движению в поле с периодом d, равным сумме толщин слоев
исходных полупроводников.
Поскольку потенциал сверхрешетки периодичен, то энергетический спектр
электрона в направлении оси сверхрешетки имеет зонный характер. Так как
период сверхрешетки d значительно больше постоянной кристаллической
решетки а, то получающиеся при этом сверхрешеточные зоны (минизоны)
представляют собой более мелкое дробление энергетических зон исходных
полупроводников.
26.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Расщепление
энергетической
зоны Е(kz)
кристалла с
постоянной
решетки а на
минизоны Ej(kz)
потенциалом
сверхрешетки с
периодом d.
Число минизон
равно d/a
27.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
В общем виде дисперсионное соотношение для электрона в сверхрешетке
2k 2
E (k )
E j (k z )
2me
здесь j – номер энергетической минизоны.
Расщепление энергетической зоны полупроводника в направлении оси сверхрешетки на ряд
неперекрывающихся минизон является общим результатом для сверхрешеток разного типа.
Дисперсионный закон для носителей заряда в минизонах, положение и ширина минизоны
определяется конкретным типом сверхрешетки. Например, в композиционных сверхрешетках
I типа дисперсия энергетических минизон для зоны проводимости в приближении сильной
связи имеет следующий вид
2 2
Ec, j k z Ec, j d I D j (d II ) cosk z d
где
Ec, j d I
dI, dII - толщина первого и второго полупроводника соответственно;
D j d II
- ширина j-ой мини зоны
2
j
1
2m c ( I ) d I2
j = 0, 1, 2, ….
28.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИСтруктуры с двумерным электронным газом
Полупроводниковые сверхрешетки
Ec, j k z Ec, j d I D j (d II ) cosk z d
2 2
2
Ec, j d I
j
1
2m c ( I ) d I2
Приведенные выше соотношения представляют собой грубую оценку положения
энергетической минизоны для Ec,j << Dc (Dc – потенциал сверхрешетки).
Таким образом, изменяя ширину ямы для электронов dI, можно менять
положение минизоны, а изменением ширины барьера dII – ширину минизоны D,j.
Количественные оценки показывают, что для dI = 100 Å и dII =50 Å Ec,0 50 мэВ,
Dc,0 10 мэВ.
29.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Прогресс в экспериментальном изучении квантово-размерных структур и их применении
тесно связан с развитием технологии их получения и в значительной степени им и
определяется.
Одна из концепций создания наноструктур, получившая название «снизу-вверх»,
состоит в том, чтобы набрать, соединить и выстроить отдельные атомы и молекулы в
упорядоченную структуру. Этот подход можно осуществить с помощью самосборки или
некоторой последовательности каталитических химических реакций. Такие процессы
широко распространены в биологических системах, где, например, катализаторы,
называемые ферментами, собирая аминокислоты, формируют живые ткани.
Противоположная концепция формирования наноструктур обозначается «сверху-вниз».
При таком подходе процесс начинается с обработки макроскопического объекта или
структуры и состоит в постепенном уменьшении их размеров. Один из широко
распространенных процессов этого класса называется литографией. Для получения
наноразмерных квантовых структур требуется применение особых методов литографии
– нанолитографии, поскольку столь малые структуры трудно приготовить при помощи
стандартных методов.
30.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
В настоящее время большинство квантово-размерных структур создаются на основе
полупроводниковых гетеропереходов. Для этого прежде всего необходимо подобрать
подходящую пару полупроводниковых материалов. Основным требованием для
создания структур с двумерным электронным газом на основе гетеропереходов
является требование равенства постоянных решетки у обоих полупроводников.
Другое важное требование к технологии изготовления квантовых гетероструктур связано
с необходимостью получения очень резких гетеропереходов с переходным слоем,
имеющим толщину всего в несколько постоянных решетки.
Для плавного
гетероперехода (рис. б)
образуется потенциальная
яма большой ширины, что
уменьшает расстояние
между уровнями энергии
электрона и затрудняет
наблюдение квантовых
размерных эффектов.
31.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
В настоящее время наиболее часто для изготовления качественных гетероструктур
применяют метод молекулярно-лучевой эпитаксии (МЛЭ).
Эпитаксия (от греческого epí – на и táxis – расположение, порядок) –
ориентированный рост одного кристалла на поверхности другого
(подложка).
Когда монокристаллическая пленка растет на подложке, отличающейся от материала
пленки, и не вступает с ним в химическое взаимодействие, то такой процесс называется
гетероэпитаксией. Когда подложка и пленка по химическому составу не отличаются или
незначительно отличаются друг от друга, то процесс называется гомоэпитаксией или
автоэпитаксией. Ориентированное наращивание слоев пленки, которая вступает в
химическое взаимодействие с веществом подложки, называют хемоэпитаксией.
32.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Молекулярно-лучевая эпитаксия по существу является развитием до совершенства
технологии термического напыления тонких пленок в условиях сверхвысокого
вакуума. Давление остаточных газов в вакуумной камере поддерживается ниже 1∙108 Па (~10-10 мм рт. ст.)
Ее отличие от классической технологии вакуумного термического напыления
связано также с более высоким уровнем контроля технологического процесса.
В методе МЛЭ тонкие монокристаллические слои формируются на нагретой
монокристаллической подложке за счет реакций между молекулярными или
атомными пучками и поверхностью подложки. Высокая температура подложки
способствует миграции атомов по поверхности, в результате которой атомы
занимают строго определенные положения. Этим определяется ориентированный
рост кристалла формируемой пленки на монокристаллической подложке.
33.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
По сравнению с другими технологиями, используемыми для выращивания тонких
пленок и многослойных структур МЛЭ характеризуется, прежде всего малой
скоростью роста и относительно низкой температурой роста. К достоинствам этого
метода следует отнести возможность резкого прерывания и последующего
возобновления поступления на поверхность подложки молекулярных пучков
различных материалов, что наиболее важно для формирования многослойных
структур с резкими границами между слоями.
Наличие сверхвысокого вакуума в камере роста при МЛЭ позволяет использовать
различные методы контроля для определения параметров растущей структуры. В
различных сочетаниях в технологических установках МЛЭ используются методы
анализа структуры, состава и морфологии растущих слоев в процессе их
формирования методом дифракции отраженных быстрых электронов, дифракции
медленных электронов, электронной оже-спектроскопии, фотоэлектронной
спектроскопии, масс-спектроскопии вторичных ионов, лазерной эллипсометрии и
др.
34.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Упрощенная схема ростовой
камеры МЛЭ. Испарение жидких
или
сублимация
твердых
материалов,
осаждаемых
в
сверхвысоком
вакууме
на
подложку,
закрепленную
на
манипуляторе с нагревательным
устройством, осуществляется с
помощью эффузионных ячеек
(эффузия
–
медленное
истечение газов через малые
отверстия).
1 – держатель образца с нагревателем; 2 –
образец; 3 – масс-спектрометр; 4 - эффузионные
ячейки; 5 – заслонки; 6 – манипулятор; 7 –
электронная пушка ДОБЭ; 8 – люминесцентный
экран.
35.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Эффузионная
ячейка
представляет
собой
цилиндрический либо конический стакан (тигель)
диаметром 1 – 2 см и длиной 5 – 10 см. Для
изготовления тигля используют пиролитический
графит высокой чистоты, либо нитрид бора BN.
Поверх тигля располагаются нагревательная
спираль из танталовой проволоки и тепловой экран,
изготовленный обычно из танталовой фольги.
1- тигель; 2 – нагреватель; 3 – радиационный
экран; 4 – термопара.
36.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Эффузионные ячейки могут работать в области
температур до 1400 0С и выдерживать кратковременный
нагрев до 1600 0С. Для испарения тугоплавких
материалов, которые используются в технологии
магнитных тонких пленок и многослойных структур,
нагревание испаряемого материала осуществляется
электронной бомбардировкой. Температура испаряемого
вещества
контролируется
вольфрам-рениевой
термопарой, прижатой к тиглю. Испаритель крепится на
отдельном фланце, на котором имеются электрические
выводы для питания нагревателя и термопары. Как
правило, в одной ростовой камере располагается
несколько испарителей, в каждом из которых размещены
основные компоненты пленок и материалы легирующих
примесей.
1- тигель; 2 – нагреватель; 3 – радиационный
экран; 4 – термопара.
37.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Наиболее важная для технологического
процесса
область
ростовой
камеры
находится между эффузионными ячейками
и
подложкой.
Эту
область
можно
разделить
на
три
зоны,
которые
обозначены на рисунке цифрами I, II и III.
Зона I –зона генерации молекулярных
пучков, в этой зоне молекулярные пучки,
формируемые каждой из эффузионных
ячеек, не пересекаются и не влияют друг
на друга. Во второй зоне (зона II – зона
смешения
испаряемых
элементов)
молекулярные пучки пересекаются и
происходит перемешивание различных
компонент. В непосредственной близости
от поверхности подложки располагается
зона III –зона кристаллизации. В этой зоне
происходит
эпитаксиальный
рост
в
процессе молекулярно-лучевой эпитаксии.
1 – держатель образца с нагревателем; 2 –
образец; 3 – масс-спектрометр;
4 - эффузионные ячейки; 5 – заслонки; 6 –
манипулятор; 7 – электронная пушка ДОБЭ;
8 – люминесцентный экран.
38.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Наиболее важные индивидуальные
атомные процессы, сопровождающие
эпитаксиальный рост следующие:
• адсорбция составляющих атомов
или молекул на поверхности
подложки;
• поверхностная миграция атомов и
диссоциация адсорбированных
молекул;
• присоединение атомов к
кристаллической решетке подложки
или эпитаксиальным слоям,
выращенным ранее;
• термическая десорбция атомов или
молекул, не внедренных в
кристаллическую решетку.
1 – поверхностная диффузия; 2 - десорбция;
3 – взаимодиффузия; 4 - встраивание в
решетку; 5 – поверхностная аггрегация
(зародышеобразование).
39.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Образование эпитаксиальной пленки связано с фазовым переходом из сильно
неравновесной паровой фазы в твердую фазу тонкой пленки. Парциальное давление
в пучках компонент в несколько раз превосходит равновесное с подложкой давление
пара. Это означает, что процесс осаждения в целом является неравновесным.
Поэтому наряду с термодинамическими параметрами в процессе роста важную роль
играют такие кинетические процессы, как способность атомов двигаться по
поверхности (поверхностная диффузия), среднее время пребывания их на
поверхности и поток атомов и молекул на растущую поверхность твердого тела.
Скорость поступления вещества на подложку определяется потоком (интенсивностью
пучка) атомов или молекул. При МЛЭ полупроводниковых соединений типичные
значения потоков составляют 1014 – 1016 атом/(см2∙ с).
Прежде чем встроиться в решетку, атом совершает в среднем 106 прыжков по
поверхности. Такое число прыжков лает массу возможностей выбора положения с
наименьшей свободной энергией. Процессы роста при МЛЭ в значительной мере
определяются химией поверхностных реакций.
40.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Молекулярно-лучевая эпитаксия
Основные характеристики метода МЛЭ
1) малая скорость роста, порядка 1 мкм/час;
2) относительно низкая температура роста (температура подложки);
3) возможность резкого прерывания и возобновления роста за счет
использования механических заслонок вблизи эффузионных ячеек для всех
компонентов;
4) возможность введения различных парообразных компонентов для
изменения состава слоя и управления концентрацией примесей путем
введения дополнительных источников;
5) наличие атомно-гладкой поверхности растущего кристалла при
эпитаксиальном росте;
6) возможность анализа и контроля в ходе роста.
41.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Термин «металлорганика» обозначает вещества, содержащие металлуглеродные (органометаллические соединения) или металл-кислородуглеродные связи (алкоксиды), а также соединения металлов с органическими
молекулами.
Эти вещества обычно имеют высокое давление паров и легко могут быть
доставлены в зону реакции путем пропускания газа-носителя, например
водорода или гелия, через жидкость или над твердым телом, которые играют
роль источника.
В различных источниках для описания этой технологии используется разные названия:
«металлоорганическая газофазная эпитаксия», «органометаллическая газофазная
эпитаксия», «металлалкильная газофазная эпитаксия». Название «рост из газовой фазы
с использованием металлоорганических соединений» является наиболее общим, так как
подчеркивает возможность роста неэпитаксиальных (поликристаллических или
аморфных) пленок. В этом методе рост эпитаксиального, поликристаллического или
аморфного слоя осуществляется при термическом разложении ( пиролизе) газообразных
металлогранических соединений и последующей химической реакции между
возникающими компонентами на нагретой подложке.
42.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Впервые в 1968 г. методом РГФ МОС были получены пленки арсенида галлия.
Химическая реакция в этом случае имеет вид
H , 700 C
CH 3 3 Ga AsH 3
GaAs 3CH 4
2
0
Разложение газовой смеси триметилгаллия (CH3)3Ga и гидрида мышьяка (арсина)
AsH3 происходит при температуре 700 0С в атмосфере водорода Н2.
43.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
С помощью РГФ МОС выращивают большинство полупроводниковых соединений AIIIBV,
AIIBVI и AIVBVI, а также многие важные тройные и четверные соединения AIIIBV. Например,
соединение AlxGa1-xAs обычно выращивают, используя следующий процесс:
1 x CH 3 3 Ga x CH 3 3 Al AsH 3 AlxGa1 x As 3CH 4
H 2 , 700 0C
Состав растущего слоя непосредственно определяется отношением парциальных
давлений триметилгаллия и триметилалюминия в газовой фазе.
Легирование осуществляется путем введения в газовый поток соответствующего
реагента.
44.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Приведенные выше реакции
проводят в специальных
реакторах.
Схематическое изображение
вертикального реактора для
РГФ МОС 1 – кварцевый
реактор; 2 – высокочастотный
нагреватель; 3 – подложка; 4
– графитовый держатель; 5 –
источники
металлорганических
соединений; 6 – датчики
потока; 7 – вентили;
45.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Подложка 3, на которой
происходит кристаллизация
требуемого соединения
помещена на графитовом
держателе 4 внутри кварцевого
реактора 1. Реакция
происходит при атмосферном
или при пониженном
(приблизительно до 10 торр)
давлении.
46.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Температура пиролиза 600 – 800 0С
обеспечивается радиочастотным
нагревом с частотой несколько сотен
килогерц (высокочастотный
нагреватель 2). Такая система
нагрева создает высокую
температуру вблизи поверхности
подложки, так как нагревается
только графитовый держатель, в то
время как стенки реакционной
камеры остаются холодными. В этом
случае полупроводниковая пленка
образуется только на поверхности
подложки, а реакция на стенках
реактора не наступает.
47.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Температура пиролиза 600 – 800 0С
обеспечивается радиочастотным
нагревом с частотой несколько сотен
килогерц (высокочастотный
нагреватель 2). Такая система
нагрева создает высокую
температуру вблизи поверхности
подложки, так как нагревается
только графитовый держатель, в то
время как стенки реакционной
камеры остаются холодными. В этом
случае полупроводниковая пленка
образуется только на поверхности
подложки, а реакция на стенках
реактора не наступает.
48.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Металлоорганические соединения
(на рисунке – диэтилцинк DEZn,
триметил галлий TMGa,
триметилалюминий TMAl)
доставляются в зону реакции с
помощью газа носителя H2.
49.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Рост из газовой фазы с использованием металлоорганических
соединений
Многослойные, многокомпонентные структуры методом РГФ МОС могут быть
выращены в едином ростовом цикле. Для этой цели в реакторах
предусмотрена возможность подключения нескольких металлорганических и
гидритных источников. Использование автоматизированного управления
процессом роста в методе РГФ МОС позволяет создавать полупроводниковые
сверхрешетки с толщиной отдельных слоев до
1,5 нм, причем изменение состава на гетеропереходе происходит практически
на толщине одного атомного слоя.
К достоинствам метода РГФ МОС следует отнести возможность создания
однородных эпитаксиальных структур большой площади на установках,
аналогичных тем, которые используются в производстве промышленного
эпитаксиального кремния.
50.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Нанолитография
Слово «литография» происходит от двух греческих корней «камень» и «пишу».
Первоначально им обозначали способ печатания изображений, при котором
рисунок сначала наносили на плоскую поверхность камня, а затем делали
оттиск с него на другом материале. Во второй половине ХХ века так стали
называть и процессы переноса рисунков электрических схем в производстве
микроэлектроники.
Смысл и главная цель литографии заключается в переносе чертежа
электрической схемы устройства на кремниевую (в подавляющем большинстве
случаев) подложку. После этого различными физико-химическими средствами
осуществляют поэтапное формирование необходимых структур и их
соединений. Обычно для этого требуется несколько десятков операций, итогом
которых является готовая интегральная электрическая схема (ИС) или
микромеханическая система (МЭМС).
51.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Нанолитография
Современная промышленная
микро-/нанолитография
использует главным образом
оптический способ переноса
рисунка с шаблона на
поверхность подложки, в связи
с чем сам процесс часто
называют фотолитографией.
Оптическая нанолитография:
И – источник излучения; О –
оптические элементы; М – маскашаблон; Р – резист; П - подложка
52.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Нанолитография
В процессе фотолитографии пучок
видимого или ультрафиолетового
света падает через маску нужной
формы на тонкое покрытие из
светочувствительного материала –
фоторезиста, покрывающего
полупроводниковую подложку.
Фоторезист - сложная полимерная
светочувствительная композиция.
Фоторезист, у которого
растворимость освещенного
участка уменьшается, называется
негативным, а фоторезист,
растворимость которого после
облучения возрастает, позитивным.
53.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Нанолитография
Далее на фоторезист действуют
селективным химическим
травителем. Проэкспонированные
участки позитивного резиста
стравливаютс со скоростью во много
раз большей от неэкспонированных
участков. (Для негативного резиста
скорость травления
экспонированных участков во много
раз меньше, чем
неэкспонированных).
В результаты этого процесса рисунок
с маски-шаблона переносится на
подложку.
54.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Нанолитография
Нанолитографию используют для получения одно- и нуль-мерных структур.
Она позволяет вырезать области, ограниченные по одному или двум
направлениям, используя в качестве исходного объекта структуры с
двумерным электронным газом.
Использование оптического – наиболее удобного и разработанного способа
литографии – предопределяет физический предел миниатюризации при ее
применении: ~ 100 нм ( в случае экспонирования резиста ультрафиолетовым
источником). Для дальнейшего повышения разрешения необходимо
применять или более жесткое излучение – рентгеновское, электронное,
ионное – или переходить к альтернативным технологиям.
55.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Значительный прогресс в структурной диагностике и технологии низкоразмерных
систем был достигнут с развитием и широким применением методов
сканирующей зондовой микроскопии (СЗМ): сканирующей туннельной
микроскопии (СТМ), атомно-силовой микроскопии (АСМ) и др.
Особой привлекательностью методов СЗМ является возможность точного
позиционирования нанометрового острия относительно исследуемого образца. В
частности, это открывает возможность применения этих методов для создания
наноразмерных объектов. В качестве примера можно привести работы по
переносу на острие зонда и укладыванию на поверхности единичных атомов, что
является предельной возможностью литографии.
В современных нанотехнологиях все более широкое распространение получают
методы нанолитографии, основанные на взаимодействии острия с поверхностью.
Нобелевский лауреат по физике 2000 г. Ж.И. Алферов считает зондовые
сканирующие методы одним из трех краеугольных камней нанотехнологии
(наряду с молекулярно-лучевой эпитаксией и самосборкой атомный кластеров на
поверхности).
56.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
57.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Сканирующий туннельный микроскоп - первый из семейства зондовых
микросокопов – был изобретен в 1981 году швейцарскими учеными
Гердом Биннигом и Генрихом Рорером.
В 1986 году за создание туннельного микроскопа Г. Биннигу и Г. Рореру
была присуждена Нобелевская премия по физике.
Вслед за туннельным микроскопом в течение короткого времени были
созданы атомно-силовой микроскоп, магнитно-силовой микроскоп (МСМ),
электросиловой микроскоп (ЭСМ), ближнепольный оптический микроскоп
(БОП) и многие другие приборы, имеющие сходные принципы работы и
называемые сканирующими зондовыми микроскопами.
58.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
59.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
60.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
61.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
62.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
63.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
64.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
65.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
66.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
67.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
68.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
69.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Понадобилось совсем немного времени после изобретения сканирующей
туннельной микроскопии для того, чтобы осознать и реализовать в дополнение
к ее исследовательским функциям еще и активные: захват отдельных атомов,
перенос их в новую позицию, атомарную сборку проводников шириной в один
или несколько атомов, локальные химические реакции, манипулирование
отдельными молекулами и т.д.
Если атом, который необходимо переместить, соединен с поверхностью
образца ковалентной связью, то электрического поля, создаваемого иглой СТМ,
может оказаться достаточно для разрыва этой связи. В результате такого акта
атомной эмиссии атом будет прицеплен к кончику иглы. Затем иглу СТМ
перемещают в другую точку поверхности, меняют знак напряжения между иглой
и поверхностью образца и помещают атом обратно на поверхность.
70.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Обычно используют два способа манипуляции
атомами с помощью иглы СТМ: горизонтальный
и вертикальный. В первом случае атом
перемещают («перекатывают») по поверхности
без отрыва от нее. Процесс вертикальной
манипуляции отличается от горизонтальной
тем, что после захвата нужного атома его
отрывают от поверхности, поднимая зонд на
несколько ангстрем.
Схематическое изображение
горизонтального и (а) и вертикального (б)
перемещения атомов в сканирующем
микроскопе:
1 – зонд; 2 – область взаимодействия на
кончике зонда;
3 – атом, подлежащий перемещению
71.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Предложен также способ химического
окисления и модифицирования
поверхности, индуцированное
движущимся острием при
прохождении тока между острием и
подложкой
Модификация полимерной пленки на
подложке локальным электрическим
полем зонда:
а – стадия экспозиции в поле; б – результат
после химической обработки:
1 – кремниевая подложка; 2 – полимерный
резист; 3 - зонд
72.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Другой способ использования сканирующего микроскопа в нанотехнологии
состоит в том, что между зондом и подложкой прикладывают достаточно
большое напряжение, по действием которого материал с кончика зонда
начинает напыляться на подложку. При перемещении зонда атомы попадают
на поверхность и образуют нить нанометрового масштаба.
73.
НИЗКОРАЗМЕРНЫЕ СТРУКТУРЫ И ТЕХНОЛОГИИТехнология квантово-размерных структур
Применение сканирующей зондовой микроскопии
Схема литографии методом осаждения молекул на подложку движущимся
зондом – «нанописьменность»:
1 – кончик зонда; 2 – водный мениск; 3 – подложка; 4 – направление движения молекул
вдоль зонда; 5 – осажденные молекулы, остающиеся на подложке на траектории
движения зонда



























































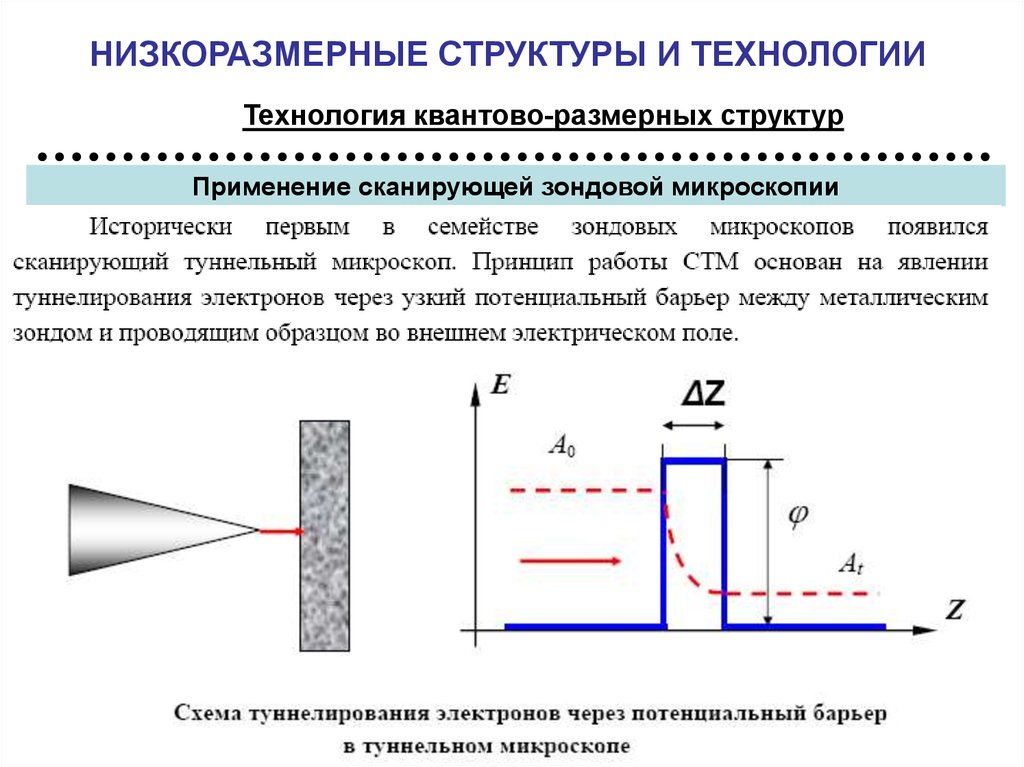






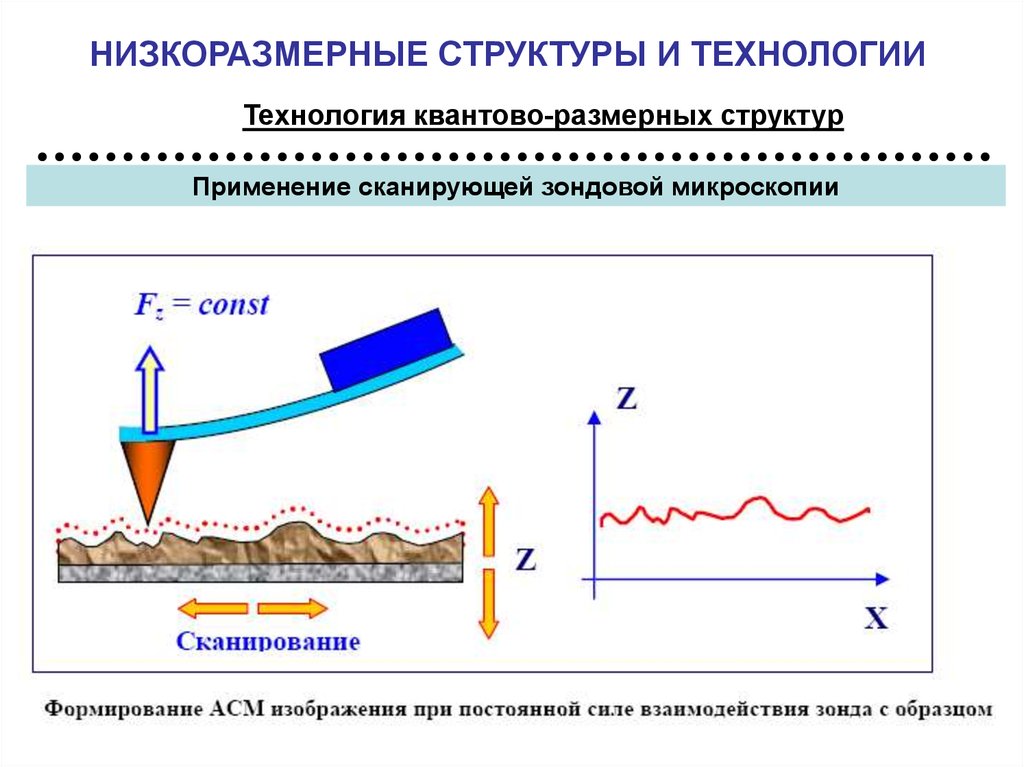






 physics
physics








