Ionimplantáció. Monolit technika előadás
1. Ionimplantáció
Monolit technika előadás2. Ionimplantáció alapok
• Alapelv:– A kívánt adalék atomokat felgyorsított ionokként (B+,
P+, As+) bombázzuk a félvezető szelet felszíni, felszín
közeli rétegeibe
– Vákuum technológia
– Mind rétegnövelő, mind rétegalakító művelet
– A diffúzióval szemben az ionimplantáció erősen nem
egyensúlyi folyamat (pár keV-MeV a becsapódó ion
energiája)
• Diffúzió energiája :
k T
q
, amely 1200°C-on 0,1eV
2
3. Az ionimplanter felépítése I.
Varian 350D ionimplanter, 4 és 6 inches szeletekhez3
4. Az ionimplanter felépítése II.
45. Az ionimplanter felépítése III.
• A becsapódó ion energiája jól szabályozható agyorsító feszültséggel (keV-MeV)
• Mágneses térrel hangolható m/q szelekció, ez
igen tiszta technológiát tesz lehetővé
• Az ion-nyaláb képes végigpásztázni a hordozó
felületét
• A target-tartó vákuum zsilipben helyezkedik el,
hogy ne kelljen szelet cserénél újra leszívni az
ultra nagy vákuumot (UHV)
5
6.
10 kVIonimplanter
B
Ionforrás
B: indukció a tömegszeparátorban
előgyorsító
m
r~
q
apertúra
utógyorsító
eltérítő
szelet
Utógyorsító:
100 kV-2.5 MV
= ionenergia
6
7. Tömegszeparátor
A mágneses tér és az ionok sebességvektora merőlegesek egymásra ->
az ionok körpályára kerülnek
A kör sugara függ az ion tömegétől
m v2
F q (vxB)
R
m v2
q V
2
m R 2 B2
v: belépő ion sebessége
q
2V
V: gyorsító feszültség
Ha kell, izotópos tisztaságot tesz lehetővé
7
8. Belőtt ionok és a szubsztrát kölcsönhatása
• Az ionimplantáció porlasztással jár kis és közepes energiák eseténis (egy belépő ionra 5-10 porlasztott ion jut)
• Ez nagyobb dózisok és energiák esetén egyensúlyba kerülhet a
részecskeárammal
• A belépő ionok fékeződését a Coulomb-erők okozzák
– Kétféle mechanizmus:
• Elektronfékeződés
• Nukleáris fékeződés
8
9. Elektronfékeződés
• Belépő ionok és a szubsztrát atomjainak elektronfelhőiközti kölcsönhatás
• A fékeződés mechanizmusa az ion pillanatnyi
energiájától függ
• Ez dominál nagyobb (1 MeV-100 keV) energiákon
• „Rugalmatlan” folyamatok, azaz az ionok kinetikus
energiája fény-, röntgensugárzás formájában emésztődik
fel
• Polarizálja a rácsot, de kevés, zömmel ponthibát kelt
csak
9
10. Nukleáris fékeződés
• Kisebb energiákon a magok közti Coulomb kölcsönhatásdominál
• „Rugalmas” ütközés, azaz képes rácsatomokat kiütni a
helyéről
• Ez az energiaátadás vezet rácshibák keletkezéséhez
10
11. Fékező hatások összehasonlítása
http://www.gs68.de/tutorials/implant.pdf11
12. Becsapódás
• R – az ion által megtettút
• Rp – a hordozó
felületétől való távolság
• R függ a belőtt anyag
rendszámától
• Nagy rendszámú
anyagba kis rendszámú
lövedék: R>>Rp
12
13. Alapfogalmak
• Összes belőtt adalék:t
xj
1
Ii (t)dt q N(x)dx
0
A0
Gummel -szám
• Dózis:
I t
N(x)dx
q A 0
1
cm 2
• Energia –> Gyorsító
feszültség [eV]
13
14. Adalékeloszlás
• A folyamatokat az implantált ion rendszáma a gyorsító energia ésa szubsztrátot alkotó elem rendszáma befolyásolja
• A becsapódó ionok átlagos mélységben, normális eloszlás szerint
kerülnek nyugalmi állapotba
x Rp
1
N(x)
exp
2 R p
2 R p
2
Maximum: Rp
Szórás: Rp
14
15. Rp és DRp meghatározása I.
Rp és Rp meghatározása I.• LSS elmélet (Lindhard, Scharff, Schiøtt)
– Mitől áll meg az ion és hol?
dE
Sn (E) SE (E)
dx
Atomokkal való kölcsönhatás
Elektronokkal való kölcsönhatás
15
16. Rp és DRp meghatározása II.
Rp és Rp meghatározása II.Se (E) k e E
1 E0
dE
R
N 0 Sn (E) Se (E)
Rp
R
M1: Implant atomtömege
M2
1
3M1
M2: Target atomtömege
M1M1 2
2
R P R P
3
M1 M 2
Modellezés:
M2
1
13E keV
M1
R nm
2
Z1 3
Z1: Implant rendszáma
: Target sűrűsége
Ha M1>>M2, akkor R Rp
http://www.gs68.de/software/simplant/index.html
16
17. Bór ionok eloszlása Si hordozóban
Amorf SiSi-ba <763> irányból lőve
Si-ba <763> irányból lőnek, mivel innen tűnik a legrendezetlenebbnek
17
18. Csatorna hatás I.
• Az ionimplantációval pontos adalékeloszlás hozható létre, azonban egyesadalék ionok eltévedhetnek, és esetleg mélyebbre jutnak, mint szeretnénk.
Gyémántrács˙különböző irányokból
18
19. Csatorna hatás II.
1920. Csatorna hatás elkerülése
• A szelet pozicionálása (döntés és csavarás)• Amorf vékony oxid réteg növesztése (200-250Å)
• A kristály amorffá tétele implantációval (Pl. Si
implantálás Si hordozóba)
• A kirstály amorffá tétele nagy dózisú, nagy
tömegű atomokkal (As)
20
21.
Több implant egymás után21
22.
Kaszkádok, sérült tartományokés amorfizáció
Hőkezelés: „szilárd fázisú epitaxia”
22
23. Hőkezelés
• Alkalmas az implantáció okozta roncsolás (kristályhibák)kijavítására
• Már 700-800°C-on is újra rendeződik az egykristály
szerkezet
• A hőkezelésnek összhangban kell lennie az egyéb
technológiai lépésekkel (Pl. ne indítson el egy diffúziós
folyamatot)
23
24. Maszkolás I.
•Fotoreziszt használható maszknak•Szemben a diffúzióval, ahol a felület közelében mindig
nagyobb a koncentráció, itt elérhető, hogy a felületen kisebb,
míg beljebb nagyobb legyen ~ tetszőleges profilok
készíthetőek
•Oda kell figyelni az alászóródásra
24
25. Maszkolás II.
• A legnagyobb koncentráció nem a felszínen van• Következő lépésként diffúzióval beljebb hajthatjuk az
adalékot
Ionimplantációval kialakított adalékprofil
25
26. Ionimplantáció félvezető-technológiai alkamazása
1/cm2Az egyéb alkalmazások - mint pl. a fémek, kerámiák kopásállóságának
javítása – a 10 … 100keV, 1021…1022 ion/m2 tartományba esnek, míg a
26
polimerek kezelése az ún. mixinggel van nagyjából fedésben.
27. Ionimplantáció félvezető-technológiai alkamazása
2728. Mellékjelenség: nem minden implantált atom aktív elektromosan
Következmények: későbbjönnek elő
28
29. Előnyök
– Nagyon pontos– Kis oldalirányú szóródás
– Tömeg szeparáció lehetséges
– Utólag is lehetséges új réteg létrehozása
– Meredek adalékprofil hozható létre
– Alacsony hőmérsékleten végezhető
– A vákuum miatt igen tiszta eljárás
– Az egyensúlyi technológiákhoz képest
nagyobb koncentráció is létrehozható
29
30. Hátrányok
– A rácsszerkezet rongálódik– Nehéz atomokkal csak sekély implantáció
valósítható meg
– Alacsonyabb termelékenység, mint diffúzióval
– Drága, bonyolult berendezések
– Veszélyes üzemeltetés
30
31. RBS spektroszkópia
"It was as though one fired a bullet at a piece of paper, and itbounced back at you!" - Ernest Rutherford
• Rutherford backscattering
– Egy hordozóban különféle elemek meghatározása a
mélység függvényében
– 2-4 MeV-os kis tömegű (He++) ionsugárral bombázzák
a mintát
– Egy detektor összegyűjti a közel 180°-ban
visszaverődő ionokat
– Ezeknek az energiája függ a kezdeti energiától, és a
részecske tömegétől, amiről visszaverődtek
• Az energia mértéke, amit elnyel a vizsgált atom, a két
részecske tömegének az arányától függ
– Meghatározhatjuk a minta kémiai összetételét
31
32. Források
• Dr. Mojzes Imre: Mikroelektronika és elektronikaitechnológia
• http://www.vsea.com/pubs.nsf/home
• http://www.casetechnology.com/links.html
• http://en.wikipedia.org/wiki/Ion_implantation
• http://www.gs68.de/tutorials/implant.pdf
• http://en.wikipedia.org/wiki/Rutherford_backscattering
32
33. Adalékolás neutronsugárzással NTD (neutron transmutational doping)
IGBT, teljesítmény eszközök: kicsi adalékolás, de pontos -> nagy letörési feszültség33
34.
Teljesítmény MOS tranzisztorokA DMOS (TMOS)
szerkezet
S
G
D
34
35.
IGBT (Insulated Gate Bipolar Transistor)Szigetelt vezérlőelektródájú bipoláris tranzisztor
S
C
G
D
B
E
35
36. Implantálás plazma immerzióval
36direct ion implantation from a plasma ambient





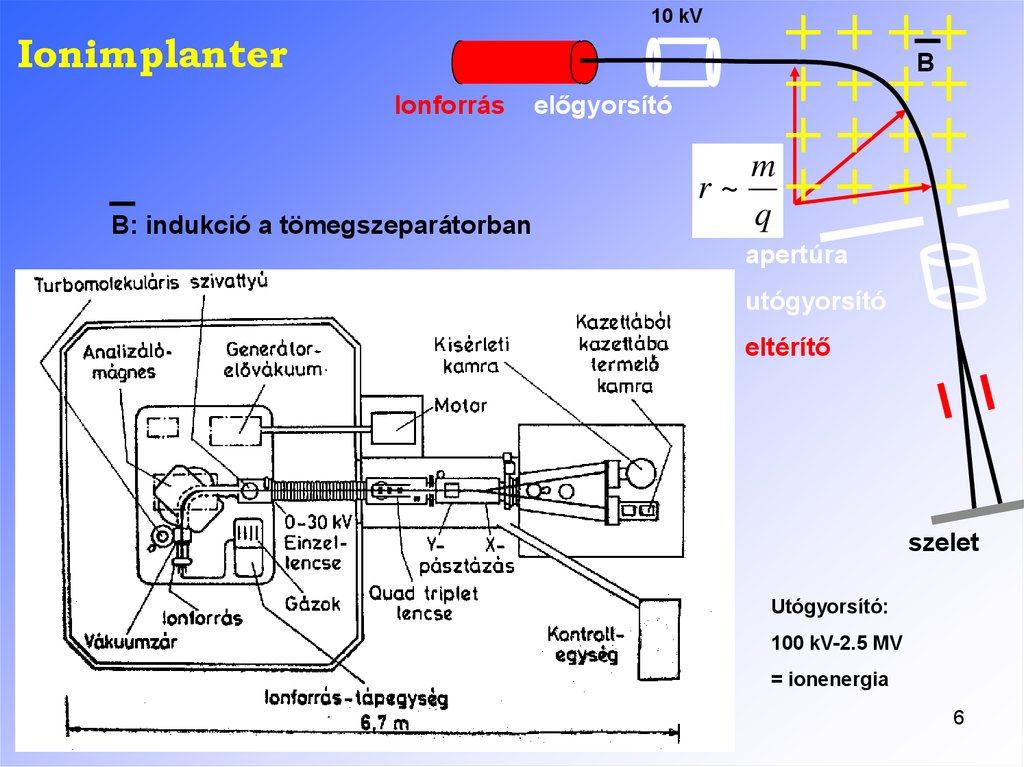





















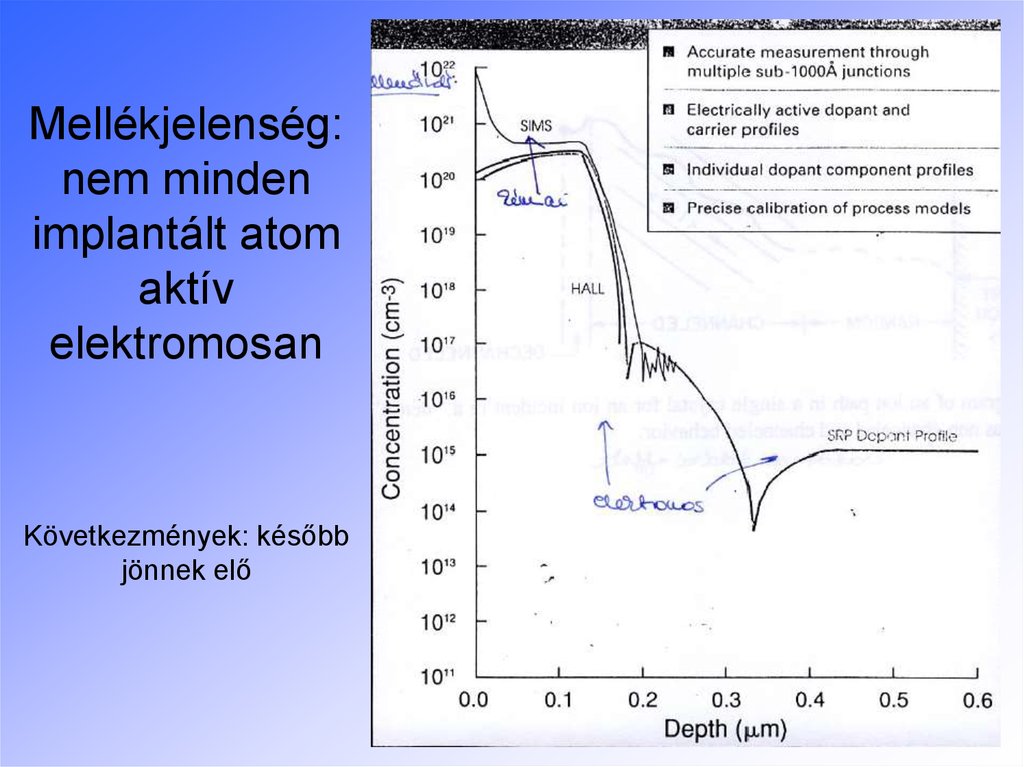






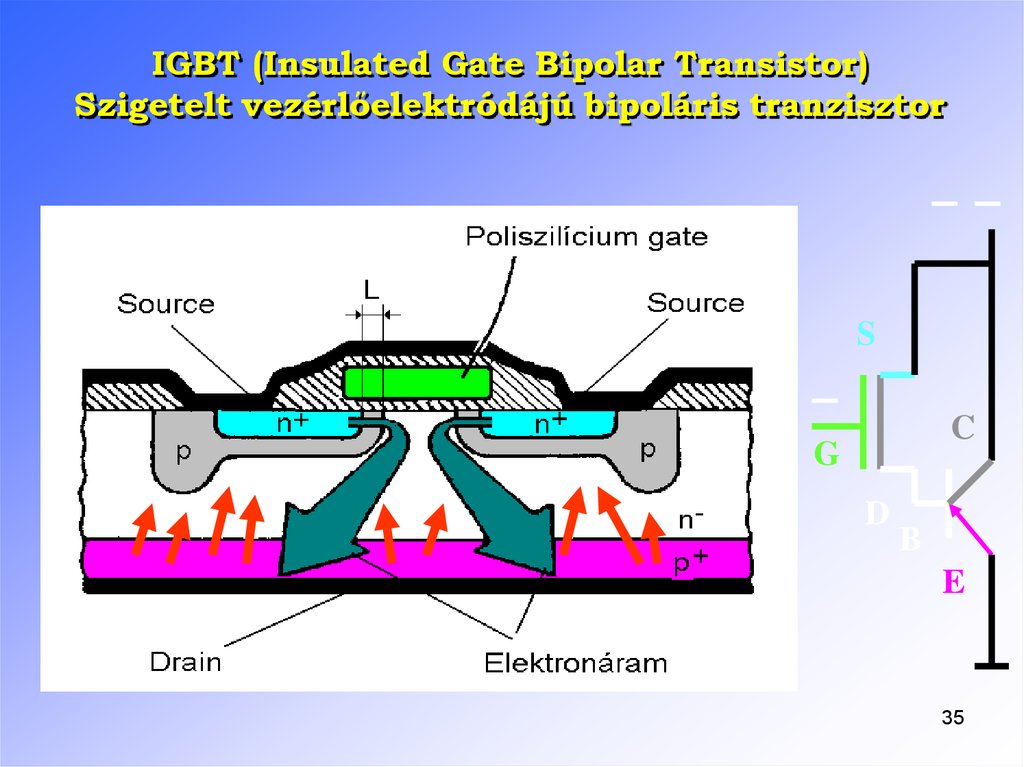


 chemistry
chemistry