Similar presentations:
Лекция № 2
1. Лекция № 2
Основы технологии ЭКБЛекция № 2
Диэлектрические
слои
1
2. Оксидные слои кремния используются:
для маскировки поверхности полупроводниковой пластиныпри проведении процессов диффузии;
для изоляции активных и пассивных элементов ИС;
для защиты поверхности полупроводника и особенно
выходов на поверхность p-n-переходов от внешних
воздействий;
для создания тонкого диэлектрического слоя под затвором
МОП - приборов, межслойной изоляции.
а — пассивация поверхности; б — маска для локального
легирования; в — тонкий подзатворный оксид
2
3. Маскирующая способность SiO2
Оксид кремния представляет Маскирующиесвойства
собой
широкозонный пленок SiO2 определяются
диэлектрик
(ширина значительно
меньшим
запрещенной зоны Еg равна значением
коэффициента
8,1 эВ).
диффузии
основных
Удельное
электрическое донорных и акцепторных
в
SiO2
по
сопротивление
SiO2 примесей
сравнению с Si.
10 15 - 10 16 Ом·см.
3
4. Методы изготовления SiO2. Термическое окисление кремния.
Сущность метода термического окисления сводится кокислительной обработке поверхности кремниевых
пластин в среде сухого, влажного кислорода или парах
воды при повышенной температуре.
В случае окисления в
сухом кислороде
происходит реакция
Si + О2 SiO2.
Природа реакции взаимодействия с парами
воды более сложна. На первом этапе водяные
нары вступают в реакцию с ионами кислорода
H2O + (Si - О - Si) (Si - ОН) + (Si - ОН).
Затем гидроксильные группы диффундируют
через оксид и на границе раздела Si - SiO2
вступают в реакцию с кремнием
4
5. Методы изготовления SiO2. Термическое окисление кремния.
Чтобы определить скорость роста оксида, необходиморассмотреть потоки окислителя к поверхности оксида (F1),
в оксиде (F2) и на границе оксида с кремнием (F3).
Значительная доля окисления протекает в
соответствии с параболическим
законом . Закон роста оксида зависит также
от времени и температуры окисления. При
пониженных температурах и малом
времени окисления выполняется линейный
закон, а при повышенных
– параболический.
5
6. Методы изготовления SiO2. Установка термическое окисление кремния.
Установка состоит из печи сопротивления (5), применяемой обычно для проведенияпроцесса диффузии. Температура в рабочей зоне может изменяться в интервале 9001200°С при точности поддержания ее ±1°С. В рабочий канал печи помещается реактор
(1), изготовленный из оптического плавленого кварца. Реактор имеет шлиф (2) для
отделения реакционного объема от внешней среды. Со стороны входа реактор
соединен с системой подачи окислителя: сухого кислорода, водяного пар, влажного
кислорода.
Схема установки термического окисления кремния
1 – реактор; 2 - шлиф;
3 - пластины кремния;
4 - держатель пластин;
5 - печь сопротивления;
6 - барботер; 7 - ротаметр;
8 – вентиль-натекатель
6
7. Методы изготовления SiO2. Термическое окисление кремния в потоке водяного пара
Источником пара служит барботер (6) с деионизованной водой, котораянагревается до определенной температуры. Температура барботера
определяет парциальное давление водяных паров над поверхностью воды,
которое, в свою очередь, определяет скорость потока пара в реакторе. При
кипячении деионизованной воды в барботере обеспечивается
поддержание давления пара в реакторе на уровне атмосферного в течение
всего процесса окисления.
7
8. Методы изготовления SiO2. Термическое окисление кремния в сухом кислороде
Окисление в сухом кислороде широко применяется, так как обеспечиваетполучение высококачественных пленок с низкой плотностью
фиксированного заряда на границе раздела Si - SiO2. Температура
окисления обычно 1000 - 1200°С.
8
9. Методы изготовления SiO2. Термическое окисление кремния во влажном кислороде
На практике при термическом окислении очень часто используют смеськислорода и паров воды. При этом скорость роста SiO2 может
приближаться к высокой скорости в парах воды, а свойства слоя могут
быть ненамного хуже, чем при выращивании в атмосфере сухого
кислорода.
9
10. Методы изготовления SiO2. Пиролиз кислородосодержащих соединений
В основе метода лежит реакция пиролиза, т.е.термического разложения паров проходящего соединения
на поверхности подложки. Такими соединениями являются
алкоксилаты (например, этилтриэтаксисилан
C2H5Si(OC2H5)3). При температуре 650 – 800 оС они
разлагаются с выделением SiO2, SiO, C и органических
радикалов в газообразной фазе. Установка похожа на
установку окисления в водяном паре.
10
11. Методы изготовления SiO2. Анодное окисление
Процесс проводится в ячейке, в которой анодом являетсяокисляемый образец, а катодом — пластина высокоомного
кремния. Окисление осуществляется в гальваностатическом
режиме при комнатной температуре.
Рост происходит за счет миграции ионов Si через оксид – граница
раздела оксид-электролит. Свойства анодного оксида
определяется природой раствора, поэтому необходимо
подбирать электролиты, обеспечивающие заданный состав,
электрофизические свойства, пористость, полезный выход по току
в процессе анодирования.
Распространение получили электролиты на основе органических
растворителей с малой вязкостью и малой гигроскопичностью.
Могут быть использованы: этиленгликоль, H3BO3, HN4OH.
11
12. Методы изготовления SiO2. Осаждение термическим испарением
Используют два метода, основанных на испарении монооксидакремния. Первый – используют порошкообразный монооксид,
второй – кремниевый электрод нагревается в атмосфере
кислорода. Скорость испарения регулируют изменением
мощности, служащей для нагрева лодочки. При малой скорости и
высоком парциальном давлении кислорода, пленка обладает
характеристиками SiO2. При больших скоростях и при низком
давлении характеристики схожи с SiO.
12
13. Методы изготовления SiO2. Реактивное катодное распыление
Основан на использовании электрического разряда междуэлектродами при низком давлении окисляющего газа. Под
действием бомбардировки ионизированными молекулами газа
материал катода испаряется в виде свободных атомов и
соединений, образующихся при реакции катода с остаточными
молекулами газа. Можно подвергать распылению кремниевую
мишень в присутствии кислорода.
13
14. Перераспределение примесей на границе Si – SiO2
При термическом окислении на поверхностикремния образуется либо истощенный, либо
насыщенный примесью слой благодаря уходу
части примеси в образующийся слой или,
наоборот, отталкиванию примеси оксидом и
накоплению ее в приповерхностном слое
кремния. Истощение или накопление примеси
в приповерхностном слое кремния зависит от
коэффициента распределения примеси m
между фазами Si и SiO2.
Концентрационные профили в Si и
SiO2 для различных
коэффициентов распределения: a m <1; б - m >1
14







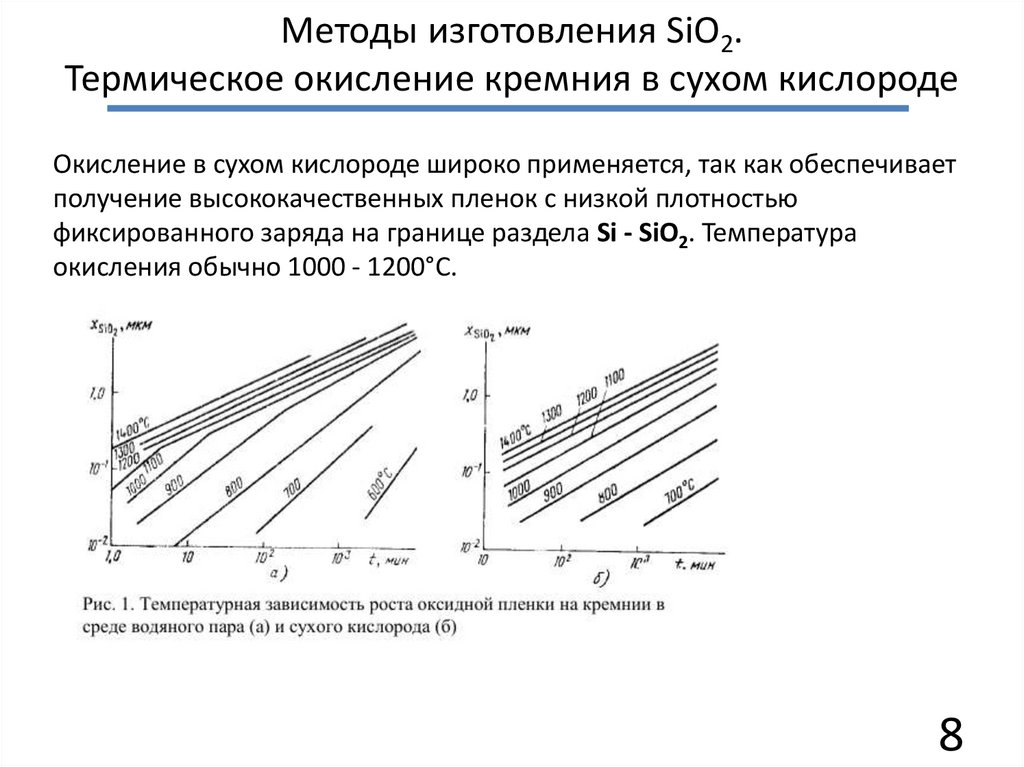






 physics
physics








