Similar presentations:
Источники оптического импульсного когерентного излучения для информационных систем III
1.
Источники оптического импульсногокогерентного излучения для
информационных систем III
Полупроводниковые лазеры
Квантово-размерные структуры
Вертикально-излучающие лазеры
Кремниевая фотоника
2.
Простейший полупроводниковый лазерТолщина l определяется через постоянную диффузии D электронов и временем
рекомбинации tau: для GaAs D = 10 см2/с и tau = 10-9 секунд толщина l~ 1 мкм. Только в этой
узкой полосе возможны усиление света и генерация лазерного излучения. n1 - плотность
электронов в нелегированном пп.
3.
Генерация излученияпроисходит в диодном лазере
посредством рекомбинации
электронов и дырок при
подаче напряжения U в
направлении пропускания.
Это напряжение уменьшает
разность потенциалов между
зонами п- и р-типа.
Если напряжение U
укладывается в порядок
величин ширины запрещенной
зоны (eU~Eg) в направлении
пропускания диода, то
разность потенциалов между
двумя энергетическими
зонами сокращается.
(а) Низкое напряжение дает только слабое световое излучение, б) более высокое
напряжение генерирует излучение большей интенсивности. (Разность уровней Ферми
определяется посредством внешнего напряжения U: eU = Fc — Fv
4.
РобертХолл и
первый
GaAs
лазер
On the morning of Sunday, September 16, 1962, Robert Hall’s team at General
Electric Research Labs demonstrated infrared emission from a gallium arsenide
(GaAs) semiconductor with a "strange" interference pattern implying coherent
laser light—the first semiconductor laser was
born. https://youtu.be/3B1P9ERCaxg
5.
Структура пучка нарасстоянии 5 см от
p-n перехода выше
порога генерации
Coherent Light Emission From GaAs Junctions
R. N. Hall, G. E. Fenner, J. D. Kingsley, T. J. Soltys, and R. O. Carlson
Phys. Rev. Lett. 9, 366 (1962) – Published 1 November 1962
6.
Coherent infrared radiation has been observedfrom forward biased GaAs p -n junctions. Evidence
for this behavior is based upon the sharply
beamed radiation pattern of the emitted light, upon
the observation of a threshold current beyond which
the intensity of the beam increases abruptly, and
upon the pronounced narrowing of the spectral distribution
of this beam beyond threshold. The stimulated
emission is believed to occur as the result
of transitions between states of equal wave number
in the conduction and valence bands.
Several requirements must be fulfilled' in order
that such stimulated emission can be observed:
(a) The electron and hole populations within the
active region must be large enough that their quasiFermi levels are separated by an energy greater
than that of the radiation; (b) losses due to absorption
by other processes must be small relative to
the gain produced by stimulated emission; and
(c) the active region must be contained within a
cavity having a resonance which falls in the spectral
range within which stimulated emission is possible.
7.
Простейший полупроводниковый лазерПоказатель преломления GaAs составляет: n = 3,6, коэффициент
отражения: R = [ (n — 1)/(n + 1) ]2 = 0,32. Дополнительное зеркальное
покрытие в данном случае не обязательно, усиления здесь и так вполне
достаточно.
8.
9.
Зависимость энергии запрещенной зоны отпостоянной кристаллической решетки
двойных соединений AIII-BV и их растворов
10.
Схемы лазерных гетероструктур на основе твердых растворов AlAs-GaAs (x1, x2,x3 – значения x в формуле твердого раствора Ga1-xAlxAs). а — простой р-n
гетеропереход; б—односторонняя гетероструктура с р-n переходом в узкозонном
материале и р — р -гетеропереходом, создающим потенциальный барьер для
инжектируемых электронов; в — двусторонняя гетероструктура с р — р- и р — n гетеропереходами; г — двусторонняя гетероструктура с р — n -переходом в
узкозонном материале и двумя гетеропереходами; д—гетероструктура с
раздельными электронным и оптическим ограничениями. Под гетероструктурами
приведены упрощенные графики пространственного изменения ширины
запрещенной зоны
11.
Зависимость энергии запрещенной зоны отпостоянной кристаллической решетки
двойных соединений и их растворов
12.
Полупроводниковые лазерыс гетероструктурами
13.
14.
Волноводные свойства гетероструктур15.
Полупроводники, используемые вполупроводниковых лазерах, и
спектральные диапазоны излучения
16.
ПодложкаДиапазоны длин
волн, мкм
Рабочая
теми-pa,
К
Активный
слой
Широкозонные
эмиттеры
GaInPAs
GaInP; GaInPAs
GaAs
0.575-0,600
GaInPAs
GaInP; GaInPAs
GaAs
0.637—0.660
300
GaPAs
AlGaPAs
»
0,74—0.80
300
AlGaAs
AlGaAs;
AIGaAsP
»
0,69—0,90
300
GaAs
AlGaAs;
AlGaAsP; GalnP
»
0,88—0.90
300
GaAlSb
AlGaAsSb
»
0,945-1.00
300
GaInAs
GaInP
»
0.90—1,15
300
GaInAsP
InP; GaInAsP
InP
1,0—1,67
300
GaSb
AlGaAsSb
GaSb
1 .6—1 .8
300
AlGaAsSb
AlGaAsSb
»
1.3-1,6
300
GalnAsSb
GaSb
»
1.8-2,0
77
PbSSe
PbS
PbS
4,1-6.4
20-180
PbSnTe
PbTe
PbTe
10 — 16
4-110
77
17.
Типы полупроводниковых лазеровлазерные диоды с одной поперечной модой,
волноводные лазеры ребристой структуры (англ. ridge wave
guide laser),
трапецеидальные усилители (англ. tapered amplifier),
лазеры с обратной связью (DFB= англ. distributed feedback
laser),
лазеры с отражателем Брэгга (DBR = англ. distributed Bragg
reflector laser),
широкополосные лазеры,
одномерные лазерные матрицы (англ. bar);
двухмерные лазерные матрицы (англ. stack)
лазеры с поверхностным излучением и вертикальным
резонатором (VCSEL — = англ. vertical cavity surface emitting
laser).
18.
Гетеролазер сполосковым контактом
Гетеролазер с
полосковым контактом
после обработки
пучком протонов
19.
Оптическая схема считывания информации в CD-ROM20.
Применявшаяся в первых LPUоднолучевая схема довольно
скоро была практически
полностью вытеснена
трехлучевой.
21.
Локальная (побитовая) записьx
/
U
/
x
; y
/
U y/
S ( /А)2
- длина волны излучения
А – числовая апертура (A=n sin )
22.
Лазерный видеодиск и CD-диск23.
24. Сравнительный анализ CD и DVD
ПараметрCD
DVD
Комментарии
Диаметр, см
12
12
Иногда используют диски диаметром 8 см
Физическая толщина диска, мм
1,2
1,2
Число информационных сторон
1
1 или 2
1,2
0,6
1
1 или 2
Емкость диска, Гбайт
0,68
4,7-17
Минимальная длина пита, мкм
Ширина пита, мкм
0,83
0,5
0,4 / 0,44
0,5
Шаг спирали (питов), мкм
1,6
0,74
Длина волны лазера, нм
780
635/650
Апертура линзы
0,45
0,6
Схема модуляции данных
EFM
8 в 16
Схема коррекции ошибок
CIRC
RS-PC
Толщина стороны, мм
Число информационных слоев
на одной стороне
Для однослойного - 0,4, для двухслойного - 0.44
635 - для коммерческих DVD-Video (for Authoring)
EFM - Eight to Fourteen Modulation
CIRC - Cross Interleaved Reed-Solomon Code,
RSPC - Reed Solomon Product Code
25.
Геометрия и плотность записи на CD, DVD и Blu-Ray дисках26. Структурные типы DVD
27. Структура DVD-дисков
28. Запись информации
29. Стирание данных
30. Механизм записи
31.
Метод ЧохральскогоОбычно скорость роста составляет несколько мм в минуту, а вращение
обеспечивает получение кристаллов цилиндрической формы. Кремниевые
слитки, изготавливаемые таким образом, имеют теперь диаметр больше 30 см.
Монокристаллы GaAs и фосфида индия (InP) обычно выращивают методом
Чохральского, но расплав изолируется от воздуха слоем расплавленного оксида
бора для того, чтобы предотвратить утечку летучих паров аниона.
32.
Химическая газофазная эпитаксияЭпитаксией называется процесс наращивания монокристаллических слоев на
подложку, при котором кристаллическая ориентация наращиваемого слоя
повторяет кристаллографическую ориентацию подложки.
Для обеспечения высокого качества кристаллической структуры тонкого верхнего
слоя, его кристаллическая структура должна быть сходной или идентичной со
структурой подложки, а постоянные их решеток должны быть как можно ближе
друг к другу, чтобы свести к минимуму деформацию. При этом атомы,
образующие тонкий слой, будут стремиться к образованию монокристалла с той
же кристаллографической ориентацией, как и у подложки. В таких случаях
говорят, что результирующая пленка наносится на подложку эпитаксиально.
Нанесение пленки монокристалла с тем же химическим составом называется
гомоэпитаксией (например, нанесение пленки Si на объемный кристалл Si). Если
пленка наносится на подложку со сходной структурой, но с другим химическим
составом, то процесс роста называется гетеро-эпитаксией (например, рост
пленки GaAs на подложке Si).
33.
Схематическое изображение установки для металлоорганической газофазнойэпитаксии (а).
Двупоточная ГФЭМОС-установка, предложенная Накамурой с соавторами для
роста GaN (б).
Схема газовых потоков вблизи поверхности подложки (в)
34.
Молекулярно-пучковая эпитаксияСхематическое изображение эффузионной ячейки
(ячейки Кнудсена)
35.
Потенциальная яма возникает, когда слой GaAs выращивается между двумя болееширокозонными барьерными слоями AlGaAs. Когда ширина слоя ямы достаточно мала, движение
электронов в квантовой яме становится квантованным в направлении роста, при этом
разрешенные энергетические уровни, соответствующие движению в этом направлении,
становятся дискретными. В плоскости, параллельной границам раздела, движение электронов
остается неограниченным. В результате этого полная электронная волновая функция дается
произведением огибающей функции (решение одномерного уравнения Шредингера) и
периодических блоховских функций Uпк (обусловленных периодичностью кристаллической
решетки), а также плоских волн, описывающих свободное движение в плоскости, параллельной
границам раздела.
Уровни энергии одномерной
потенциальной ямы шириной a
2 2 2
2
En
n
E
n
0
2
2
ma
В плоскости ху (потенциальной ямы)
передвижение носителей не ограничивается,
поэтому полную энергию носителей можно
записать в виде
36.
Изображение волновых функций для четырех нижних уровнейэнергии (п = 1, 2, 3, 4) одномерной прямоугольной ямы с
бесконечно высокими стенками.
Схема уровней одномерной прямоугольной ямы, на которой
показаны
уровни ямы с бесконечно высокими стенками (слева,
пунктирные линии) и лежащие ниже уровни ямы с конечными
стенками (справа, сплошные линии).
37.
Количество электронов N(E) (слева) и плотность состояний D(E) (справа)в зависимости от энергии для четырех типов квантовых структур в
приближении прямоугольных ям и Ферми-газа.
Плотности состояний в зоне проводимости и валентной
зоне однослойной КРС
38.
Оптические переходы в КРС39.
Квантово-размерная структура40.
Многослойная КРС41.
42.
43.
Ступенчатый характер распределения плотности состояний, котораяконечна даже при минимально возможной энергии, позволяет создать
полупроводниковые лазеры с низким значением порогового тока < 1 мА
при комнатной температуре и слабой температурной зависимостью
порогового тока.
Большая анизотропия оптического усиления (оптическое усиление для ТЕмоды значительно больше, чем для ТM-моды) в структурах с квантовыми
ямами обеспечивает высокую стабильность поляризации оптического
излучения.
Узкая ширина полосы оптического усиления структуры с квантовыми
ямами позволяет легко осуществить одномодовый режим генерации не
только в полосковой, но и в ширококонтактной структуре.
В таких лазерах наблюдается линейная зависимость мощности
оптического излучения от силы тока и высокая степень постоянства
модового состава излучения.
44.
45.
Зонная диаграмма при прямом смещении 0,66 В и волноводный спектр усиленияTE моды (в) для квантовых ям 7 (g7), 8 (g8), 10 (g10) и 14 нм (g14).
gtot – суммарный спектр волноводного усиления
при использовании асимметричных многослойных
квантоворазмерных гетероструктур на основе четверных соединений
Ga0,6In0,40As0,36Sb0,64 /Al0,35Ga0,65As0,03Sb0,97 с неоднородно
возбужденными
активными слоями, отличающимися толщиной, можно получить
широкий и практически плоский спектр волноводного усиления в
диапазоне 2,30–2,84 мкм.
46.
Принцип функционирования SEED-прибора. Под влиянием электрическогополя носители освобождаются из квантовой ямы, например, за счет
туннелирования (а). Структура, содержащая квантовые ямы, электрически
смещается цепью с последовательным сопротивлением R(6). Реакция
структуры на действие электрической цепи заключается в резком
уменьшении выходного сигнала, когда мощность входного излучения
превышает определенное пороговое значение (в).
47.
Генерация сверхкоротких импульсов48.
Электрооптические модуляторы светаЯчейка Поккельса
1
n X r13 n0 E Z
2
1
nY r33 ne E Z
2
2 ( n X nY )
L
Минимальное время переключения ~ 1 пс
49.
Синхронизация продольных мод в резонатореE(t ) l n E0 exp i[(w 0 l w )t l ]
n
w
w
w
c
L
l l 1
sin[( 2n 1)( wt ) / 2]
A(t ) E0
sin[( wt ) / 2]
2
p
(2n 1) w
50.
Методы синхронизации модАктивная синхронизация мод
Пассивная синхронизация мод
51.
Методы генерации сверхкоротких импульсов52.
Частота синхронизации мод в современныхполупроводниковых лазерах
53.
Структура лазера типаGRIN-SCH с многослойной
квантоворазмерной структурой
градиентные
слои
МКРС
градиентные
слои
54.
55.
Экспериментальные данные по получениюцуга фемтосекундных импульсов в полупроводниковом
лазере с синхронизацией мод (GRIN-SCH-MQW-CPM)
56.
Временной цуг импульсовGRIN-SCH-MQW-CPM лазера
с частотой 1 ТГц
57.
ТЕМПЕРАТУРНАЯ ЗАВИСИМОСТЬ ПОРОГАГЕНЕРАЦИИ ПОЛУПРОВОДНИКОВЫХ ЛАЗЕРОВ
В общем случае график jth(T) можно разбить на два или три участка: от предельно низких
температур до T1 – участок постоянного или медленного роста jth(T), от T1 до T2 – пологий
участок экспоненциального роста jth, выше T2 – участок более крутого экспоненциального
роста. i = 1, 2; T0i – параметры аппроксимации.
ДГС
ЛКТ
ЛКЯ
58. Формирование квантово-размерных структур
Квантовая яма из арсенида галлия наподложке; б) - квантовая проволока и
квантовая точка, полученные методом
литографии.
метод электронно-лучевой литографии: а) — изначальная
покрытая защитным слоем квантовая яма на подложке; б) —
облучение образца через маску; в) — конфигурация после
растворения проявителем облученной части радиационночувствительного защитного слоя; г) — формирование маски для
последующего травления; д) — состояние после удаления
оставшейся части чувствительного защитного слоя; е) —
состояние после стравливания частей материала квантовой ямы;
ж) — окончательный вид наноструктуры после удаления маски
травления.
59.
Схема уровней в различных структурахa – объемный материал; b – квантовая яма;
c – квантовая проволока;d – квантовая точка.
Betul Arda, Huizi Diwu. Department of Electrical and Computer Engineering
University of Rochester)
60. Структура уровней
Дискретные уровни энергии: высокая плотность состояний,слабая зависимость от температуры.
КТ
КЯ
61.
Структурная схема лазера на КТИдеальный ЛКТ состоит из 3D-массива точек одинакового размера и формы.
Окружен более широкозонным п.п. – электронное ограничение .
Встроен в оптический волновод - оптическое ограничение.
Состоит из нижнего и верхнего слоев (n-типа и p-типа )
62. ЛКТ
MBE-технологияИнтеграция слоев квантовых точек в
активную зону лазера с двойной
гетероструктурой
Плотность КТ >1010cm-2
63.
Преимущества лазера на КТДлина волны генерации определяется энергетическими уровнями, а не
шириной ЗЗ:
возможность управлять длиной волны (изменением размеров);
максимальный коэффициент усиления.
Небольшой объем:
высокая частота повторения импульсов;
большая ширина полосы модуляции;
малый динамический чирп;
малый коэффициент увеличения ширины линии;
низкий порог лазерной генерации.
Зависимость от температуры тока порога генерации I threshold (T)
I threshold (T) = I threshold (T ref).exp ((T-(T ref))/ (T 0)) :
высокое значение T 0 вследствие уменьшенного электрон-фононого
взаимодействия;
работа при комнатной температуре без термостабилизации.
Подавление диффузии неравновесных носителей – уменьшение потерь.
64.
Зависимость длины волны генерацииЛКТ и ЛКСР от температуры
65.
High speedquantum dot lasers
Advantages
Directly Modulated Quantum
Dot Lasers
•Datacom
Mode-Locked Quantum Dot
Lasers
•Short
InP Based Quantum Dot
Lasers
•Low
application
•Rate of 10Gb/s
optical pulses
•Narrow spectral width
•Broad gain spectrum
•Very low α factor-low chirp
emission wavelength
•Wide temperature range
•Used for data transmission
66.
67. 1.3 µm Quantum Dots
68.
69.
70.
71.
Вертикально излучающиеполупроводниковые лазеры
72.
Лазерная связь между чипами73.
Линейка выколотыхгетеролазеров
74.
Полупроводниковый лазер сраспределенной обратной связью
DFB – distributed feedback laser
75.
76.
DBRdistributed Bragg reflector
Схематическое изображение лазерных структур: a традиционный полосковый лазер, b - вертикальноизлучающий лазер.
77.
78.
Вертикально-излучающийлазер (ВИЛ) на двух длинах волн
с брэгговскими зеркалами (DBR)
79.
Схемы электронного и оптического ограничения80.
81.
Решетка ВИЛ лазеров82.
ВИЛ с плоскими брэгговскими зеркалами83.
ВИЛ на модах шепчущей галереи84.
Микролазеры85.
ВИЛ с активной областью на основе трех слоевквантовых точек InAs/InGaAs.
86.
Структура зон и оптические переходыInP
Si
Фосфид индия
Арсенид галлия
Антимонид индия
Кремний – непрямозонный материал
Германий
Низкая эффективность излучательной рекомбинации (поглощение на свободных
кремний
носителях, оже-рекомбинация)
87.
88.
Кремниевый гибридный лазер89.
ЗОННАЯ СТРУКТУРА90.
ПРОФИЛЬ ПОКАЗАТЕЛЯ ПРЕЛОМЛЕНИЯ91.
92.
РЕЗУЛЬТАТЫ ЧИСЛЕННОГО МОДЕЛИРОВАНИЯ93.
94. Литература
• О.Звелто. Принципы лазеров.-М.:Мир, 1984• Физика полупроводниковых лазеров.- М.:Мир,
1989
• Laser Focus World, 2000, Vol. 36, No. 4, 5, 6, 7
Semiconductor Lasers 2000.
www.optoelectronics-world.com
95.
Контрольные вопросы.1. Полупроводниковые лазеры – области применения.
2. Основные свойства полупроводников
3. Образование запрещенной зоны
4. Зонная структура полупроводников, уровень Ферми.
5. Инжекция в p-n переходе, светодиод.
6. Устройство и работа простейшего полупроводникового лазера.
7. Полупроводниковые лазеры с гетероструктурами.
8. Волновые свойства гетероструктуры, удержание носителей.
9. Оптическая схема считывания информации в CD-ROM.
10. Зависимость энергии запрещенной зоны от постоянной
кристаллической решетки двойных соединений и их растворов.
11. Понятие о квантово-размерной структуре.
12. Преимущества лазеров на многослойных КРС.
13. Методы генерации сверхкоротких импульсов.
14. Ячейка Поккельса, принцип работы.
15. Генерация сверкоротких импульсов путем возбуждения короткими
импульсами тока.
16. Синхронизация мод в резонаторе как метод получения цуга
сверкоротких импульсов.
17. Частота синхронизации мод в современных полупроводниковых
лазерах.

















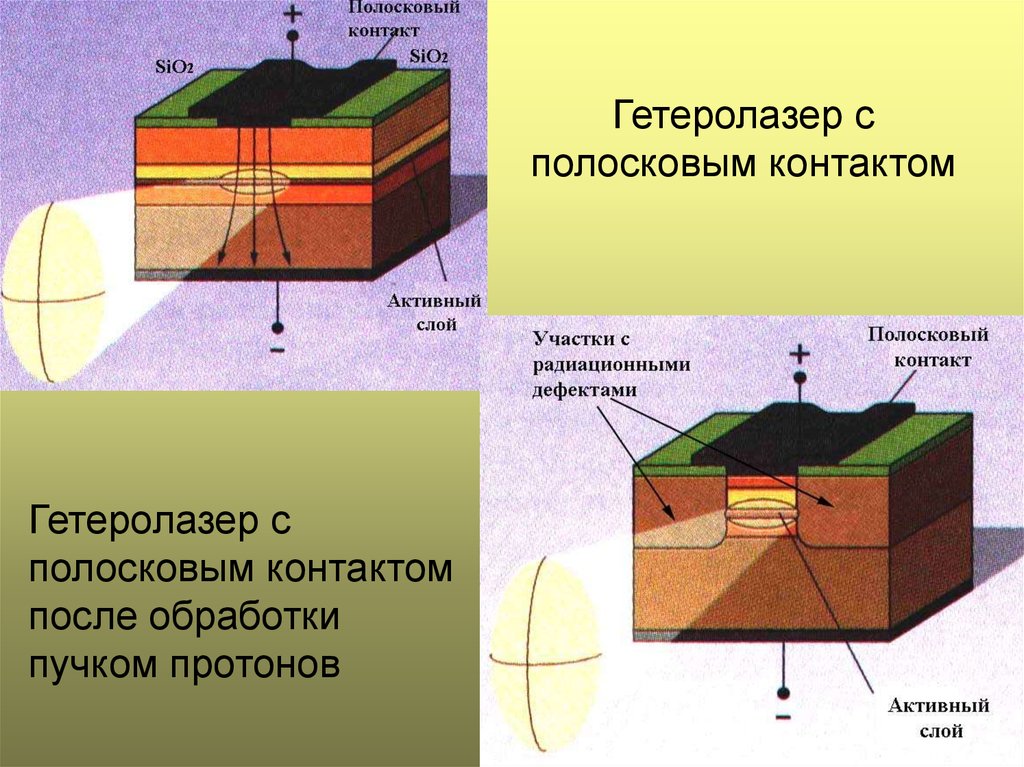






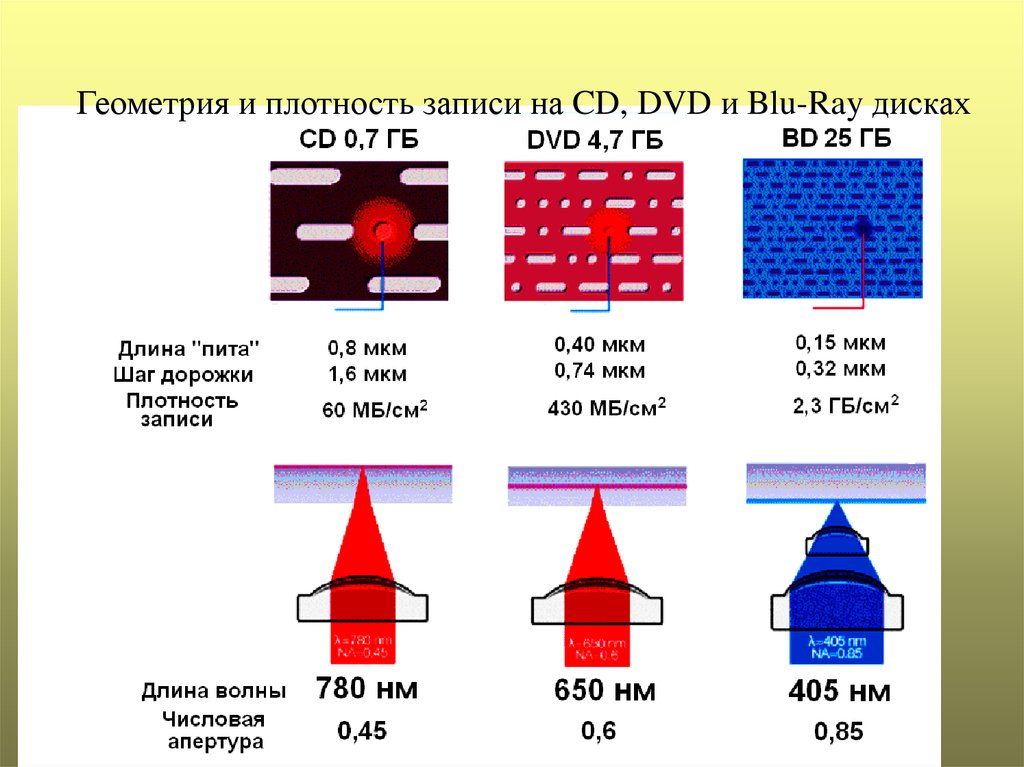





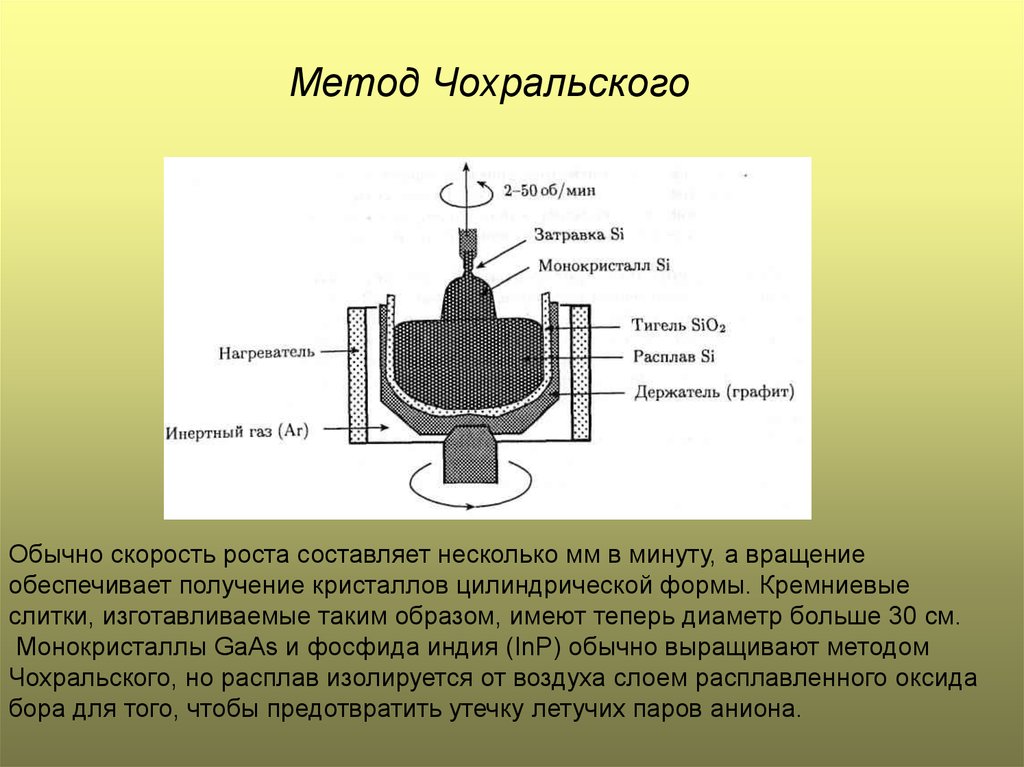

































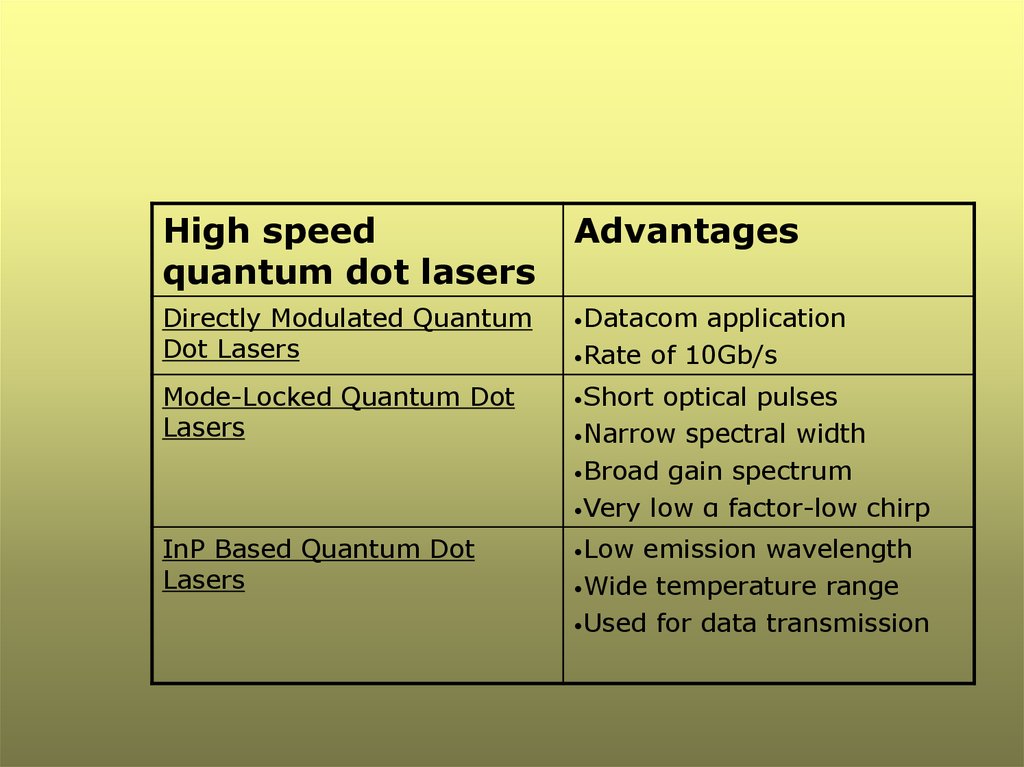
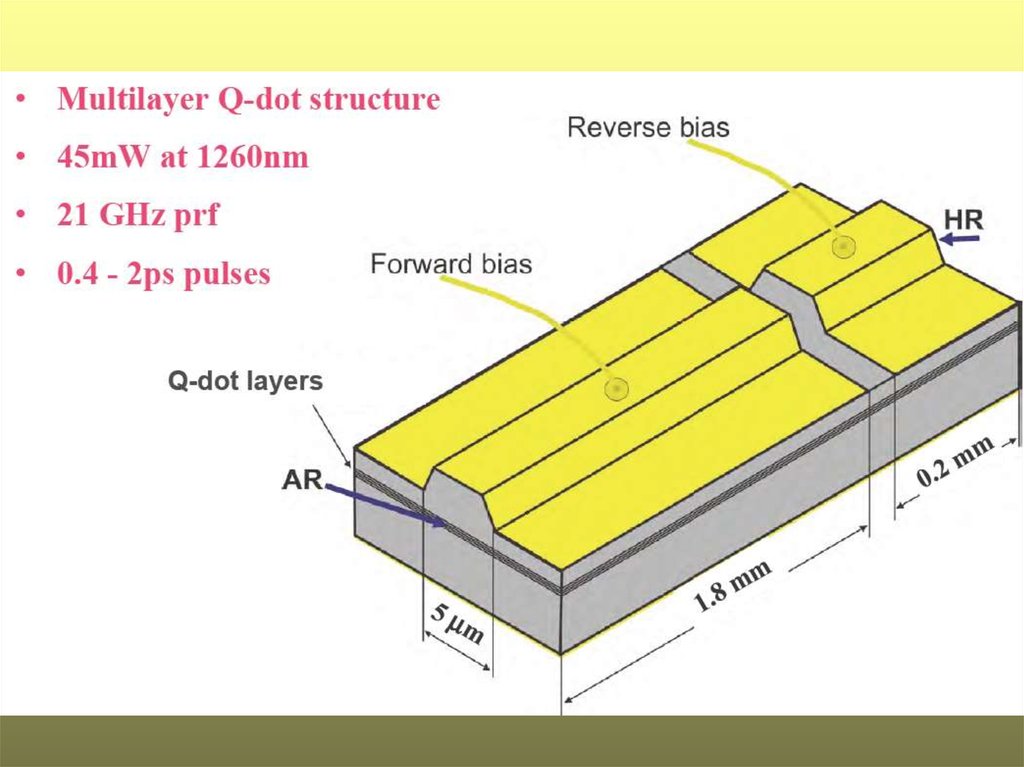

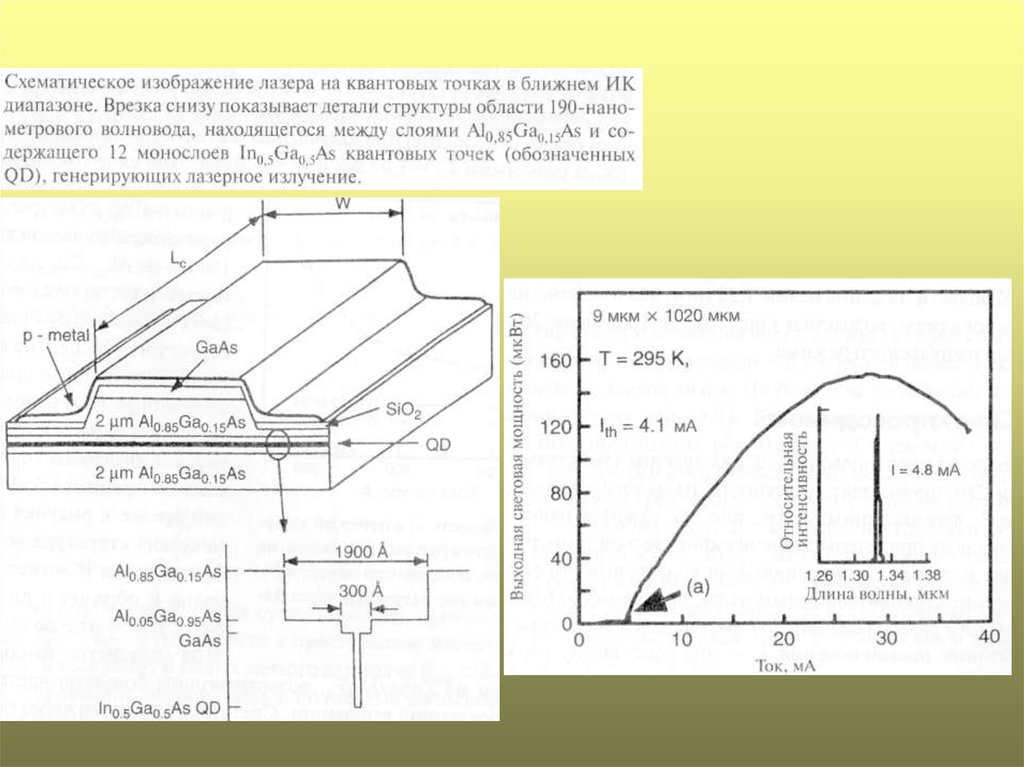



























 physics
physics








