Similar presentations:
Теоретические аспекты физического осаждения из газовой фазы
1.
Теоретические аспекты физического осаждения из газовой фазыПод физическим осаждением из газовой фазы (PVD – Physical Vapor Deposition) материала пони
1. Термо-вакуумным, при котором материал термически испаряется в виде атомов или молеку
2. Ионного распыления, при котором материал выбивается из мишени в виде атомов или моле
Метод ионного распыления по сравнению с термо-вакуумным обладает следующими преимущ
- низкие температуры проведения процессов осаждения;
- сохранение стехиометрии сложных соединений и сплавов;
- простота автоматизации и интеграции с процессом ионной очистки поверхности подложки;
- длительный ресурс мишеней;
- лучшая адгезия пленок;
- упрощение и удешевление систем обеспечения высокой однородности пленок по толщине на п
2.
dN иdt A
pнас и
атом
, 2
2 mkTи м с
dN и
pнас и
m
Vи m
m
pнас и
;
dt A
2
kT
2 mkTи
и
D000 – Резистивный нагрев. Проволочный испаритель
(для– смачиваемых
D003
Резистивный материалов);
нагрев.
D001 – Резистивный нагрев. Ленточный испаритель (для несмачиваемых материалов),
Тигельный
испаритель.
D002 – Резистивный нагрев. Сублимационный испаритель:
1 – фланец,
2 – токоввод, 3 –
3
Vи 5,83 10 pнас
M кг
,
Tи м 2 с
3.
4.
D010 – Высокочастотный нагрев. Тигельный испаритель.D011 – Высокочастотный нагрев. Тигельный испаритель со стартовым элементом
Испарение сплавов (закон Рауля):
pнас , Ар аст.
pнас , А
xА
x А (100 x А )
MА
MБ
5.
D020 – Электронный нагрев. Тигельный испаритель.D021 – Электронный нагрев. Проволочный испаритель.
D022 – Электронный нагрев. Штабиковый испаритель.
6.
D030 – Электронно-лучевой нагрев.Испаритель с пушкой Пирса.
D031 – Электронно-лучевой нагрев.
Испаритель с аксиальной пушкой.
T r , t
E0
c 4 T t
3
2
r2
exp
4 T t
r02 Pe
T (r )
2 r T
3 E0 I e
T
2 q e T R
7.
D032 – Электронно-лучевой нагрев.Многотиглевый испаритель.
8.
D040 – Лазерный нагрев.Испаритель с твердотельным или газовым лазером.
9.
D050 – Молекулярно-лучевое испарение.dN и
pнас и атом
, Кнудсена):
фузионный испаритель
(Ячейка
1 – тигель, 2 – нагреватель, 3 – испаряемый материа
2
dt A
м
с
2 mkTи
D050 – Молекулярно-лучевое испарение.
ритель: поток испаряемого материала, 2 – исходный материал, 3 – лодочка испарителя, 4 – кры
10.
Схема молекулярно-лучевой эпитаксии кремния, легированного сурьмойТнагрева
Tп
Подложка из Si или сапфира Al2O3 (КНС) или SiO2, Si3N4 (КНИ)
р = 10-6 – 10-8 Па
λ = 5.10-3/р = 5.104 м
Ea = kTи
Tп=673 – 1073 К
Ячейка Кнудсена
Si
Sb
11.
12.
D100 – Ионно-плазменное распыление.постоянном токе: 1 – вакуумная камера, 2 – экран, 3 – мишень, 4 – подложка, 5 – подложкодер
D101 – Ионно-плазменное распыление.
Диодный источник на переменном высокочастотном (ВЧ) токе.
E max
S(E)
;
2
4
U0
3
ji= Qi.qe, А/м2
Qi n i
kTi
Mi
ji M кг
Vр S
, 2
qe N A м с
Частота изменения полярности на электродах (D101): f > 1/te, где время пробега электронов te = d/ve (при d=0,1 м , f
13.
D102 – Ионно-плазменное распыление.D103 – Ионно-плазменное распыление.
Магнетронный
источник
на4постоянном
токе:
– экран, 2 – мишень, 3 – подложко
– электромагнит,
2 – мишень,
3 – анод,
– термокатод,
5 –1подложкодержатель.
14.
D104 – Ионно-плазменное распыление.Магнетронный источник на переменном высокочастотном токе.
D105 – Ионно-плазменное распыление.
ный сверхвысокочастотный (СВЧ) источник с электронно-циклотронным резонансом (ЭЦР): 1
Длина свободного пробега электрона в плазме =1/(Se.n), (Se - сечение столкновения электрона с атомами плаз
15.
D110 – Ионно-лучевое распыление.ктромагнит, 2 – термокатод, 3 – анод, 4 – катод-нейтрализатор, 5 – мишень, 6 – подложка, 7 – да
D111 – Ионно-лучевое распыление.
м катодом: 1 – электромагнит, 2 – первый катод, 3 – второй катод, 4 – вытягивающий электрод,
16.
D200 – Осаждение взрывом.фокусирующая линза, 7 – полупрозрачное зеркало, 8 – поляроид, 9 – ячейка Керра, 10 – монок
рвак=10 -10 Па;
ТП=293 К;
Vоmax 103 мкм/с;
Е=1-1000 эВ;
КИ=0,1-0,5
17.
D210 – Осаждение взрывом.правляемый разрядник, 4 – конденсор или генератор импульсного тока, 5 – нагреватель катода
D220 – Осаждение взрывом.
точник: 1 – взрываемый образец, 2 – подложка, 3 – поток продуктов взрыва, 4 – конденсаторна
18.
D300 – Осаждение дуговым разрядом.парах катода): 1 – катод, 2 – система охлаждения катода, 3 – анод, 4 – электростатический экран
D301 – Осаждение дуговым разрядом.
Дуговой источник с холодным катодом (в парах катода и анода): 1 – катод, 2 – анод.
max
”
V
q доп М 10 2
Е опт
19.
D310 – Осаждение дуговым разрядом.тод прямого накала, 2 – анод (испаряемый материал), 3 – источник накала катода, 4 – источни
D311 – Осаждение дуговым разрядом.
испаряемый материал, 4 – тигель, 5 – источник напряжения смещения на подложке, 6 – источ
20.
D400 – Ионное осаждение.Термо-ионный источник диодного типа.
D401 – Ионное осаждение.
Термо-ионный источник с потенциалом смещения.
V”max
qдоп М 10 2
Еопт
21.
D410 – Ионное осаждение.аза, 2 – газоразрядная плазма, 3 – ионы осаждаемого материала, 4 – подложки, 5 – электрод по
D411 – Ионное осаждение.
вакуумная камера, 3 – электрод под положительным потенциалом, 4 – кварцевая труба, 5 – ин
22.
D420 – Ионное осаждение.й источник с горячим катодом: 1 – электромагнит, 2 – термокатод, 3 – анод, 4 – рабочая камера
D421 – Ионное осаждение.
ным катодом: 1 – электромагнит, 2 – первый катод, 3 – второй катод, 4 – вытягивающий элект
23.
D430 – Ионное осаждение.льноточный: 1 – катод, 2 – анод, 3 – нейтральная изолирующая вставка, 4 – нагреватель катода,
24.
D431 – Ионное осаждение.ряемый материал), 3 – источник накала катода, 4 – источник питания дуги, 5 – источник питан
D432 – Ионное осаждение.
й анод, 4 – соленоид, 5 – баллон с рабочим газом, 6 – подложка, 7 – коллектор подачи реактивн
25.
D433 – Ионное осаждение.ени, 2 – катод второй ступени, 3 – соленоид, 4 – анод первой ступени, 5 – источник питания ген
D434 – Ионное осаждение.
иков: 1 – катод, 2 – диэлектрик, 3 – анод, 4 – электрод поджига, 5 – управляемый разрядник, 6
26.
Параметры МРС на постоянном токе имеют следующие тдавление рабочего газа (аргона), Па
0,3 - 1,5
ток разряда, А
10 - 100
напряжение разряда, B
400-600
магнитная индукция, Тл
0,01-0,05
ширина темного катодного пространства, мм 2 - 4
скорость распыления, мкм/мин
0,1 - 1,5
энергетическая эффективность с медной мишенью, кг/Дж
потребляемая мощность, кВт
5 - 20
PVD
5
4
осаждение Ti/ TiN
kW
M
N
3
S
Ar
N2
t =100
C
2
6
1
к насосной
системе
1. Подложкодержатель с нагревательной ситемой
2. Подложка
3. Мишень
4. Система вращающихся магнитов
5. Система водяного охлаждения
6. Заслонка
Недостатки МРС:
- коэффициент использования материала мишени 25%;
- неравномерность толщины пленки на неподвижной под
- наличие потока высокоэнергетических электронов на по
- сравнительно высокое давление рабочего газа (аргона) (

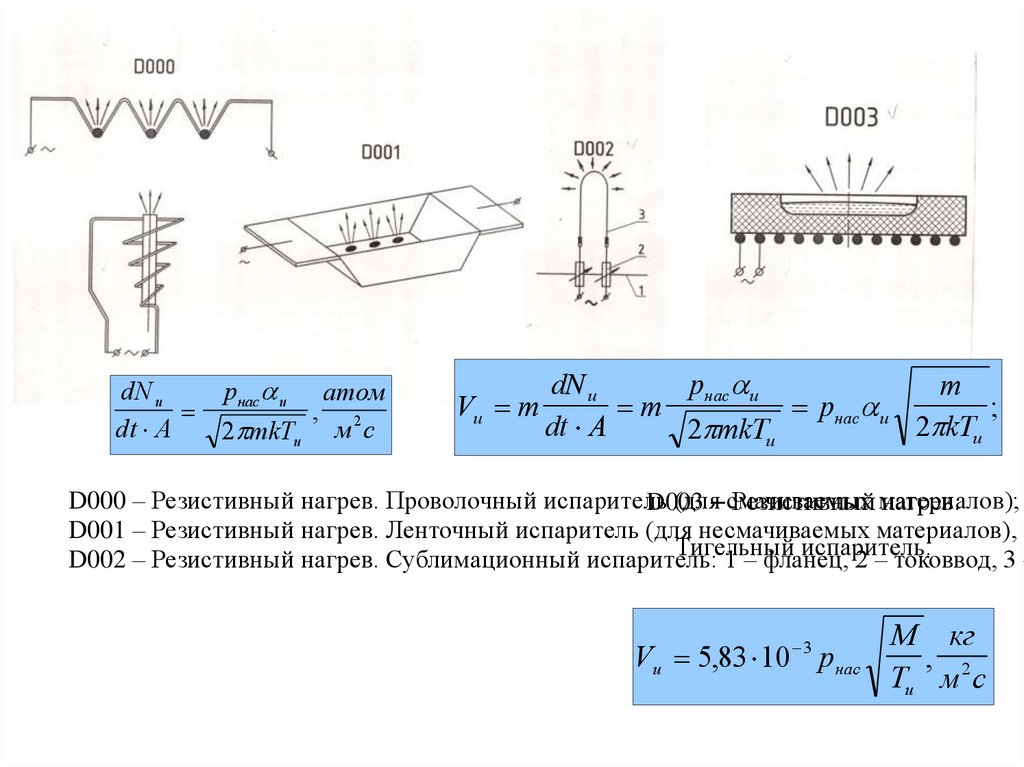









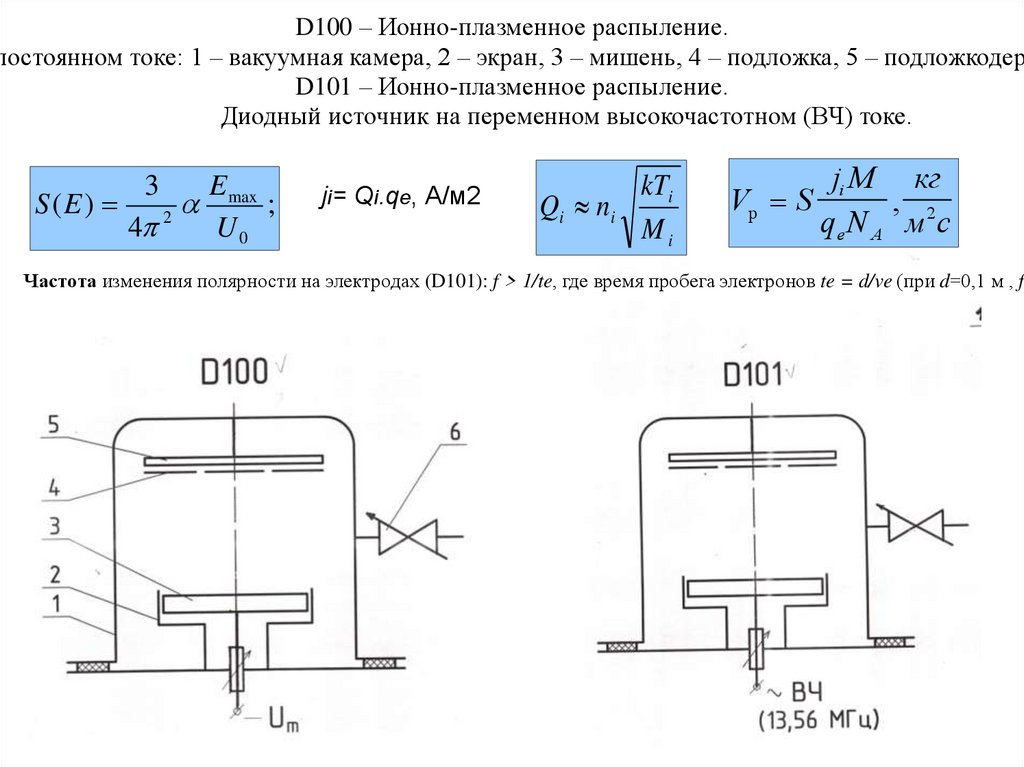
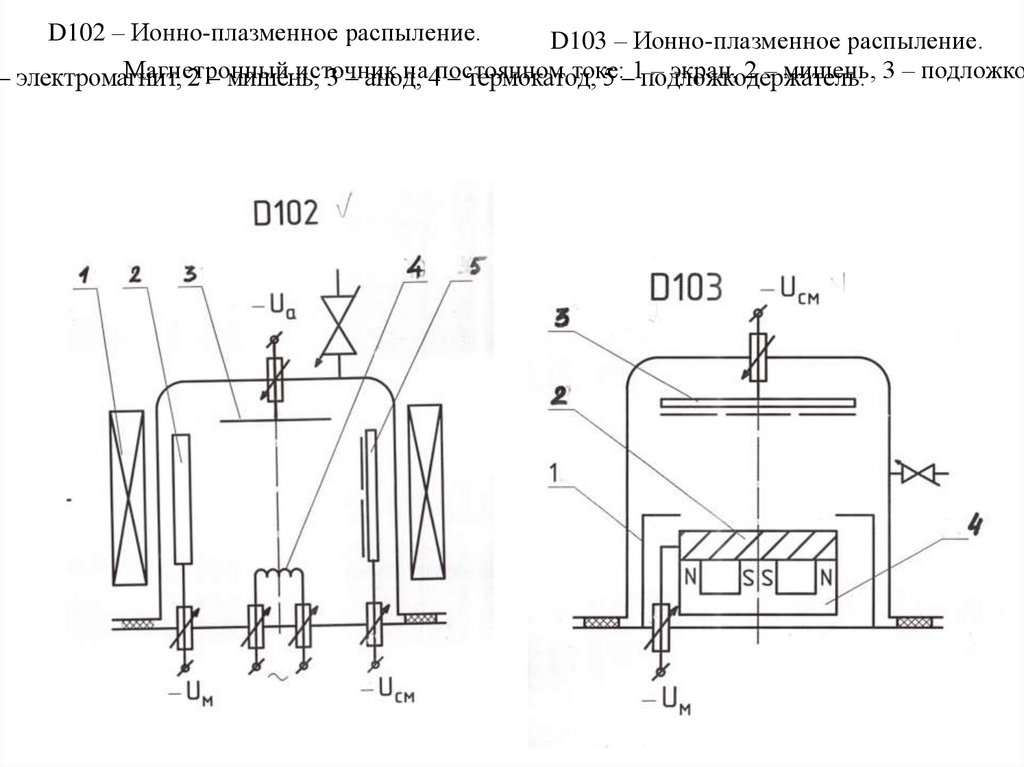

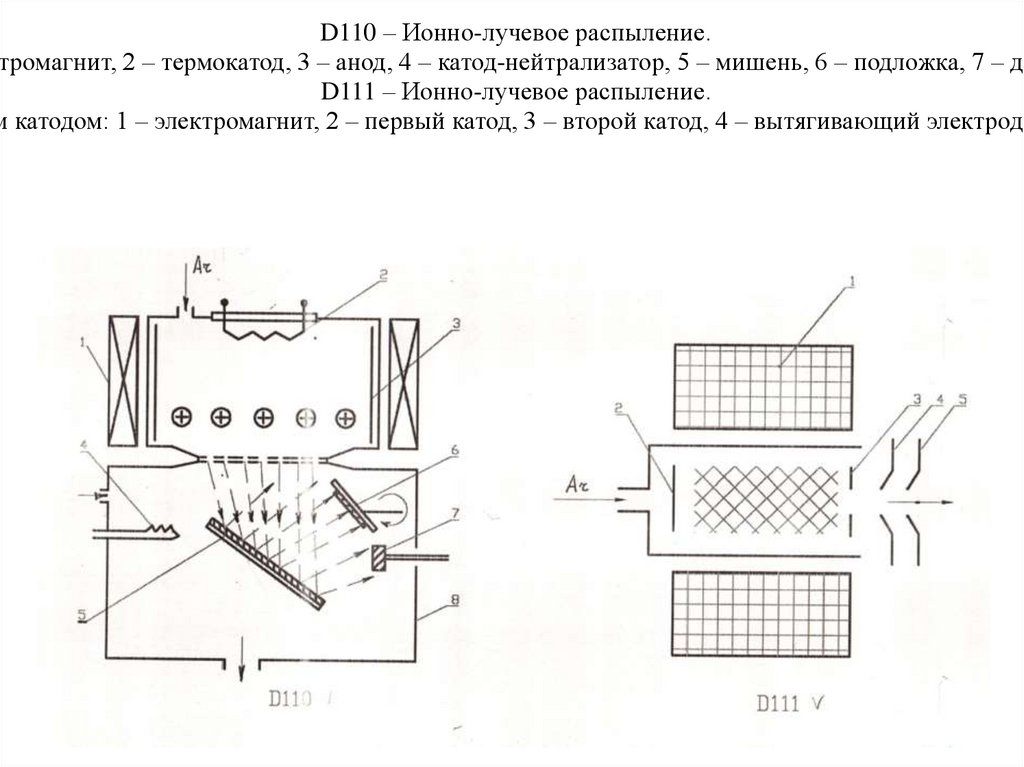
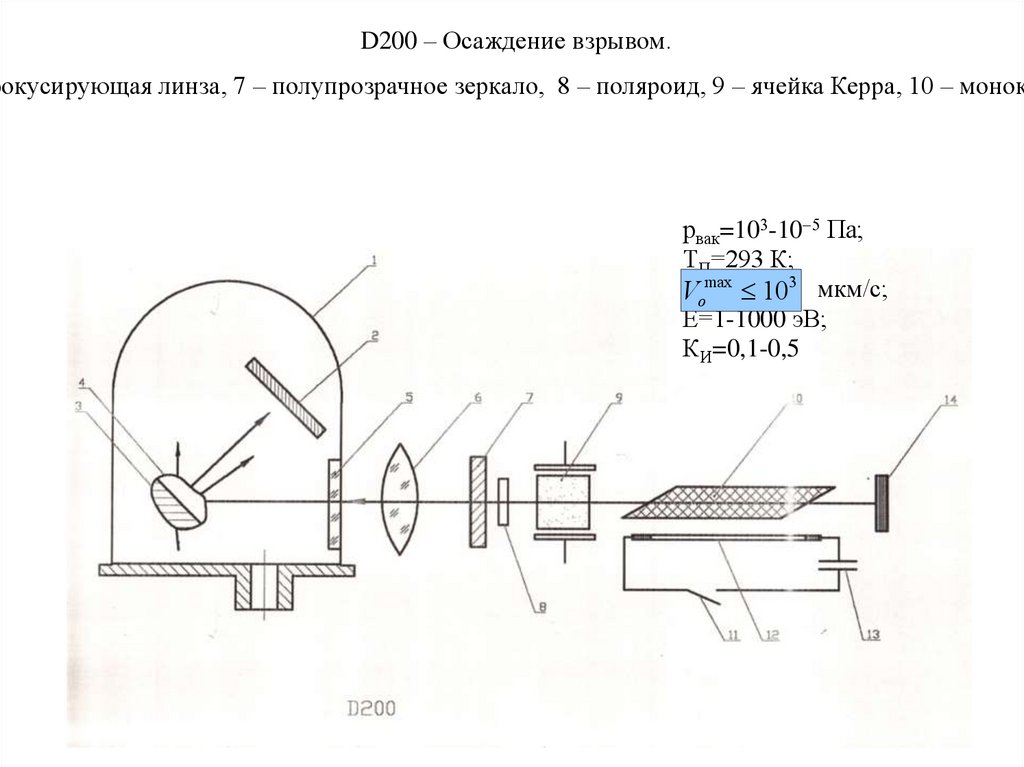






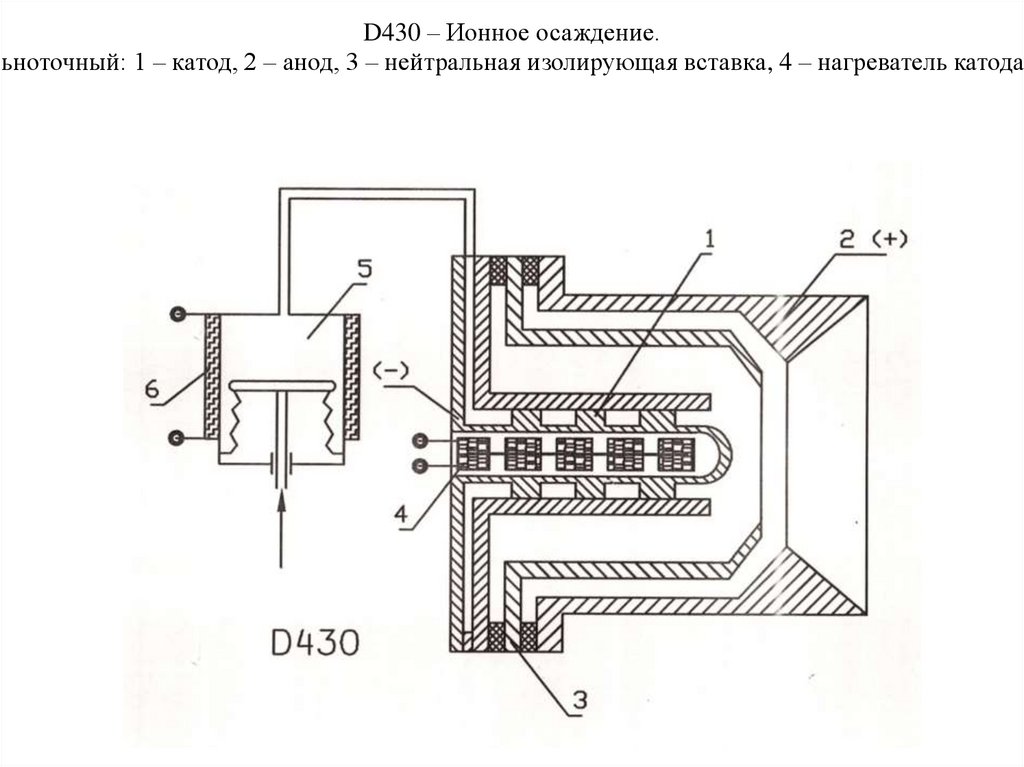



 physics
physics








